IC運營工程技術科普篇識
Q1:如果發現產品fab的后端金屬層有EM的問題,如何評估lifetime?需要做什么測試。除了HTOL,有專門針對EM的lifetime評估方式嗎?
Answer:
EM是工藝可靠性的認證測試項目,foundry必須具備的測試能力。Foundry有專門測試EM的測試結構,Process qualification,process monitor的必選項目,工廠可以提供相關report。
產品終端測試溫度能加到多少,溫度加不上來,加速因子會很小。即便可以終端高溫燒機,sample數量少也沒有統計意義。再退一步,即便終端燒機有失效發生,還要花大量時間確認是你這顆芯片出問題,而且是EM問題。在產品上的話,foundry process reliability qual.的EM結果已經沒有多少參考意義了。只能在產品上設計老化實驗老驗證,小概率出現的DPPM level的缺陷也不太了能抓得到。
Q2:為啥大多數pad都是方形的?或長方形的,這個有啥說法嗎?
Answer:
長方形為了CP扎針和封裝焊接 分開使用不同位置。方形的pitch可以做到最小。八角的pad寄生電容小,RF pad都是八角的,RF天線pad是八角的,打線還是方形的。可能跟layout時格點(grid)規則的設置有關系。一般的斜線連接都是45°,所以線或塊的走向要么平行,要么垂直,少數45°,幾乎沒有其他角度。在foundry的EDA環境設置里,這三種方向以外圖形走向會報錯。方形的和八角的pad都會看得到,其他形狀的只要不是45°走線,MRC就會報錯。
相比圓形,方形和條形pad的幾何特征更有利于機器視覺識別、測量和定位,從而有利于提高bonding過程中焊點定位精度。工程師在wire bond編程的時一般用芯片左上角pad和右下角的pad做操作點,十字光標橫平豎直,方形和八角都好定位,確保芯片是正的,便于后續的操作。可能跟layout時格點(grid)規則的設置有關系。一般的斜線連接都是45°,所以線或塊的走向要么平行,要么垂直,少數45°,幾乎沒有其他角度。在foundry的EDA環境設置里,這三種方向以外圖形走向會報錯。
Q3:一款FCLGA芯片,里面封了一個FET,這個FET單獨使用是可以到50V沒問題的,但封成FCLGA之后,30V就出現了燒短路的現象,100%失效。可能會是什么原因導致的呢?拿空基板和芯片自己手焊測試,也是沒問題的,封起來之后就有問題了。一直右邊失效。
Answer:
繼續FA看看,估計越往下約嚴重,對比layout和schematic看看。考慮散熱問題,高溫下自激反饋導致thermal run away,高溫導致高電流,高電流導致溫度繼續升高,如此反饋自我激勵。一直是右邊失效,需要考慮為何這個地方會有較大的電流密度。可能要考慮原來FET的封裝散熱和新封裝散熱系數。可以考慮添加散熱片。在FET的G和S之間再并一個10K電阻。通常損壞的原因可能是因為柵極上累積的靜電荷所導致。
如果是熱阻因素,可以考慮高導熱Compound。但是高導熱的Compound通常價格也更貴,會抬升運營成本。這些都算是權益之計,根源還是要找到為何會always燒同一個點,并且做出在下一代芯片上做設計優化。“Quality by Design.質量源自設計。”芯片DFM做好了,制造的路就會是一片坦途,質量管控也容易做。還可以用溫度成像儀,記錄不同電壓下的溫度。看看是否電壓與溫度對應關系,也能找到是否是熱燒毀的關系。
Q4:美光的DDR4,在低溫-20度下不能啟動,-10度就可以啟動。有人遇到過類似的嗎?
Answer:
會不會是你主芯片上的DDR_PHY物理接口的low temperature timing問題?可以看一下低溫下的眼圖對比。還有VDD_DDRPHY的輸出電壓在不同溫度下的差異。DRAM芯片的供應商通常都會保證芯片的低溫性能,還有LTOL test。DDR有不同的grade。需確認工作溫度的規格。這個和主控要一起分析,避免定位錯誤。
Q5:買來的耐壓30V的東芝PMOS,用在3.3V上,作為一個上電soft start的電路。使用過程也有概率燒毀。這個有啥可能?我猜測是3.3V對地短路燒毀了MOS管。
Answer:
通流能力不夠的情況下,通過大電流,Rdson會變大,積熱就會變大,在散熱不夠的情況下,會燒壞MOS。
背面這個貌似MOS。主要是這個散熱設計的很好。通過把PCB挖孔,在金屬端,讓MOS緊貼散熱片。這是封裝特定的構造,在工控的電源板中常見,一般有是插件,先將MOS鎖到散熱片再插件過波峰焊。很多年前就見過很多功放芯片被鎖到散熱片上,但都是插件。但是這種針對SMT封裝,直接鎖到散熱片上的方法,以前我還真沒想到。聰明就聰明在把PCB挖孔,然后在反面焊接。大部分人在使用SMT MOS的時候,是把整個MOS焊接到PCB上,利用PCB散熱。
PCB散熱跟不上,就在外殼上加個小散熱片,這些方法都不如直接把散熱Pin鎖到散熱片上。工控的功率版板子會統一散熱片橫槽方向,通過機殼的蜂窩孔,或風扇來形成空氣流通,散熱會很快。也是朝熱相關方向去分析,die、molding compound和基板之間,因材料熱膨脹系數不匹配,可能導致熱失配帶來熱變形和熱應力。不同材料熱變形不一致,就會引發結構內部的熱應力,影響結構的抗斷裂性能。
不同材料在一定溫度下連接成為一個整體結構之后,各部分之間收縮變形程度不均,會在材料界面邊緣產生殘余應力,這種殘余應力形成后幾乎無法消除,嚴重時可能導致界面開裂。因此,熱失配帶來的封裝結構熱載荷失衡嚴重的話,可能導致封裝結構變形、剝離,封裝后翹曲、芯片隱裂等。如果從熱失配方向考慮,可以用DSC、TMA、DMA等熱分析手段做一些材料熱性能測試,會有助于排查封裝材料是否熱失配或熱匹配。
Q6:為什么HTOL做的時候結溫必須大于125度呢?我看si基的載流子在這個溫度還是條直線呢?
Answer:
沒有說必須Tj必須大于125,任何產品未來保護可靠性Tj要小于Tjmax。HTOL主要要考慮應用情況,以及足夠的溫度加速因子。器件選型時應達到如下標準:
民用等級:Tjmax≤150℃ 工業等級:Tjmax≤135℃
軍品等級:Tjmax≤125℃ 航天等級:Tjmax≤105℃
責任編輯:xj
原文標題:季豐電子IC運營工程技術知乎 – W50
文章出處:【微信公眾號:上海季豐電子】歡迎添加關注!文章轉載請注明出處。
-
芯片
+關注
關注
459文章
52150瀏覽量
436015 -
IC
+關注
關注
36文章
6093瀏覽量
178372 -
PAD
+關注
關注
1文章
101瀏覽量
31031
原文標題:季豐電子IC運營工程技術知乎 – W50
文章出處:【微信號:zzz9970814,微信公眾號:上海季豐電子】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄

鴻利顯示榮獲“廣東省Mini LED新型顯示工程技術研究中心”認定
優艾智合獲批廣東省復合協作機器人工程技術研究中心
珠海泰芯半導體入選2024年度廣東省工程技術研究中心
曦華科技榮獲2024年度廣東省工程技術研究中心認定
森源電氣子公司華盛隆源“智能電網設備工程技術研究中心”獲省級認定
國星光電獲評禪城區智能光電子器件工程技術研究中心
技術科普 | 下一代芯片技術,新突破

芯驛電子AUMO傲目亮相2024汽車工程技術與裝備展
技術科普 | Rust-Shyper 架構簡介及對 RISC-V 的支持

鉆井工程技術研究院選購我司導熱系數測試儀

技術科普|傳感器關鍵參數介紹“精度”
賽盛集團電磁兼容工程技術中心落成慶典圓滿舉行

AI真·煉丹:整整14天,無需人類參與
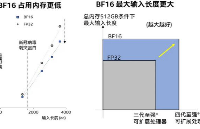





 IC運營工程技術科普
IC運營工程技術科普










評論