摩爾定律在晶圓工藝制程方面已是強(qiáng)弩之末,此時(shí)先進(jìn)的封裝技術(shù)拿起了接力棒。扇出型晶圓級(jí)封裝(FOWLP)等先進(jìn)技術(shù)可以提高器件密度、提升性能,并突破芯片I/O數(shù)量的限制。然而,要成功利用這類(lèi)技術(shù),在芯片設(shè)計(jì)之初就要開(kāi)始考慮其封裝。
數(shù)十年來(lái),半導(dǎo)體工藝已經(jīng)將芯片中晶體管線寬從數(shù)十微米逐步降低到幾個(gè)納米級(jí)別,大約每18個(gè)月芯片中晶體管密度就會(huì)翻一番,這就是著名的摩爾定律。但與此同時(shí),設(shè)計(jì)和制造成本不斷上升,改進(jìn)空間逐漸縮小,再加上許多其它困難,阻礙著半導(dǎo)體進(jìn)一步的發(fā)展。此外,隨著單個(gè)芯片中晶體管密度不斷增加,芯片連接也出現(xiàn)了一些問(wèn)題,例如I/O引腳數(shù)量以及芯片間互連的速度都出現(xiàn)了局限。
這些限制在需要大量高帶寬內(nèi)存的應(yīng)用(如人工智能邊緣和云系統(tǒng))中尤其成問(wèn)題。為了解決這些問(wèn)題并繼續(xù)提高器件密度,業(yè)內(nèi)已經(jīng)開(kāi)發(fā)出幾種先進(jìn)的封裝技術(shù),這些技術(shù)可讓多個(gè)芯片之間以緊湊的高性能封裝互連,組裝在一起相當(dāng)于一個(gè)芯片。其中一種先進(jìn)的封裝技術(shù)就是FOWLP,已經(jīng)用于移動(dòng)設(shè)備的批量生產(chǎn)中。FOWLP封裝工藝是指將單獨(dú)的芯片安裝在稱為重分布層(RDL)的中介層(interposer)基板上,可提供芯片之間的互連以及與IO焊盤(pán)之間的連接,所有這一切均采用一次成型的封裝。
面朝上和面朝下方法
FOWLP有多種形態(tài),每種形態(tài)的制造步驟都略有不同,可從多家供應(yīng)商處獲得(如圖1所示)。FOWLP組裝可以使用“先模具(mold-first)”的流程實(shí)現(xiàn),裸片可以面朝下或面朝上安裝;或者使用“先RDL(RDL-first)”方式組裝而成。
圖1:FOWLP技術(shù)形態(tài)包括mold-first和RDL-first組裝形式(來(lái)源:Micromachines)
在mold-first流程中,采用臨時(shí)的粘合或散熱層將裸片附著到載體上,然后將其鑄模封裝。如果裸片面朝下安裝,則下一步是釋放臨時(shí)層,附加RDL層,然后鑲上焊錫球,完成封裝。如果裸片面朝上安裝,則還需要一些其它步驟。
首先,在塑造成型之前,必須添加銅柱來(lái)擴(kuò)展各個(gè)裸片的I/O連接。成型之后,必須將模塑件的背面磨細(xì)以露出銅柱,然后再附加RDL層并形成焊錫球。
而在RDL-first的流程中,RDL通過(guò)臨時(shí)釋放層附著到載體上,然后裸片再附著到RDL上。接著是鑄造成型,再釋放載體,并形成焊錫球。兩種方法的最后一步都是分割組件,這些組件被成批處理,制成獨(dú)立器件。
不同的方法有不同的成本和性能考量。從成本方面看,mold-first面朝下的方法避免了制造銅柱和進(jìn)行背面研磨的步驟,因此具有較低的制造成本,適合少量I/O的應(yīng)用;但它存在裸片移位、晶圓翹曲等問(wèn)題,因而限制了其在復(fù)雜多芯片封裝中的使用。
面朝上的方法則避免了上述問(wèn)題,而且由于芯片背面完全暴露利于散熱,因而具備熱管理方面的優(yōu)勢(shì)。而RTL-first方法的優(yōu)勢(shì)在于,在制造過(guò)程中可以使用經(jīng)過(guò)驗(yàn)證合格的裸片(KGD),從而提高了良率。
從性能方面看,面朝下方法比其它兩種方法的連接路徑要短(圖2)。其它兩種方法都需要銅柱,以擴(kuò)展到RDL的連接,而且在芯片下方有一層材料增加了連接間的寄生電容,影響了其高頻性能。
圖2:不同的 FOWLP方法可能影響走線長(zhǎng)度并產(chǎn)生寄生效應(yīng),這需要在芯片設(shè)計(jì)中加以考慮。(來(lái)源:Micromachines)
先進(jìn)封裝新工具
隨著邏輯電路速率的提高,由封裝制造導(dǎo)致的這種細(xì)微的寄生效應(yīng)變得越來(lái)越重要,它極有可能顯著地改變信號(hào)時(shí)序和特性。因此,想要使用這種高級(jí)封裝技術(shù)的開(kāi)發(fā)人員需要確保其仿真和設(shè)計(jì)驗(yàn)證工作覆蓋封裝和芯片設(shè)計(jì),從而確保成功應(yīng)用。
芯片供應(yīng)商已經(jīng)開(kāi)始內(nèi)部開(kāi)發(fā)自己的工具,以便將封裝和芯片設(shè)計(jì)集成到單個(gè)工藝流程中,以供客戶使用。然而,內(nèi)部開(kāi)發(fā)的工具可能會(huì)限制設(shè)計(jì)人員對(duì)不同供應(yīng)商的芯片工藝的選擇。如果想混合由不同工藝制成的芯片,則可能需要依靠外包組裝和測(cè)試(OSAT)廠商提供的工具來(lái)驗(yàn)證完整封裝的芯片設(shè)計(jì)。EDA公司正在加緊開(kāi)發(fā)可支持這些先進(jìn)封裝要求的設(shè)計(jì)與驗(yàn)證工具。
無(wú)論采用哪種方式,先進(jìn)封裝將繼續(xù)扮演越來(lái)越重要的角色,因?yàn)榘雽?dǎo)體行業(yè)期望延緩摩爾定律的壽命。市場(chǎng)對(duì)更小、更快、功能更強(qiáng)大的芯片和系統(tǒng)的需求將持續(xù),而封裝似乎已經(jīng)成為開(kāi)發(fā)人員必須探索的新領(lǐng)域。
責(zé)任編輯:lq
-
摩爾定律
+關(guān)注
關(guān)注
4文章
638瀏覽量
79673 -
芯片設(shè)計(jì)
+關(guān)注
關(guān)注
15文章
1062瀏覽量
55449 -
封裝技術(shù)
+關(guān)注
關(guān)注
12文章
573瀏覽量
68427
原文標(biāo)題:關(guān)注 | 扇出型晶圓級(jí)封裝能否延續(xù)摩爾定律?
文章出處:【微信號(hào):wc_ysj,微信公眾號(hào):旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
擊碎摩爾定律!英偉達(dá)和AMD將一年一款新品,均提及HBM和先進(jìn)封裝

wafer晶圓厚度(THK)翹曲度(Warp)彎曲度(Bow)等數(shù)據(jù)測(cè)量的設(shè)備
減薄對(duì)后續(xù)晶圓劃切的影響

跨越摩爾定律,新思科技掩膜方案憑何改寫(xiě)3nm以下芯片游戲規(guī)則
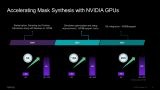
電力電子中的“摩爾定律”(1)

玻璃基板在芯片封裝中的應(yīng)用
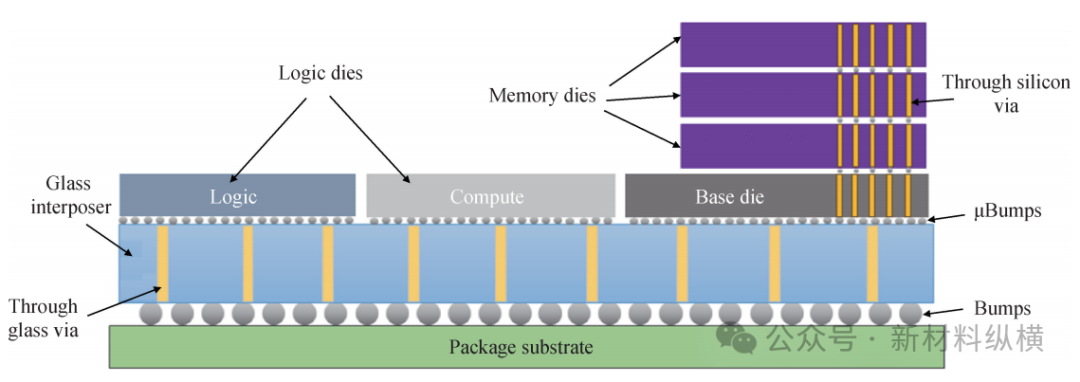
瑞沃微先進(jìn)封裝:突破摩爾定律枷鎖,助力半導(dǎo)體新飛躍






 摩爾定律在晶圓工藝制程方面已是強(qiáng)弩之末
摩爾定律在晶圓工藝制程方面已是強(qiáng)弩之末













評(píng)論