由于快速的開關(guān),傳導(dǎo)損耗和擊穿電壓的增加,在現(xiàn)代工業(yè)應(yīng)用中增加了SiC MOSFET的使用。通過最快速的開關(guān)速度和更高的頻率賦能,該框架減小了尺寸并提高了系統(tǒng)效率。大功率SIC MOSFET模塊是驅(qū)動電機(jī)系統(tǒng)中Si IGBT的可接受替代品。dV / dt較高會在逆變器和電動機(jī)彼此遠(yuǎn)離的情況下由于反射波而給電動機(jī)繞組保護(hù)帶來額外的負(fù)載,這在大多數(shù)驅(qū)動電動機(jī)應(yīng)用中非常常見。1由于切換速度更快,即使使用短電纜,在不同應(yīng)用中也需要dV / dt濾波器。可以為SiC MOSFET精確設(shè)計輸出濾波器。2個IGBT開關(guān)的性能隨電流水平而變化。相比較而言,電纜的長度對開關(guān)裝置3的影響很大。SiC MOSFET表現(xiàn)出對電流狀態(tài)的更高依賴性,并且隨著長度變化而擴(kuò)大了變化范圍。為了獲得更高的開關(guān)頻率,應(yīng)簡化連續(xù)導(dǎo)通和截止相臂之間的控制死區(qū)時間(T d),以在控制性能和模塊保護(hù)之間保持最佳平衡。4尚未充分探討電纜長度和輸出濾波器對SiC MOSFET的開關(guān)性能以及以Si IGBT性能為基準(zhǔn)的影響。4在簡單的工程中修改控制死區(qū)時間的能力至關(guān)重要。在用于控制新一代設(shè)計的不同設(shè)置情況下,SiC MOSFET的性能會發(fā)生變化。電纜和dV / dt濾波器的影響很長,很難重新制定,因為寄生和各種框架布置具有多方面的性質(zhì)。本文將討論1,200-V 300-A SiC MOSFET的性能,以及通過不同的變量(例如電纜長度,停滯時間和輸出濾波器)對其開關(guān)頻率的影響。
實驗裝置
圖1顯示了測試設(shè)置的電路圖。雙脈沖測試(DPT)用于檢查當(dāng)前水平下的開關(guān)性能。整個評估過程中使用了無法區(qū)分的入口驅(qū)動電路。使用500 VDC總線電源,并利用9,200 μF的電解頂庫來保持傳輸電壓。覆蓋的傳輸條有助于將圓形寄生電感最小化。
負(fù)載電流水平會影響IGBT和MOSFET的速度。開關(guān)是通過對柵極進(jìn)行充電和釋放來實現(xiàn)的,該柵極依賴于柵極驅(qū)動電路和環(huán)路電流。在中等或重負(fù)載的情況下,MOSFET的開關(guān)速度僅取決于柵極驅(qū)動電路。5另一方面,在小負(fù)載的情況下,來自電源環(huán)路的柵極充電或放電電流將變?yōu)榻^對值,以確定開關(guān)速度。
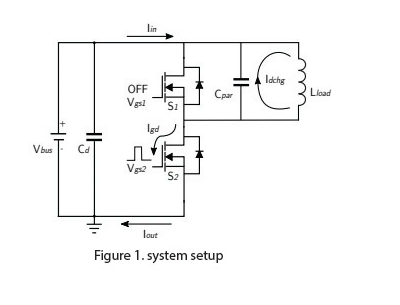
圖1:電路圖
從不同變量切換的影響
負(fù)載電流
負(fù)載電流的變化對兩個模塊的開關(guān)性能顯示出不同的影響。在導(dǎo)通過程中,對電流的開關(guān)速度依賴性可以忽略不計,尤其是對于MOSFET,因為在導(dǎo)通過程中它僅下降16%,而在關(guān)斷過程中上升到468%。在高負(fù)載電流時,這兩個MOSFET和IGBT示出幾乎相同的開關(guān)行為,而在低負(fù)載電流時,T斷示出了巨大的變化,這是在MOSFET的情況下468%,在IGBT的情況下109%。4現(xiàn)在知道,T off對負(fù)載電流的依賴大于T on。本文的其余部分僅關(guān)注各種輸出排列方案下的T off變化
2.電纜長度
由于延長了充電和放電持續(xù)時間,長距離電纜會增加開關(guān)時間。當(dāng)電纜長度在低電流下增加時,MOSFET T off會增加。當(dāng)我們降低電流時,電纜的減速效果會更高。相比之下,IGBT在嘗試的電流范圍內(nèi)顯示出相同的模式。但是,在高電流下,與MOSFET相比,T off表示對電纜長度變化的依賴性更高。延長的電纜長度會在釋放路徑中增加阻抗,并增加了T off在低電流下對電纜長度的依賴。可比現(xiàn)象應(yīng)在T on也一樣 另一個看法是,與短時和長時應(yīng)用的IGBT相比,高電流下MOSFET的高開關(guān)速度優(yōu)勢是顯而易見的。
圖2:開關(guān)電路設(shè)置
3.死區(qū)時間優(yōu)化
在現(xiàn)代驅(qū)動電機(jī)應(yīng)用中,當(dāng)設(shè)計基于SiC MOSFET的逆變器時,短路和保護(hù)的檢測是另一個重要主題,尤其是在從現(xiàn)有的基于IGBT的Si計劃轉(zhuǎn)變的過程中。與具有8至10 μs的短路耐受時間的IGBT相比,SiC MOSFET通常具有2 μs以下的耐受時間。6在擊穿之前,SiC MOSFET通常可以承受更高的電流,但是其長期可靠性會變差。
死區(qū)時間d d是避免橋穿通的有效策略。對于IGBT,空載時間通常在1至5 μs范圍內(nèi),開關(guān)頻率為1 kHz至10 kHz。在較低電流下,較慢的關(guān)斷(0.4 μs)時間不會引起短路風(fēng)險。對于SiC MOSFET,開關(guān)頻率落在10至50kHz的范圍內(nèi),空載時間低于1 μs,以實現(xiàn)出色的控制性能。低電流下較慢的關(guān)斷會引起短路危險。
空載時間應(yīng)根據(jù)負(fù)載曲線和輸出設(shè)置精確平衡。基于模型的死區(qū)時間優(yōu)化5需要更多的硬件推測。此外,由于快速切換帶來的噪聲耦合,難以精確估計來自柵極驅(qū)動電路的低壓信號。
至于輸出電纜的效果,情況取決于組件,例如電纜長度,沿這些線的輸出濾波器電容,將它們組合成一種布置并不容易。給定檢查結(jié)果,甚至可以得出一些一般準(zhǔn)則。電纜長度在影響使用輸出濾波器的時間中起著無關(guān)緊要的作用。在大電流情況下,較長的電纜不會影響開關(guān)頻率,但會影響小電流操作。電纜規(guī)格的大小或長度可用作死區(qū)時間優(yōu)化目的的控制輸入。4
結(jié)論
進(jìn)行了硬件系統(tǒng)測試,以仔細(xì)檢查負(fù)載電流和電纜長度對SiC MOSFET的影響,并且由于合并輸出排列增量模型的復(fù)雜性,Si IGBT關(guān)閉了該過程。與Si IGBT相比,SiC MOSFET的關(guān)斷時間對隨機(jī)流和輸出設(shè)計的影響更大。在高電流,電纜長度和濾波器等不同因素的影響下,該設(shè)備的關(guān)斷變量無關(guān)緊要。長電纜會降低低電流下的開關(guān)速度。為了補(bǔ)償關(guān)斷時間的變化并避免發(fā)生短路以獲得良好的控制性能,使用了指數(shù)函數(shù)模型根據(jù)負(fù)載電流來驅(qū)動T off,從而可以優(yōu)化T d。,不需要額外的硬件安裝。
參考
1 MJ Scott,J。Brockman,B。Hu,L。Fu,L。Xu,J。Wang和RD Zamora,“使用寬帶隙器件的電機(jī)驅(qū)動系統(tǒng)中的反射波現(xiàn)象”,在2014年IEEE寬帶隙功率研討會上設(shè)備和應(yīng)用,第164–168頁,IEEE,2014年。
2 R. Ruffo,P。Guglielmi和EG Armando,“用于降低SiC中電機(jī)過壓的逆變器側(cè)RL濾波器的精確設(shè)計。
3 L. Middelstaedt,D。Richter,A。Lindemann和A.Wintrich,“負(fù)載電纜配置對IGBT開關(guān)特性的影響”,在PCIM Europe 2016上;國際電力電子展覽會和會議,智能運(yùn)動,可再生能源和能源管理,pp.1-8,VDE,2016年。
4 1200V 300A SiC MOSFET開關(guān)性能的表征取決于負(fù)載電纜-輸出濾波器和控制死區(qū)時間優(yōu)化于玉佳,Willy Sedano,Peizhong Yi,Lixiang Wei標(biāo)準(zhǔn)驅(qū)動部,羅克韋爾自動化6400 West Enterprise Drive,Mequon,美國威斯康星州53092。
5 Z. Zhang,H。Lu,DJ Costinett,F(xiàn)。Wang,LM Tolbert和BJ Blalock,“利用碳化硅半導(dǎo)體的電壓源轉(zhuǎn)換器的基于模型的空載時間優(yōu)化”,《電力電子IEEE期刊》,第1卷。32號 11,第8833–8844頁,2016年。
6 S. Ji,M。Laitinen,X。Huang,J。Sun,W。Giewont,F(xiàn)。Wang和LM Tolbert,“ 10 kV SiC mosfet的短路特性和保護(hù)”,《 IEEE功率電子學(xué)報》,卷 34號 2,第1755–1764頁,2018年。
編輯:hfy
-
MOSFET
+關(guān)注
關(guān)注
150文章
8242瀏覽量
218443 -
開關(guān)頻率
+關(guān)注
關(guān)注
2文章
162瀏覽量
21707 -
SiC MOSFET
+關(guān)注
關(guān)注
1文章
83瀏覽量
6436
發(fā)布評論請先 登錄
為何使用 SiC MOSFET
全SiC功率模塊的開關(guān)損耗
SiC-MOSFET的應(yīng)用實例
SiC-MOSFET與Si-MOSFET的區(qū)別
采用第3代SiC-MOSFET,不斷擴(kuò)充產(chǎn)品陣容
開關(guān)損耗更低,頻率更高,應(yīng)用設(shè)備體積更小的全SiC功率模塊
搭載SiC-MOSFET和SiC-SBD的功率模塊
SiC-MOSFET有什么優(yōu)點
SiC功率器件SiC-MOSFET的特點
【羅姆SiC-MOSFET 試用體驗連載】基于Sic MOSFET的直流微網(wǎng)雙向DC-DC變換器
【羅姆SiC-MOSFET 試用體驗連載】SiC開發(fā)板主要電路分析以及SiC Mosfet開關(guān)速率測試
SiC-MOSFET器件結(jié)構(gòu)和特征
降低 SiC 電阻之路
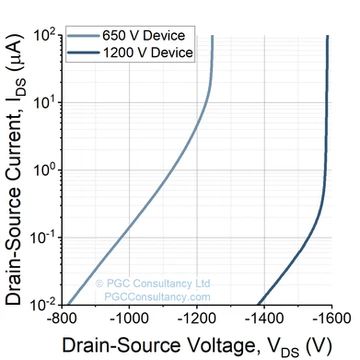
1,200V SiC MOSFET 提供更高的性能?
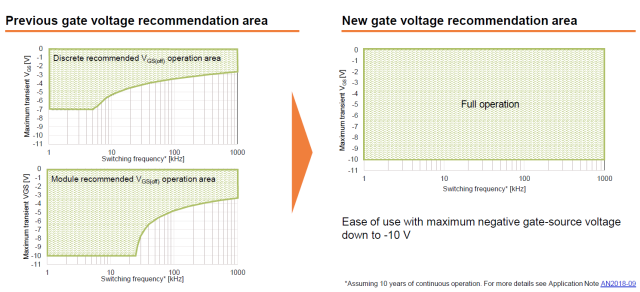





 探討1,200-V 300-A SiC MOSFET對開關(guān)頻率的影響
探討1,200-V 300-A SiC MOSFET對開關(guān)頻率的影響
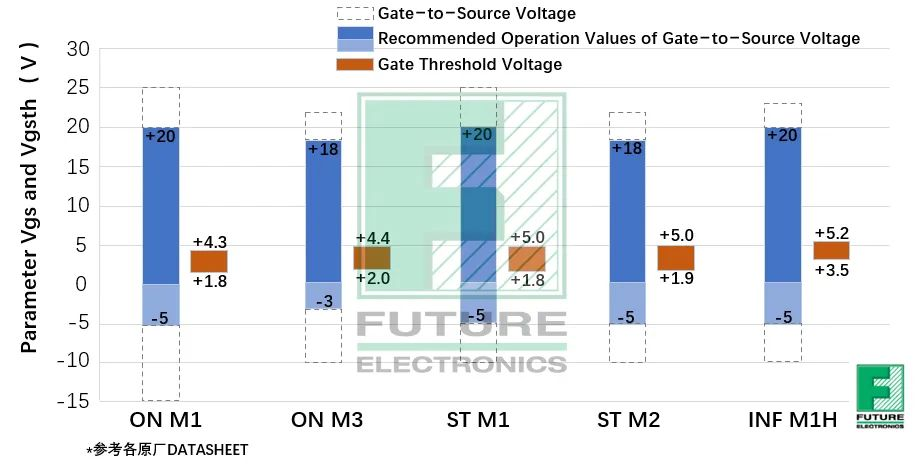










評論