氮化鎵(GaN)是一種寬禁帶半導(dǎo)體,第三代半導(dǎo)體的典型代表。與第一代半導(dǎo)體硅基的器件相比,GaN器件具有更高耐壓、更快開關(guān)頻率、更小導(dǎo)通電阻等特性,在功率電子器件領(lǐng)域得到廣泛應(yīng)用。相關(guān)研究顯示,GaN器件適用于68%的功率器件市場;在功率轉(zhuǎn)換電路中應(yīng)用GaN器件可消除整流器在進行交直流轉(zhuǎn)換時90%的能量損失,極大提高了能源利用效率;可使筆記本等電源適配器的體積縮小,減小設(shè)備體積,提高集成度。
GaN HEMT 電力電子器件的應(yīng)用
在實際應(yīng)用中,為實現(xiàn)失效安全的增強模式(E-mode)操作,科研人員廣泛研究了基于凹槽柵結(jié)構(gòu)的MIS柵、p-GaN regrowth柵增強型GaN HEMT器件。在實際的器件制備過程中,精確控制柵極凹槽刻蝕深度、減小凹槽界面態(tài)密度直接影響器件閾值電壓均勻性、柵極可靠性,在大規(guī)模量產(chǎn)中會直接影響器件的量產(chǎn)良率。
GaN HEMT 增強型器件技術(shù)路線及關(guān)鍵科學(xué)問題
近期,中國科學(xué)院蘇州納米技術(shù)與納米仿生研究所研究員孫錢團隊博士研究生蘇帥、鐘耀宗等在p-GaN Regrowth器件制備技術(shù)、器件可靠性測試分析技術(shù)等方面取得進展,制備的器件閾值電壓達到~1.7 V@ IDS = 10 μA/mm、開關(guān)比達5×101?、輸出電流400mA/mm以上,器件綜合性能優(yōu)異;在柵極凹槽深度高均勻性的精確控制及減小凹槽界面態(tài)密度方面,利用自主創(chuàng)新的MOCVD熱分解自終止技術(shù)手段實現(xiàn)了精確可控的柵極凹槽制備,且凹槽深度均勻性大幅提高,同時柵極界面態(tài)密度減小1~2個數(shù)量級,達到 ~1011 eV?1·cm?2 ,有助于高性能MIS、pGaN柵極增強型器件的研發(fā)。
(a):MOCVD熱分解實現(xiàn)高均勻性低界面態(tài)柵極凹槽結(jié)構(gòu)的技術(shù)路線;(b):基于MOCVD熱分解制備的凹槽的表面形貌,熱分解自終止的驗證及片上均勻性統(tǒng)計;(c):利用變頻CV表征柵極界面態(tài)密度
相關(guān)成果發(fā)表在電子器件領(lǐng)域期刊IEEE Electron Device Letters 、ACS Applied Materials & Interfaces、IEEE Journal of Emerging and Selected Topics in Power Electronics,以及第三十二屆功率半導(dǎo)體器件和集成電路國際會議上。主要作者為蘇帥、鐘耀宗,通訊作者為孫錢、副研究員周宇。研究得到國家自然科學(xué)基金、國家重點研發(fā)計劃課題、中科院重點前沿科學(xué)研究計劃、江蘇省重點研發(fā)計劃項目。
責(zé)任編輯:lq
-
集成電路
+關(guān)注
關(guān)注
5417文章
11942瀏覽量
366990 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28563瀏覽量
232235 -
電源適配器
+關(guān)注
關(guān)注
14文章
672瀏覽量
43872
原文標(biāo)題:蘇州納米所在功率半導(dǎo)體器件和集成電路研究中取得進展
文章出處:【微信號:MEMSensor,微信公眾號:MEMS】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
從型號看實力!仁懋GaN器件命名規(guī)則全解析
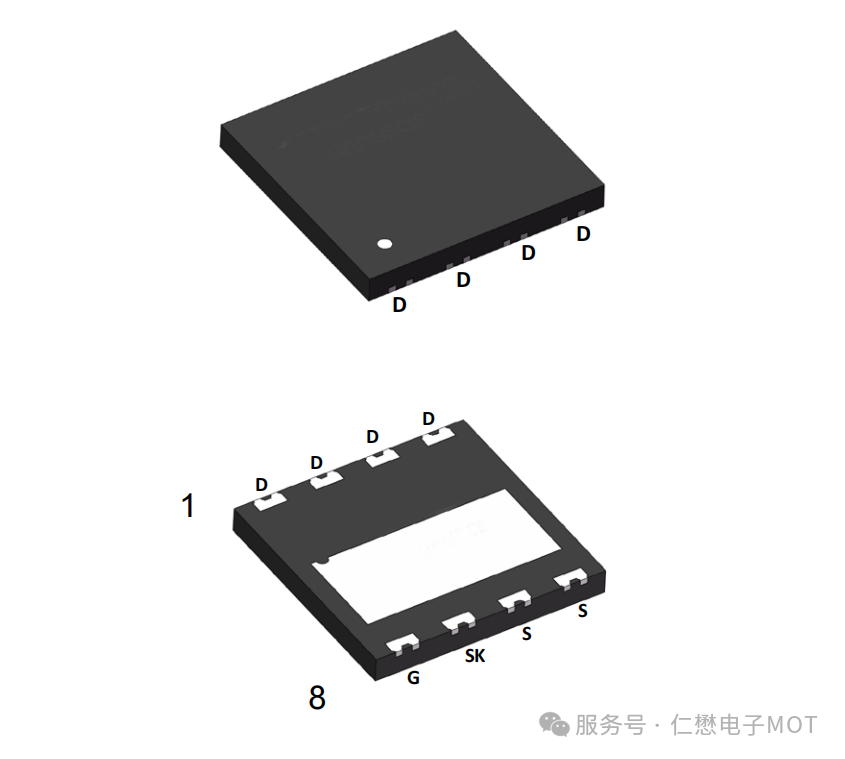
GaN HEMT的SPICE模型使用指南及示例
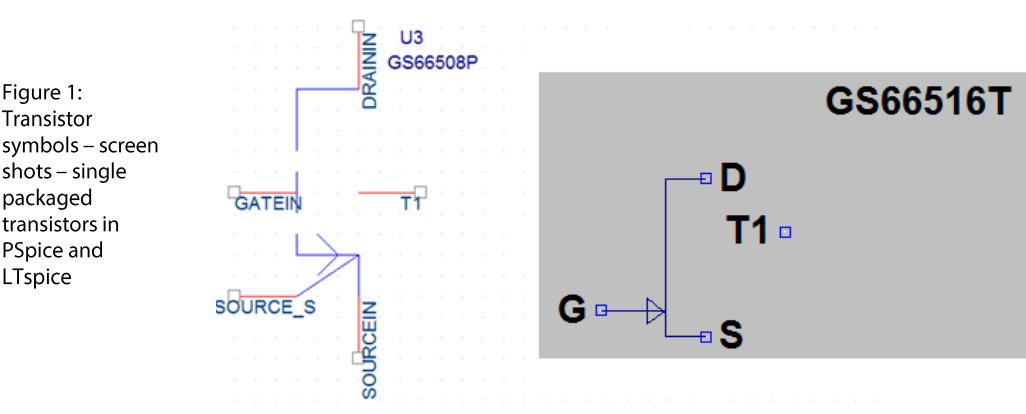
GNP1070TC-Z 650V GaN HEMT 數(shù)據(jù)手冊

高速GaN E-HEMT的測量技巧方案免費下載
使用TMS320C6000增強型DMA的應(yīng)用

AP2222D 20V N溝道增強型MOSFET
N溝道增強型MOSFET的優(yōu)缺點
CoolGaN和增強型GaN區(qū)別是什么
增強型HotRod QFN封裝:實現(xiàn)低EMI性能






 GaN HEMT增強型器件技術(shù)路線及關(guān)鍵科學(xué)問題
GaN HEMT增強型器件技術(shù)路線及關(guān)鍵科學(xué)問題










評論