在上周的Semicon West上,ASML提供了有關(guān)當(dāng)前EUV系統(tǒng)以及正在開(kāi)發(fā)的0.55高NA系統(tǒng)的最新信息。
Anthony Yen是ASML的全球技術(shù)開(kāi)發(fā)中心副總裁兼負(fù)責(zé)人。在過(guò)去的兩年里,他的談話幾乎總是以同樣的方式 :“EUV幾乎已經(jīng)為HVM做好了準(zhǔn)備。”但這次卻是與眾不同的,“截止目前,EUV在準(zhǔn)備HVM中”。
據(jù)悉,ASML今年又運(yùn)送了7個(gè)NXE:3400B系統(tǒng),共計(jì)11個(gè)新系統(tǒng)。這使得該領(lǐng)域的EUV系統(tǒng)總數(shù)達(dá)到50個(gè),盡管并非所有系統(tǒng)都被認(rèn)為具有HVM功能。ASML預(yù)計(jì)到今年年底,第三季度將增加7個(gè)系統(tǒng),到第四季度將增加12個(gè)系統(tǒng),共計(jì)30臺(tái)機(jī)器。
主要模塊
當(dāng)提到當(dāng)前3300/3400系統(tǒng)的主模塊時(shí),有許多關(guān)鍵組件。有液滴發(fā)生器,從那里產(chǎn)生錫水滴。這些液滴被撞擊,產(chǎn)生EUV光,其被引導(dǎo)到中間焦點(diǎn)。

由此,我們可以突出顯示影響系統(tǒng)正常運(yùn)行時(shí)間和功率的一些關(guān)鍵因素。為了改善系統(tǒng),您需要高輸入CO2激光器。然后,該激光器將錫滴液噴射。發(fā)生這種情況時(shí),您需要高轉(zhuǎn)換效率和高收集效率。這是通過(guò)橢圓形EUV收集鏡完成的。這里有兩個(gè)焦點(diǎn),第一個(gè)是當(dāng)錫被撞擊時(shí),然后在第二個(gè)焦點(diǎn)處重新聚焦。最后,液滴捕集器收集未能破裂的液滴。因此,提高效率和降低劑量開(kāi)銷(xiāo)是關(guān)鍵。
在他們的實(shí)驗(yàn)室,Yen報(bào)告說(shuō)ASML已經(jīng)為源功率實(shí)現(xiàn)了超過(guò)300瓦的功率。目前,客戶現(xiàn)場(chǎng)安裝的源電源仍為250 W.在250 W時(shí),客戶每小時(shí)最大吞吐量約為155片晶圓。今年早些時(shí)候英國(guó)的Britt Turkot在2019年的EUVL研討會(huì)上證實(shí)了這些數(shù)字。

阻礙系統(tǒng)可用性的一個(gè)組件是液滴發(fā)生器。ASML報(bào)告稱,自2014年以來(lái),液滴發(fā)生器已從2014年的約100小時(shí)變?yōu)?019年的1000多小時(shí)。自去年以來(lái),它們將液滴發(fā)生器的使用壽命提高了30%。值得注意的是,這里可以進(jìn)行其他改進(jìn)。再填充錫罐需要額外的停機(jī)時(shí)間。正如您稍后將看到的,這將在今年晚些時(shí)候解決。

另一個(gè)值得關(guān)注的是收集器本身。這是一個(gè)650毫米直徑的多層分級(jí)鏡,旨在最大限度地提高反射性。這里的關(guān)鍵問(wèn)題是如何使其盡可能保持清潔,防止其起霧或被污染。目前客戶安裝了NXE:3400B系統(tǒng),Yen報(bào)告的每千兆脈沖的降解率約為0.15%。ASML希望在相同功率(250 W)下將其降至低于0.1%/ GP。

今天,收集器遵循相當(dāng)可預(yù)測(cè)的壽命,這種壽命在大致線性趨勢(shì)下降低。收集器降級(jí)后,需要進(jìn)行交換。這是一個(gè)問(wèn)題。幾年前,這可能需要一周時(shí)間。今天,它需要一天多一點(diǎn)。ASML打算用下一代NXE:3400C將其減少到不到8小時(shí)。
NXE:3400C
在今年下半年,ASML將開(kāi)始出貨其下一代EUV系統(tǒng)。NXE:3400C是一種進(jìn)化工具,旨在進(jìn)一步解決前面描述的一些缺陷。該系統(tǒng)的額定值為175 WPH,20 mJ /cm2。在第二季度財(cái)報(bào)電話會(huì)議上,ASML報(bào)告稱該系統(tǒng)在實(shí)驗(yàn)室運(yùn)行時(shí)為175 WPH,達(dá)到2000 WPD,在與客戶相同的內(nèi)存生產(chǎn)條件下運(yùn)行。
新系統(tǒng)的一個(gè)特殊功能是模塊化容器,經(jīng)過(guò)重新設(shè)計(jì),易于維護(hù)。Yen說(shuō)他們希望使用這個(gè)系統(tǒng)可以將收集器的交換從一天減少到不到八小時(shí)。此外,他們已經(jīng)改變了液滴發(fā)生器補(bǔ)充程序。沒(méi)有任何人需要關(guān)閉系統(tǒng)電源以重新填充容器,然后將系統(tǒng)重新聯(lián)機(jī)。現(xiàn)在可以通過(guò)內(nèi)聯(lián)方式重新填充新系統(tǒng)。總而言之,通過(guò)所有這些變化的組合,他們希望達(dá)到目標(biāo)95%的可用性。
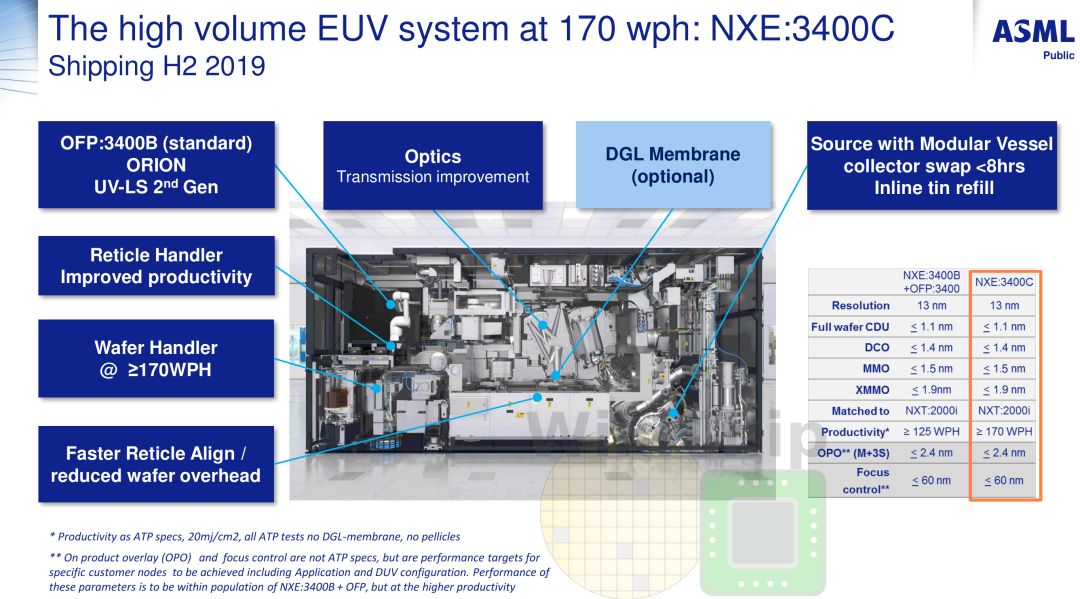
EUV Pellicle
EUV的另一個(gè)問(wèn)題是粒子帶來(lái)的前端缺陷。當(dāng)涉及到光罩區(qū)域的清潔度時(shí),它們每10,000次曝光接近1個(gè)粒子。
對(duì)于每10,000次曝光不能容忍1個(gè)顆粒的客戶,可以選擇EUV薄膜。這是一個(gè)覆蓋掩模版的超薄透明膜,旨在防止顆粒到達(dá)掩模版。雖然這有助于解決缺陷,但今天使用薄膜的問(wèn)題是光透射率的降低。當(dāng)一些EUV被薄膜吸收時(shí),會(huì)轉(zhuǎn)化為功率損失。這方面的進(jìn)展非常緩慢。在過(guò)去的一年半中,平均透光率僅提高了約3.5%至83%。一個(gè)好的目標(biāo)是超過(guò)90-93%的透射率,但目前還不清楚該行業(yè)是如何實(shí)現(xiàn)這一目標(biāo)的。

High-NA系統(tǒng)
再往前看,ASML已經(jīng)開(kāi)始使用High-NA系統(tǒng)了。第一個(gè)系統(tǒng)預(yù)計(jì)將在2021年底之前發(fā)貨。High-NA系統(tǒng)比目前的3400系統(tǒng)更大更重。該機(jī)器采用截然不同的鏡頭系統(tǒng),使用0.55 NA變形鏡頭。這些鏡頭的額定半波長(zhǎng)為8nm,在x方向上放大4倍,在y方向上放大8倍。由于鏡頭有一半的視野,該系統(tǒng)增加了一些額外的階段,旨在提高加速度。
High-NA系統(tǒng)沒(méi)有改變的一點(diǎn)是與3400系統(tǒng)兼容的源。值得指出的是,與現(xiàn)在相比,它在High-NA系統(tǒng)中實(shí)際上位于更加水平的位置,這將允許它們移除鏡子。效果類(lèi)似于將功率增加超過(guò)30%。

完成鏡頭放大率的增加以減少陰影效應(yīng)。然而,4x / 8 1:2放大率的影響是電路設(shè)計(jì)本身。使用標(biāo)準(zhǔn)的6英寸光掩模,在標(biāo)準(zhǔn)0.33 NA機(jī)器上,您可獲得4x / 4x光罩,這意味著33 mm×26 mm的全光場(chǎng),最大芯片尺寸為858mm2。對(duì)于具有變形光學(xué)器件的0.55 NA,您在y方向上看8倍,因此您的場(chǎng)地現(xiàn)在減半。對(duì)于電路設(shè)計(jì)人員而言,這意味著有效磁場(chǎng)為16.5 mm x 26 mm,最大裸片尺寸為429mm2。
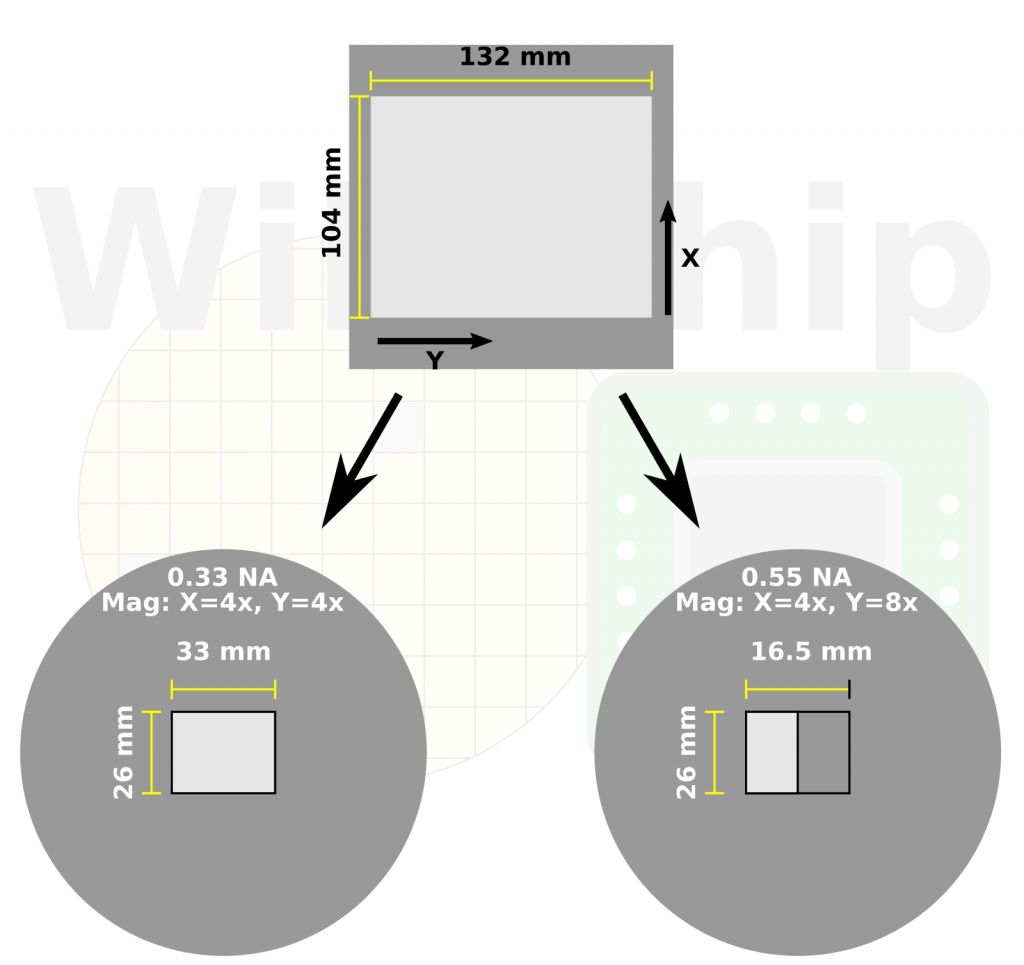
目前,仍然存在一些與基礎(chǔ)設(shè)施有關(guān)的重大挑戰(zhàn),High-NA的掩模基礎(chǔ)設(shè)施還沒(méi)有。
一個(gè)值得注意的問(wèn)題是前面討論的面具3D效果。它需要新穎的吸收劑以最小化問(wèn)題。當(dāng)芯片設(shè)計(jì)人員完成IC設(shè)計(jì)時(shí),設(shè)計(jì)將從文件傳輸?shù)焦庋谀V小T撗谀S米髦髂0澹ㄟ^(guò)在晶片上印刷圖案,掃描儀可以從該模板有效地印刷IC的許多副本。傳統(tǒng)上,這是通過(guò)掩模投射光來(lái)完成的。這個(gè)過(guò)程很像典型的高架投影儀,除了向后(從大圖像到小圖像)。對(duì)于EUV,面具是完全不同的。這里,掩碼實(shí)際上是基于鏡像類(lèi)型的掩碼空白。通過(guò)使用吸收材料以及抗反射涂層(ARC)在掩模上“繪制”不同的電路圖案。
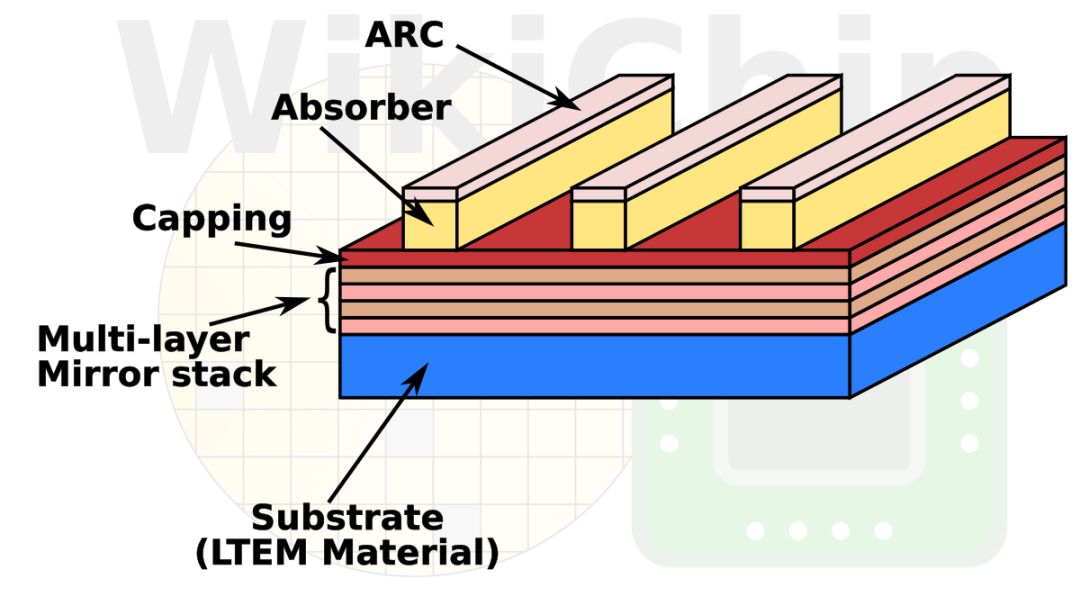
在操作過(guò)程中,當(dāng)光線照射到掩模版上時(shí)(通常是一個(gè)小角度,大約6度),有時(shí)這些結(jié)構(gòu)的反射會(huì)引起陰影效應(yīng)和像差。
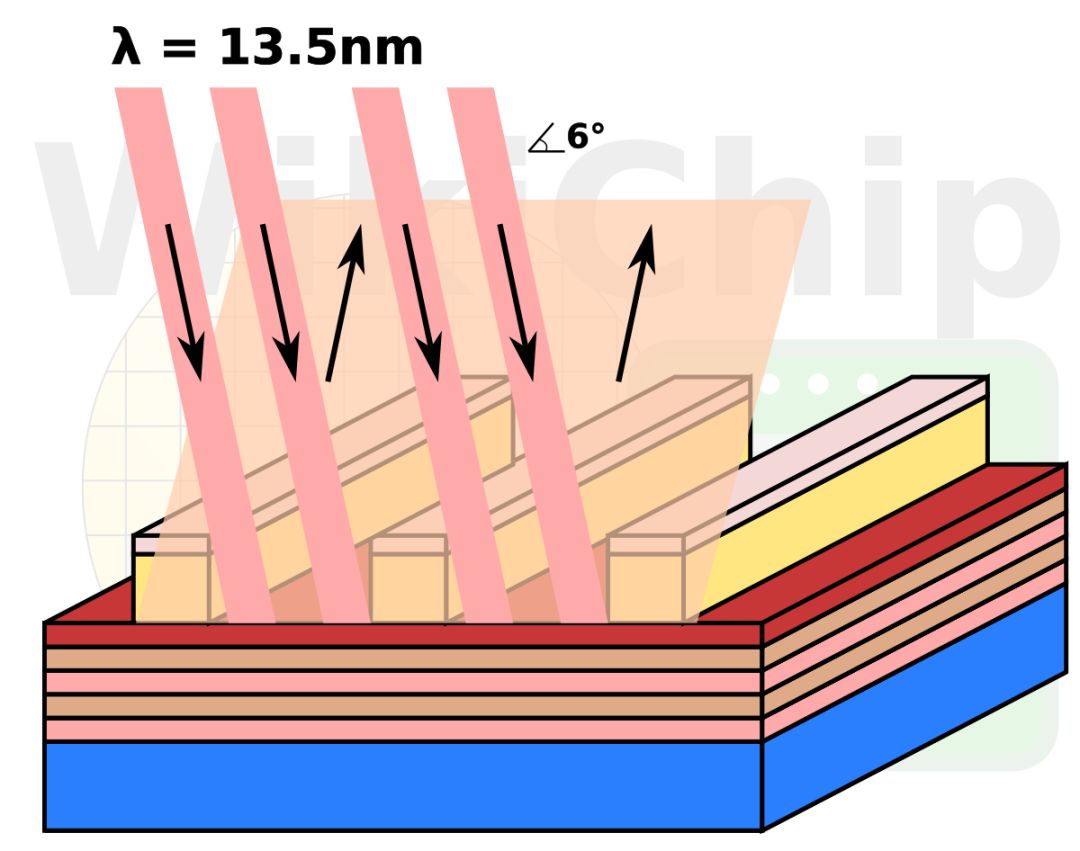
盡管這個(gè)問(wèn)題已經(jīng)有很長(zhǎng)一段時(shí)間了解,但研發(fā)主要集中在EUV的其他方面,如主模塊和電源。此外,這些效果在7納米節(jié)點(diǎn)上也沒(méi)有太大問(wèn)題。然而,降至5納米和3納米,掩模3D效果將變得更加明顯。
另外,光刻膠與High-NA掩模須在同一側(cè),還有很多工作要做。

500 W功率的High-NA系統(tǒng)
再看一點(diǎn)。Yen說(shuō),在他們的圣地亞哥實(shí)驗(yàn)室,ASML已經(jīng)設(shè)法達(dá)到450 W的功率。“當(dāng)我們的High-NA掃描儀出現(xiàn)時(shí),我相信我們將超過(guò)500 W,”他補(bǔ)充道。大約500 W是ASML需要在其高NA半場(chǎng)掃描儀上達(dá)到150 WPH,60 mJ /cm2的地方。
-
EUV
+關(guān)注
關(guān)注
8文章
609瀏覽量
86888 -
ASML
+關(guān)注
關(guān)注
7文章
723瀏覽量
42012
原文標(biāo)題:深度揭秘:ASML EUV工藝最新進(jìn)展
文章出處:【微信號(hào):wc_ysj,微信公眾號(hào):旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
光刻機(jī)巨頭ASML業(yè)績(jī)暴雷,芯片迎來(lái)新一輪“寒流”?
翱捷科技在5G領(lǐng)域的最新產(chǎn)品進(jìn)展
EUV光刻技術(shù)面臨新挑戰(zhàn)者
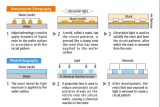
ASML發(fā)布2024年財(cái)報(bào),業(yè)績(jī)強(qiáng)勁增長(zhǎng)
ASML:中國(guó)芯片落后西方15年!
清洗EUV掩膜版面臨哪些挑戰(zhàn)
日本首臺(tái)EUV光刻機(jī)就位
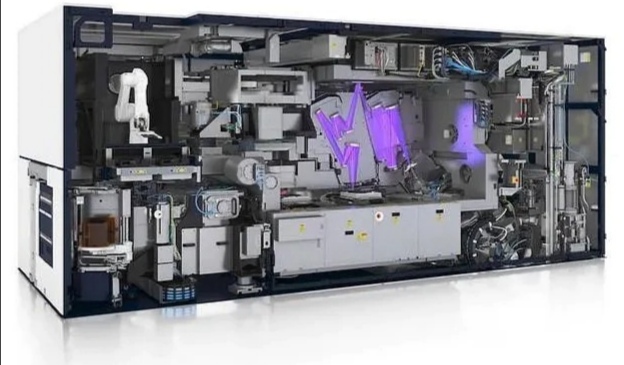
光刻機(jī)巨頭拋出重磅信號(hào) 阿斯麥(ASML)股價(jià)大幅上漲
今日看點(diǎn)丨 2011億元!比亞迪單季營(yíng)收首次超過(guò)特斯拉;三星將于2025年初引進(jìn)High NA EUV光刻機(jī)
今日看點(diǎn)丨傳三星HBM3獲英偉達(dá)認(rèn)證 將用于中國(guó)版H20芯片;OPPO 新開(kāi)兩塊高密度硅材料單電芯電池
ASML擬于2030年推出Hyper-NA EUV光刻機(jī),將芯片密度限制再縮小
ASML創(chuàng)始人逝世...
ASML創(chuàng)始人離世!
阿斯麥(ASML)與比利時(shí)微電子(IMEC)聯(lián)合打造的High-NA EUV光刻實(shí)驗(yàn)室正式啟用
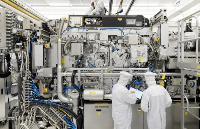





 關(guān)于ASML EUV工藝的最新信息進(jìn)展
關(guān)于ASML EUV工藝的最新信息進(jìn)展










評(píng)論