先進IC封裝是“超越摩爾”時代的一大技術亮點。當芯片在每個工藝節(jié)點上的縮小越來越困難、也越來越昂貴之際,工程師們將多個芯片放入先進的封裝中,就不必再費力縮小芯片了。
然而,先進IC封裝技術發(fā)展十分迅速,設計工程師和工程經理們需要跟上這一關鍵技術的發(fā)展節(jié)奏。首先,他們需要了解先進IC封裝中不斷出現(xiàn)的基本術語。
本文將對下一代IC封裝技術中最常用10個術語做簡要概述。
2.5D封裝
2.5D封裝是傳統(tǒng)2D IC封裝技術的進步,可實現(xiàn)更精細的線路與空間利用。在2.5D封裝中,裸片堆疊或并排放置在具有硅通孔(TSV)的中介層頂部。其底座,即中介層,可提供芯片之間的互聯(lián)。
2.5D封裝通常用于高端ASIC、FPGA、GPU和內存立方體。2008年,賽靈思將其大型FPGA劃分為四個良率更高的較小芯片,并將這些芯片連接到硅中介層。2.5D封裝由此誕生,并最終廣泛用于高帶寬內存(HBM)處理器集成。
圖1:2.5D封裝示意圖。(圖片來源:Research Gate)
3D封裝
在3D IC封裝中,邏輯裸片堆疊在一起或與存儲裸片堆疊在一起,無需構建大型的片上系統(tǒng)(SoC)。裸片之間通過有源中介層連接。2.5D IC封裝是通過導電凸塊或TSV將元件堆疊在中介層上,3D IC封裝則將多層硅晶圓與采用TSV的元件連接在一起。
硅通孔技術是2.5D和3D IC封裝中的關鍵使能技術,半導體行業(yè)一直使用HBM技術生產3D IC封裝的DRAM芯片。
圖2:從3D封裝的截面圖可以看出,通過金屬銅TSV實現(xiàn)了硅芯片之間的垂直互連。(資料來源:Research Gate)
小芯片(Chiplet)
芯片庫中有一系列模塊化芯片可以采用裸片到裸片互聯(lián)技術集成到封裝中。小芯片是3D IC封裝的另一種形式,可以實現(xiàn)CMOS器件與非CMOS器件的異構集成。換句話說,它們是封裝中的多個較小的SoC,也叫做小芯片,而不是一個大的SoC。
將大型SoC分解為較小的小芯片,與單顆裸片相比具有更高的良率和更低的成本。小芯片使設計人員可以充分利用各種IP,而不用考慮采用何種工藝節(jié)點以及采用何種技術制造。他們可以采用多種材料,包括硅、玻璃和層壓板,來制造芯片。
圖3:基于小芯片的系統(tǒng)是由中介層上的多個小芯片組成的。(圖片來源:Cadence)
扇出
在扇出封裝中,“連接”被扇出芯片表面,從而提供更多的外部I/O。它使用環(huán)氧樹脂塑封料完全嵌入裸片,不需要諸如晶圓凸塊、上助焊劑、倒裝芯片、清潔、底部噴灑充膠和固化等工藝流程,因此也無需中介層,使異構集成變得更加簡單。
扇出技術是比其他封裝類型具有更多I/O的小型封裝。2016年,蘋果借助臺積電的封裝技術,將其16納米應用處理器與移動DRAM集成到iPhone 7的一個封裝中,從而將這項技術推向舞臺。
扇出晶圓級封裝(FOWLP)
FOWLP技術是對晶圓級封裝(WLP)的改進,可以為硅片提供更多外部連接。它將芯片嵌入環(huán)氧樹脂塑封料中,然后在晶圓表面構建高密度重分布層(RDL)并施加焊錫球,形成重構晶圓。
它通常先將經過處理的晶圓切成單個裸片,然后將裸片分散放置在載板上,并填充間隙以形成重構晶圓。FOWLP在封裝和應用電路板之間提供了大量連接,而且由于襯底比裸片要大,裸片的間距實際上更寬松。
圖4:在FOWLP封裝中,硅倒裝芯片嵌入到玻璃襯底中,RDL透過芯片扇出至玻璃通孔。(圖片來源:Samtec)
異構集成
將分開制造的不同元件集成到更高級別的組件中,可以增強功能并改進工作特性,因此半導體器件制造商能夠將采用不同制造工藝流程的功能元件組合到一個器件中。
異構集成類似于系統(tǒng)級封裝(SiP),但它并不是將多顆裸片集成在單個襯底上,而是將多個IP以小芯片的形式集成在單個襯底上。異構集成的基本思想是將多個具有不同功能的元件組合在同一個封裝中。
圖5:異構集成中的一些技術構建塊。(圖片來源:日月光集團)
高帶寬內存(HBM)
HBM是一種標準化的堆棧存儲技術,可為堆棧內部以及存儲與邏輯元件之間的數據提供高帶寬通道。HBM封裝將存儲裸片堆疊起來,并通過硅通孔(TSV)將它們連接在一起,從而創(chuàng)建更多的I/O和帶寬。
HBM是一種JEDEC標準,它在封裝內垂直集成了多層DRAM器件,封裝內還有應用處理器、GPU和SoC。HBM主要以2.5D封裝的形式實現(xiàn),用于高端服務器和網絡芯片。現(xiàn)在發(fā)布的HBM2版本解決了初始HBM版本中的容量和時鐘速率限制問題。
圖6:HBM封裝將存儲裸片彼此堆疊,并通過TSV將它們連接起來以創(chuàng)建更多I/O和帶寬。(圖片來源:SK海力士)
中介層
中介層是封裝中多芯片模塊或電路板傳遞電信號的管道,是插口或接頭之間的電接口,可以將信號傳播更遠,也可以連接到板子上的其他插口。
中介層可以由硅和有機材料制成,充當多顆裸片和電路板之間的橋梁。硅中介層是一種經過驗證的技術,具有較高的細間距I/O密度和TSV形成能力,在2.5D和3D IC芯片封裝中扮演著關鍵角色。
圖7:系統(tǒng)分區(qū)中介層的典型實現(xiàn)。(資料來源:Yole Développement)
重分布層(RDL)
重分布層包含銅連接線或走線,用于實現(xiàn)封裝各個部分之間的電氣連接。它是金屬或高分子介電材料層,裸片可以堆疊在封裝中,從而縮小大芯片組的I/O間距。RDL已成為2.5D和3D封裝解決方案中不可或缺的一部分,使其上芯片可以通過中介層相互進行通信。
圖8:使用重分布層的集成封裝。(圖片來源:富士通)
硅通孔(TSV)
硅通孔(TSV)是2.5D和3D封裝解決方案的關鍵實現(xiàn)技術,是在晶圓中填充以銅,提供貫通硅晶圓裸片的垂直互連。它貫穿整個芯片來提供電氣連接,形成從芯片一側到另一側的最短路徑。
從晶圓的正面將通孔或孔蝕刻到一定深度,然后將其絕緣,并沉積導電材料(通常為銅)進行填充。芯片制造完成后,從晶圓的背面將其減薄,以暴露通孔和沉積在晶圓背面的金屬,從而完成TSV互連。
 電子發(fā)燒友App
電子發(fā)燒友App













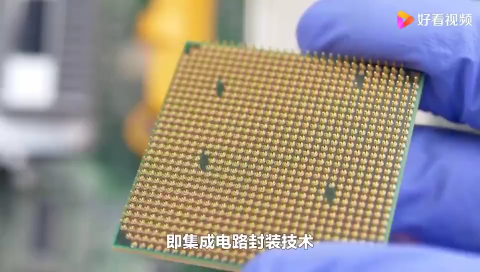

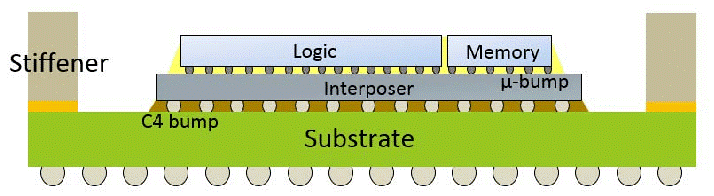




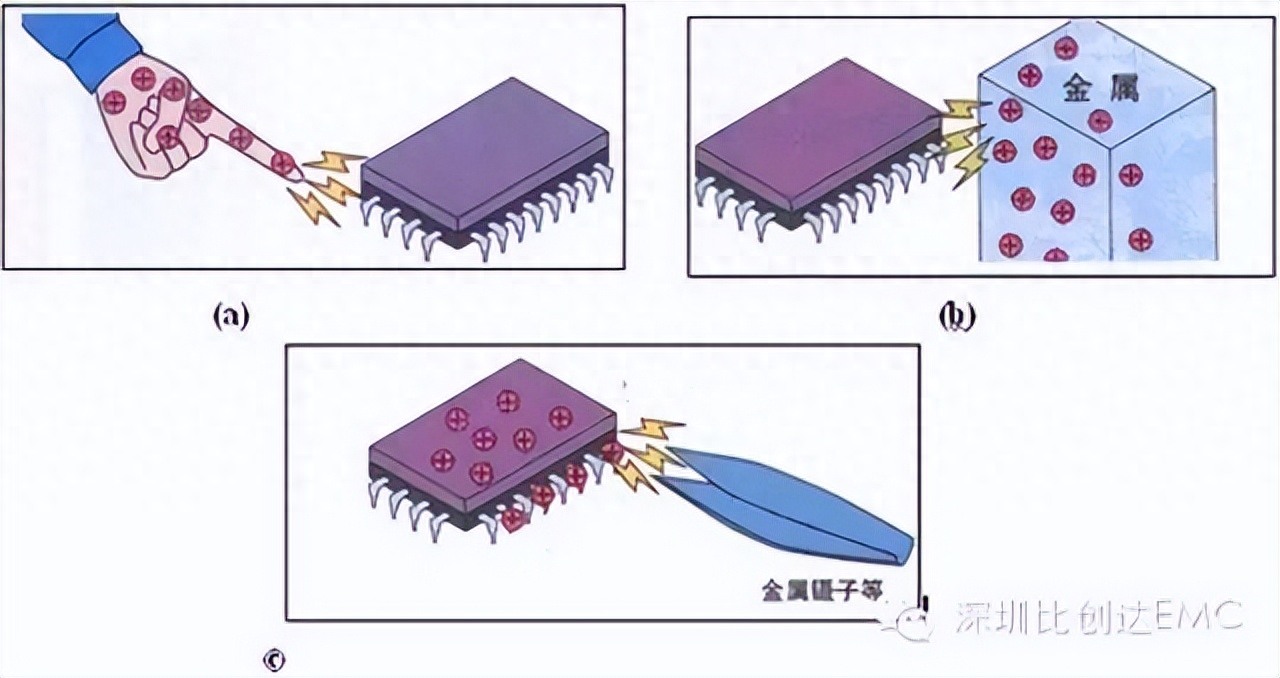
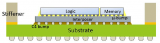












評論