完善資料讓更多小伙伴認識你,還能領取20積分哦,立即完善>
電子發燒友網技術文庫為您提供最新技術文章,最實用的電子技術文章,是您了解電子技術動態的最佳平臺。
圖1為半導體封裝方法的不同分類,大致可以分為兩種:傳統封裝和晶圓級(Wafer-Level)封裝。傳統封裝首先將晶圓切割成芯片,然后對芯片進行封裝;而晶圓級封裝則是先在晶圓上進行部分或全部封裝,之后再將其切割成單件。...
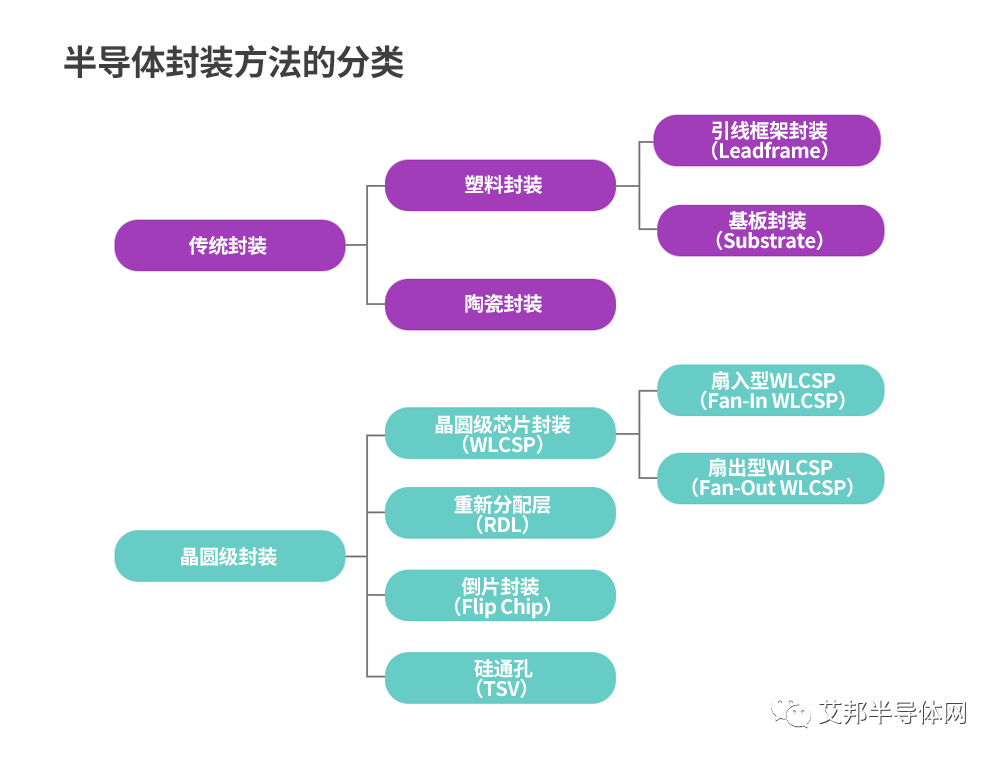
將一個或多個IC芯片用適宜的材料封裝起來,并使芯片的焊區與封裝的外引腳用引線鍵合(WB)、載帶自動鍵合(TAB)和倒裝芯片鍵合(FCB)連接起來,使之成為有實用功能的器件或組件。...

在材料方面,對于大尺寸系統級芯片(SoC)封裝來說,FCBGA基板的CTE需要更低,才能保證大尺寸芯片封裝的可靠性。ABF材料進一步降低CTE的難度很大,BT材料的半固化片的CTE可以達到1×10-6·℃-1~3×10-6·℃-1,作為堆積的絕緣材料在降低FCBGA基板整體CTE方面會做出重要貢獻。...

電荷泵是一種增加或反轉直流電壓的電壓變換器。例如,+5V可以轉換為+10V或-5V(或更高/更低的值)。...
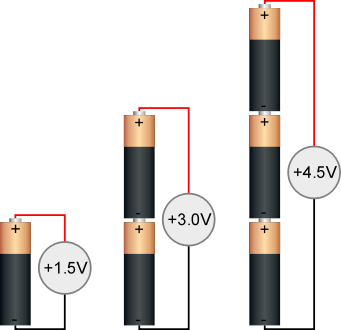
錫焊是一門科學,他的原理是通過加熱的烙鐵將固態焊錫絲加熱熔化,再借助于助焊劑的作用,使其流入被焊金屬之間,待冷卻后形成牢固可靠的焊接點。...
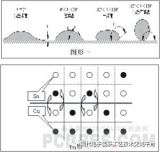
互連是另一個問題。如何將信號和電源從一個地方傳輸到另一個地方取決于很多因素:涉及信號數量、帶寬或比特率、你能容忍的延遲,以及你的預算。...
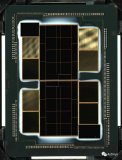
半導體:生產過程主要可分為(晶圓制造 Wafer Fabrication) 、(封裝工序 Packaging)、(測試工序 Test) 幾個步驟。...

CMP 主要負責對晶圓表面實現平坦化。晶圓制造前道加工環節主要包括7個相互獨立的工藝流程:光刻、刻蝕、薄膜生長、擴散、離子注入、化學機械拋光、金屬化 CMP 則主要用于銜接不同薄膜工藝,其中根據工藝段來分可以分為前段制程(FEOL)和后段制程(BEOL),前段制程工藝主要為 STI-CMP 和 Po...
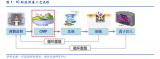
華秋自研數字系統,包括PCB/SMT自動報價系統,DFM軟件、智能拼板系統、BOM分析工具等20多種系統和工具,構建了信息化與自動化融合的數字化平臺,打通了電子全產業鏈數字化通路。...

燃氣輪機的本質上是一種通過燃料(主要為天然氣)與空氣燃燒產生出氣體推動葉片做功的機械,按照燃燒室溫度不同,目前的主流機型為E級、F級和H級。燃氣輪機的優勢在于階梯利用,可作為參照的是,目前全球最先進的百萬千瓦超超臨界煤電機組的額定工況的凈效率也不超過47%。...

在一個晶圓上,通常有幾百個至數千個芯片連在一起。它們之間留有80um至150um的間隙,此間隙被稱之為劃片街區(Saw Street)。...
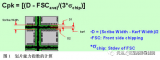
Chiplet技術是一種利用先進封裝方法將不同工藝/功能的芯片進行異質集成的技術。這種技術設計的核心思想是先分后合,即先將單芯片中的功能塊拆分出來,再通過先進封裝模塊將其集成為大的單芯片。...

What's C4 Flip Chip? ▼C4 is: Controlled Collapsed Chip Connection受控折疊芯片 連接 ▼Chip is connected to substrate by RDL and Bump芯片通過RDL和凸點連接到基板 ▼Bum...

半導體是醫療設備內部工作的一個組成部分,有助于非導體和導體之間的導電性以控制電流。反過來,制造完美半導體的組裝過程非常詳細,尤其是現在設備變得越來越小。...
雖然 1BM 的608 晶體管計算機的質量僅 為 ENIAC 的 1/30,但 1t的質量不可能成為陸車單兵的負街,更不可能作為飛機的裝載。20 世紀 60年代初,一臺能夠進行四則運算、乘方、開方的計算器,其質量和一合 21inCRT 電視機相當,體積也遠遠超過算盤和計算尺。...


先進封裝是“超越摩爾”(More than Moore)時代的一大技術亮點。當芯片在每個工藝節點上的微縮越來越困難、也越來越昂貴之際,工程師們將多個芯片放入先進的封裝中,就不必再費力縮小芯片了。本文將對先進封裝技術中最常見的10個術語進行簡單介紹。...

飛機脈動式裝配生產線最初從Ford公司的移動式汽車生產線衍生而來,是通過設計飛機裝配環節中的各個流程,完善人員配置與工序過程,把裝配工序均衡分配給相應作業站位,讓飛機以固有的節拍在站位上進行脈沖式移動,操作人員則要在固定站位完成飛機生產裝配工作。...
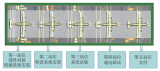
蝕刻是一種從材料上去除的過程。基片表面上的一種薄膜基片。當掩碼層用于保護特定區域時在晶片表面,蝕刻的目的是“精確”移除未覆蓋的材料戴著面具。...
