在追求不斷提高能效的過程中,MOSFET的芯片和封裝也在不斷改進(jìn)。盡管四十多年來我們對(duì)這種器件有了很多了解,但目前將它們有效地應(yīng)用于電源產(chǎn)品依然面臨挑戰(zhàn)。根據(jù)具體應(yīng)用建立FET性能模型并采用電子表格記錄數(shù)據(jù)的經(jīng)驗(yàn)豐富的設(shè)計(jì)人員,亦未能從熟悉的模型中獲得滿意的結(jié)果。
除了器件結(jié)構(gòu)和加工工藝,MOSFET的性能還受其他幾個(gè)周圍相關(guān)因素的影響。這些因素包括封裝阻抗、印刷電路板(PCB)布局、互連線寄生效應(yīng)和開關(guān)速度。事實(shí)上,真正的開關(guān)速度取決于其他幾個(gè)因素,例如切換的速度和保持柵極控制的能力,同時(shí)抑制柵極驅(qū)動(dòng)回路電感帶來的影響。同樣,低柵極閾值還會(huì)加重Ldi/dt問題。
正因?yàn)榱私怆娐分?a target="_blank">晶體管的性能很重要,所以我們將選用半橋拓?fù)洹_@種拓?fù)涫?a href="www.asorrir.com/article/special/" target="_blank">電力電子裝置最常用的拓?fù)渲弧_@些例子重點(diǎn)介紹了同步壓降轉(zhuǎn)換器——一個(gè)半橋拓?fù)涞木唧w應(yīng)用。
共源極電感效應(yīng)
圖1為具備雜散電感和電阻(由封裝鍵合線、引線框以及電路板布局和互連線帶來)等寄生效應(yīng)的半橋電路。共源電感(CSI)傾向于降低控制FET(高邊FET)的導(dǎo)通和關(guān)斷速度。如果與柵極驅(qū)動(dòng)串聯(lián),通過CSI的電壓加至柵極驅(qū)動(dòng)上,可使FET處于導(dǎo)通狀態(tài)(條件:V = -Ldi/dt),從而延遲晶體管的關(guān)斷。這也會(huì)增大控制FET的功耗,如圖2所示。
更高的功耗會(huì)導(dǎo)致轉(zhuǎn)換效率降低。另外,由于雜散電感,電路出現(xiàn)尖峰電壓的可能性很高。如果這些尖峰電壓超過器件的額定值,可能會(huì)引起故障。
為了消除或使這種寄生電感最小化,設(shè)計(jì)人員必須采用類似無引腳或接線柱的DirecFET等封裝形式,并采用使互連線阻抗最小化的布局。與標(biāo)準(zhǔn)封裝不同,DirecFET無鍵合線或引線框。因此,它可極大地降低導(dǎo)通電阻,同時(shí)大幅降低開關(guān)節(jié)點(diǎn)的振鈴,抑制開關(guān)損耗。
緩和C dv/dt感應(yīng)導(dǎo)通
影響性能的另一個(gè)因素是C dv/dt感應(yīng)導(dǎo)通(和由此產(chǎn)生的擊穿)。C dv/dt通過柵漏電容CGD的反饋?zhàn)饔茫ㄒ鸩槐匾牡瓦匜ET導(dǎo)通),使低邊(或同步)FET出現(xiàn)柵極尖峰電壓。
實(shí)際上,當(dāng)Q2的漏源極的電壓升高時(shí),電流就會(huì)經(jīng)由柵漏電容CGD 流入總柵極電阻RG ,如圖3(a)所示。因此,它會(huì)導(dǎo)致同步FET Q2的柵極出現(xiàn)尖峰電壓。當(dāng)該柵極電壓超出規(guī)定的閾值時(shí),它就會(huì)被迫導(dǎo)通。圖3(b)顯示的,正是在圖3(a)所示 典型同步壓降轉(zhuǎn)換器拓?fù)渲校紽ET Q2在這種工作模式下的主要波形。
若要準(zhǔn)確地確定低邊或同步MOSFET Q2的這種現(xiàn)象帶來的功耗,需要對(duì)其漏源電壓VDS_Q2 進(jìn)行一段時(shí)間的鉗位控制。在鉗位控制時(shí)段,其功耗約為:
在這個(gè)等式中,Vcl 代表VDS_Q2 的鉗位電壓值;fs代表開關(guān)頻率;Irrm 代表峰值反向恢復(fù)電流;tcl 代表反向恢復(fù)電流由Irrm 降至零所需的時(shí)間。
由上式可以看出,C dv/dt感應(yīng)損耗是Vin、dv/dt和開關(guān)頻率的函數(shù),反過來,它也會(huì)受驅(qū)動(dòng)速度、柵極電荷Qg、反向恢復(fù)電荷Qrr和布局的影響。因此,要想抑制這種不必要的導(dǎo)通,需要選擇具備低荷比(QGD/QGS1)的適用同步MOSFET Q2。在QGD/QGS1中,QGD代表柵漏米勒電荷,QGS1代表柵極電壓達(dá)到閾值之前的柵源電荷。盡管降低CDS 或增大CGS可降低C dv/dt感應(yīng)電壓,但Q2的C dv/dt感應(yīng)導(dǎo)通還取決于漏源電壓 VDS-Q2 和閾值電壓Vth。由于柵極閾值電壓會(huì)隨著溫度的升高而降低,因此這個(gè)問題在溫度升高情況下會(huì)進(jìn)一步惡化。因此,低閾值FET對(duì)C dv/dt問題尤其敏感。
在實(shí)際應(yīng)用中,要想評(píng)估同步MOSFET Q2,需要了解柵極電容的柵極電荷性能。因此,聰明的辦法是調(diào)查C dv/dt感應(yīng)導(dǎo)通,這需要查看累積的米勒電荷。為避免Q2錯(cuò)誤導(dǎo)通,設(shè)計(jì)人員必須確保當(dāng)漏源電壓VDS-Q2 達(dá)到輸入電壓時(shí),它必須比柵源電容的總電荷低。
最大限度降低封裝寄生效應(yīng)
簡單的數(shù)學(xué)分析表明,解決這個(gè)問題的最佳辦法是選擇小于1的電荷比QGD/QGS1。防止C dv/dt感應(yīng)導(dǎo)通的其他因素包括低驅(qū)動(dòng)漏極阻抗(《1 歐姆)、具備低RG的FET設(shè)計(jì)、外置的G-S電容器和具備最低寄生效應(yīng)和電壓振鈴的Q2封裝。
同步MOSFET Q2的導(dǎo)通電阻RDS(on) 及其封裝,在抑制C dv/dt導(dǎo)通方面具備同等的重要性。實(shí)際上,近幾年來,MOSFET供應(yīng)商對(duì)各種封裝進(jìn)行了大幅改進(jìn),使通態(tài)電阻變得很低并最大限度降低寄生效應(yīng)。例如以7引腳D2PAK封裝為例,相對(duì)于同等的標(biāo)準(zhǔn)D2PAK封裝,在相同漏源電壓VDS條件下,它的導(dǎo)通電阻降低0.4 mΩ,同時(shí)大幅改進(jìn)了電流處理功能。采用7引腳D2PAK封裝的典型代表是IRFS3004-7PPBF。該MOSFET的額定電壓為40 V,導(dǎo)通電阻為1.4 mΩ,漏電流(ID)為240 A。同樣的芯片采用傳統(tǒng)的D2PAK封裝,其通態(tài)電阻為1.8 mΩ,額定漏電流為195 A。
其他改進(jìn)的功率封裝包括功率四方扁平無引腳封裝(PQFN)和DirectFET等封裝。PQFN封裝具備多種變體。不過,與其他的封裝不同,DirectFET未采用任何鍵合線和引線框,使封裝電阻和寄生電感降至最低,如圖4所示。
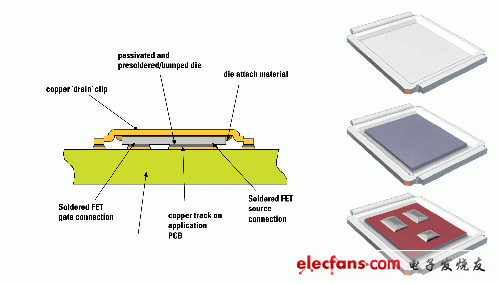
圖5和圖6為無芯片封裝的電阻和寄生電感的測量值與不同類型MOSFET封裝的頻率的對(duì)比情況。


從這些圖可以看出,DirectFET封裝與DPAK、D2PAK、SO8 和微型引線框封裝(MLP)等其他封裝相比,相對(duì)于頻率帶來的電阻和電感可忽略不計(jì)。此外,DirecFET相對(duì)于帶引腳的封裝,其寄生感應(yīng)值的變化最小,因?yàn)槟軌驇黼娮韬碗姼械姆庋b已被降至最低程度。隨著不久前對(duì)DirecFET材料和結(jié)構(gòu)的改進(jìn),這種封裝的電阻降至0.15 mΩ,寄生電感降低0.1 nH以下。唯一在封裝電阻和電感方面與DirectFET接近的封裝是MLP——PQFN的變體。
性能最大化

為進(jìn)一步闡明上述的內(nèi)容和更好地了解C dv/dt損耗對(duì)整個(gè)電路損耗的影響,讓我們用兩個(gè)MOSFET(參數(shù)如表1所示)例說明。1號(hào)器件具備高通態(tài)電阻和低電荷比值,而2號(hào)器件是具備低通態(tài)電阻和高電荷比值的晶體管。將這兩個(gè)器件插入同步壓降轉(zhuǎn)換器具備相同的Q1 MOSFET和1 MHz開關(guān)頻率的同步FET插槽。輸入電 壓為14 V,輸出電壓為1.3 V。

兩個(gè)不同的同步FET的測量損耗如圖7所示。從圖7可以看到,在寬輸出負(fù)載范圍條件下,1號(hào)器件相對(duì)于2號(hào)器件的損耗更低。實(shí)際上,在10A負(fù)載條件下,1號(hào)器件的功耗比2號(hào)器件低0.72 W。整體而言,2號(hào)器件的功耗比1號(hào)器件高出約18%,這主要是由C dv/dt導(dǎo)通損耗造成的。其中的奧秘就在于,1號(hào)器件具備更低的柵漏電荷和電荷比,因此它具備更低的或不產(chǎn)生Cdv/dt損耗。由于負(fù)載電流對(duì)C dv/dt損耗的影響不大,因此在輕載條件下,功耗的變化基本無差別。
另一個(gè)可影響電源產(chǎn)品設(shè)計(jì)的MOSFET性能的因素是布局。例如,不合理的電路板布局可增大電源電路的寄生效應(yīng),反過來,增大的寄生效應(yīng)又會(huì)提高電源的開關(guān)和導(dǎo)通損耗。此外,它還會(huì)提高電磁干擾的噪聲水平,從而使設(shè)計(jì)出的產(chǎn)品達(dá)不到理想的性能。
若要最大限度降低電路板布局帶來的影響,設(shè)計(jì)人員必須確保通過將驅(qū)動(dòng)和MOSFET盡可能地背靠背放置,從而使輸入回路面積最小化,如圖8所示。

圖8右側(cè)有一個(gè)位于FET下方的小型陶瓷支路,利用過孔形成一個(gè)極小的輸入回路。因此,需要將支路電容靠近驅(qū)動(dòng)放置,并將輸入陶瓷電容CIN 靠近高邊MOSFET放置。在這里,控制回路FET相對(duì)于同步FET具備更高的優(yōu)先權(quán)。
如果將FET并聯(lián),需要確保柵極回路阻抗匹配。另外,該布局必須采用隔離的模擬接地層和功率接地層,使大電流電路形成獨(dú)立的回路,從而不干擾敏感的模擬電路。然后,必須將這兩個(gè)接地層與PCB布局的一個(gè)點(diǎn)連接。此外,設(shè)計(jì)人員還必須利用多個(gè)過孔,使FET與輸入引腳Vin或接地層連接。電路板上任何未用區(qū)域必須灌注銅。
總之,封裝阻抗、PCB布局、互連線寄生效應(yīng)和開關(guān)速度都是影響電源電路MOSFET性能的重要因素。因此,要想在高功率密度條件下獲得最佳的轉(zhuǎn)換效率,必須在設(shè)計(jì)MOSFET過程中,充分考慮封裝、電路板布局(包括互連線)、阻抗和開關(guān)速度。
F3: 實(shí)際上,當(dāng)Q2的漏源極的電壓升高時(shí),電流就會(huì)經(jīng)由柵漏電容CGD 流入總柵極電阻RG ,如圖3(a)所示。因此,它會(huì)導(dǎo)致同步FET Q2的柵極出現(xiàn)尖峰電壓。當(dāng)該柵極電壓超出規(guī)定的閾值時(shí),它就會(huì)被迫導(dǎo)通。圖3(b)顯示的,正是在圖3(a)所示 典型同步壓降轉(zhuǎn)換器拓?fù)渲校紽ET Q2在這種工作模式下的主要波形。
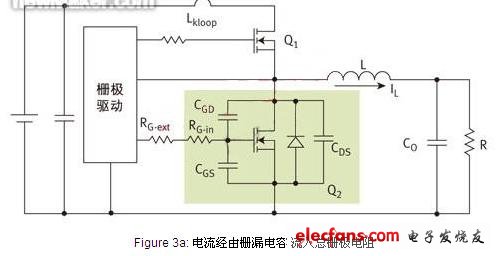
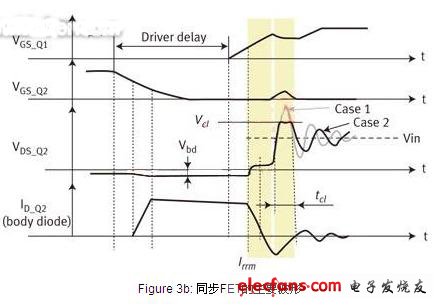
 電子發(fā)燒友App
電子發(fā)燒友App









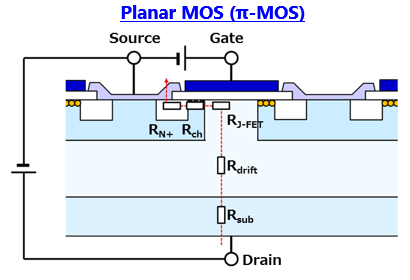










評(píng)論