在產(chǎn)品切換到無鉛工藝后,當(dāng)PCB板經(jīng)受機(jī)械應(yīng)力測(cè)試(例如沖擊和振動(dòng))時(shí),焊盤下方的基板開裂顯著增加。直接導(dǎo)致兩種類型的故障:當(dāng)表面貼裝,BGA焊盤和導(dǎo)線斷裂或兩根導(dǎo)線有電位差時(shí),在板上“建立”金屬遷移通道,如圖9-19和圖9-20所示分別。
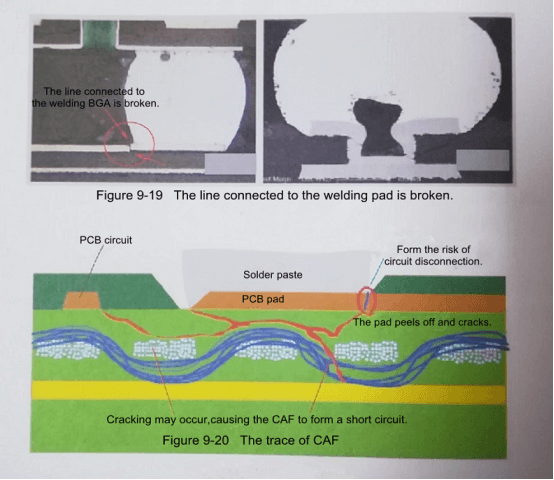
(1)無鉛焊料的硬度變高在指定的應(yīng)變水平下,傳遞到PCB焊盤界面的應(yīng)力更大。
(2)PCB從熔融焊料到固化焊料的溫差ΔT變大,導(dǎo)致CTE更不匹配在PCB和元件之間的X/Y平面上,焊點(diǎn)上的應(yīng)力更大。
(3)高Tg材料(Tg> 150°C)更脆。
這三個(gè)條件可能導(dǎo)致基材開裂增加。
PCB表面樹脂開裂發(fā)生在手機(jī)板上,如圖9-21所示。
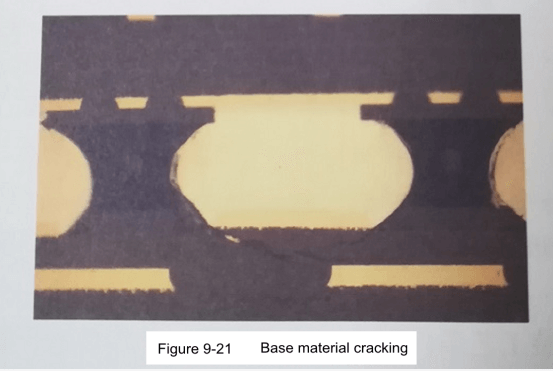
高Tg FR4材料更易受墊剝落的影響當(dāng)其他因素得到修復(fù)時(shí),重新使用標(biāo)準(zhǔn)Tg FR4材料。因此,最好在無鉛工藝中使用中間Tg FR4材料。
產(chǎn)品切換后對(duì)于無鉛,BGA焊點(diǎn)機(jī)械沖擊試驗(yàn)的主要失效模式是鉛焊點(diǎn)與無鉛焊點(diǎn)的BGA,因?yàn)闊o鉛焊點(diǎn)本身的剛性和較高的裝配溫度。焊盤下面的PCB表面樹脂開裂,鉛焊點(diǎn)的應(yīng)變電阻和無鉛焊點(diǎn)如圖9-22所示。
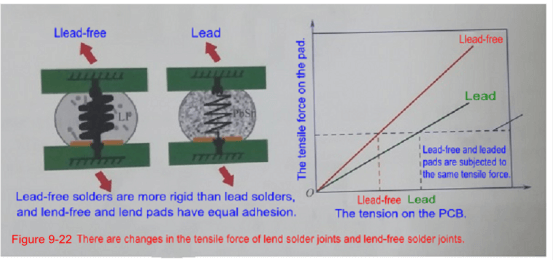
用于剝離剝離的高Tg材料標(biāo)準(zhǔn)Tg材料的最大拉伸力的比較如圖9-23所示。
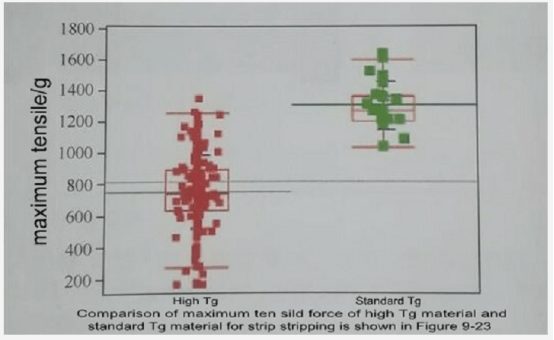
在一些公司改為無鉛后,幾個(gè)PCB次表面樹脂開裂事件發(fā)生了,表明使用大尺寸BGA時(shí)無鉛變化存在風(fēng)險(xiǎn)。
為了避免在無鉛焊接過程中PCB的分層,需要增加Td。一般來說,Dicy(雙氰胺)固化劑極性極易吸收普通FR-4水,用作PN,不易吸收水(酚醛樹脂)固化劑的含量從Dicy的5%增加到25%Wt,但同時(shí)增加了Z方向的CTE。為了降低Z方向的CTE,20%的SiO2是結(jié)果是增加了T,同時(shí)增加了PCB的剛性,降低了韌性,或者使PCB變脆。
-
pcb
+關(guān)注
關(guān)注
4351文章
23405瀏覽量
406616 -
PCB設(shè)計(jì)
+關(guān)注
關(guān)注
396文章
4775瀏覽量
89142 -
華強(qiáng)pcb線路板打樣
+關(guān)注
關(guān)注
5文章
14629瀏覽量
43730
發(fā)布評(píng)論請(qǐng)先 登錄
BGA焊盤設(shè)計(jì)與布線

SMT貼片加工元件位移全解析:原因、影響與預(yù)防措施
關(guān)于SMT回流焊接,你了解多少?
SMT組裝過程中缺陷類型及處理
SMT貼片加工虛焊現(xiàn)象:原因分析與解決步驟全解析
SMT錫膏貼片加工過程中出現(xiàn)漏件損件的原因分析

pcb焊盤區(qū)域凸起可以焊嗎
pcb設(shè)計(jì)中如何設(shè)置默認(rèn)的焊盤大小參數(shù)?
SMT貼片加工過程中容易出現(xiàn)問題的封裝類型原因

SMT貼片加工中避免導(dǎo)通孔與焊盤的連接不良的有效方法
SMT貼片加工產(chǎn)生焊接裂縫的原因是什么?
SMT貼片加工前必備,PCB與元器件烘烤的重要性






 了解SMT加工過程中BGA焊盤下PCB樹脂材料開裂的原因
了解SMT加工過程中BGA焊盤下PCB樹脂材料開裂的原因

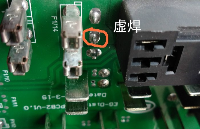










評(píng)論