一般來說,非半導體從業者,是見不到上圖的晶圓這個形態的,我們一般能見到的形態就是電路板上焊著的模塊,仔細觀察這些模塊,可以看到這些模塊表面是塑料包裹著的,并且在周邊伸出一小段金屬,并被焊接在電路板(PCB板)上,見下圖,上面焊接著大大小小不同大小的模塊,這些模塊與PCB板自身內部電路組成了實現某種功能的一個系統,將這塊PCB板接到總電路或者直接接上電源和產品負載就可以工作了。
這些小的模塊塑料內部核心就是作為半導體FAB廠工程師的全部工作內容,它們就是來源于上圖的晶圓,這個晶圓上全部是其中的一種或者幾種模塊的重復結構(由光刻版上圖形決定,以后會講到),這些成千上萬的重復結構在完成晶圓廠的加工、測試合格后,會到封裝廠,用非常細的鋸(厚度幾十微米)將貼合在藍膜上的晶圓按照事先畫好的劃片道將晶圓上這些重復單元切割成獨立的單元,這些獨立的單元就是前面見到的塑料模塊內的核心結構die,每個核心結構上都設置有不同數量的引線腳,這些引線腳的作用是留作引線焊接之用。
用金屬引線將這些引線腳與金屬框架焊接好,這樣,金屬框架就與晶圓上的重復單元做好了連線,但是這樣一個結構直接焊接到PCB板上穩定性不夠,無法在高低溫,高濕,震動等發雜環境下保持穩定,需要將這個結構用塑料包裹固定起來,經過塑封好的結構,核心結構得到了固定,控制了導熱,導電性能,再經過嚴苛的篩選機制,即Final Test(FT)測試,以及抽樣reliability測試(可靠性測試),壽命一般要達到了10年以上(加應力測試,并非測10年,屬于可靠性測試范疇,以后也會涉及,常見的有在增加應力條件下測試168小時和1000小時兩種),滿足了FT測試的封裝樣品才會拿來使用。
不同系統級廠家針對自己需要的模塊,到相應的模塊供應商處購買封裝模塊,并焊接在PCB板上,再進行PCB板系統級測試,上機測試,直到用戶產品使用跟進反饋,如果用戶端短期內未發現問題,則證明產品從設計到生產,封裝,測試都是沒有問題的,一旦到用戶端短期內發現問題,那么追查問題則變得非常困難,要一層一層確認,損失也是最大的,所以,在最初晶圓上就把問題發現出來(如果是晶圓問題),通過測試將問題die篩選出來棄用,會減少非常多不必要的麻煩,這塊暫時不再深入探討,后面有機會再談,本文主要講述一個半導體產品的來龍去脈,讓新人有一個大體籠統的認識,后面再慢慢展開。
其實還有一個非常關鍵的沒有講,就是晶圓的基底是怎么來的,經過哪些過程才成為了劃片前的重復單元的,下面簡單介紹一下。
半導體晶圓按直徑大小不同分為6英寸,8英寸,12英寸,18英寸(現在還處于實驗室階段),不同大小的晶圓又是從不同直徑的硅晶棒切割而來的,這些硅晶棒是襯底供應商的主要工作內容,制造單晶硅有兩種方法:直拉法和區熔法,這里只提一下兩種方法,具體方法不做詳細介紹,后面有機會進一步介紹,硅晶棒拉好后,再經過切割,研磨,拋光步驟,獲得生產用的硅襯底,有的需要在襯底上再用外延爐生長一層外延層,根據要求,可以制備N型或者P型外延。
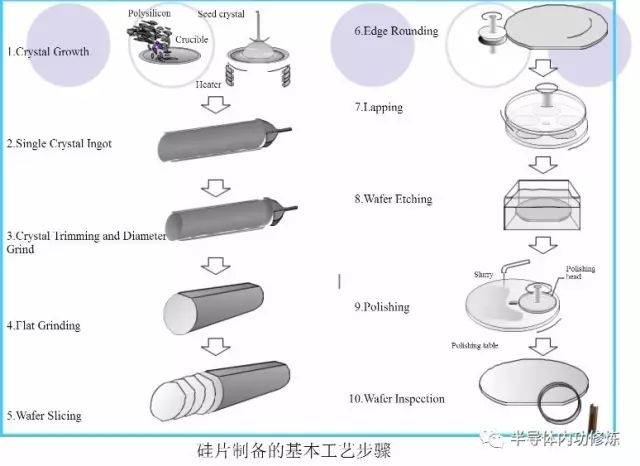
下面簡單介紹一下如何利用硅襯底制造出器件。
半導體晶圓加工廠一般有4個模組:光刻,刻蝕,擴散,薄膜,有的工廠會細分.。以一個二極管器件為例,講解一下如何生產一個二極管產品:我們在學習電路的時候,看到的二極管只是一個符號,實際在制造的時候要復雜得多,簡單的說,先要將符號轉換成版圖,然后將版圖制造成不同層次的光刻版,然后按不同的制造順序,將PN結先后制造到硅片上,在過程中,要用到微影光刻技術,還要用到離子注入,擴散,刻蝕,薄膜等步驟,將PN結做到硅片上后,需要將PN結用導線引出來,才能給PN結加電壓,所以就需要用金屬層淀積到接觸孔里,然后留出做引線腳的窗口PAD,從描述可以知道,需要做5層光刻版,N型區,P型區, 接觸孔,金屬層,PAD區域,來定義不同層次空間位置,有的產品PN結的一個結用襯底做,就少了一層,這樣,經過復雜的工藝步驟之后,最簡單的PN結二極管就做好了,后面再經過之前講的封裝測試就可以焊接到電路板上了。

具體講解如下:
(1)制造二極管的光刻版:在玻璃基底上淀積一層鉻膜,芯片圖形就是由鉻膜形成的,對于工藝中不同層次的結構,需要生成不同的光刻版,并且將各個圖形位置精確定位,光刻版一般由一個產品芯片重復構成,有的為了節約成本,會放置多個產品;
(2)有了光刻版和硅片襯底,就可以開始加工芯片了,芯片的主體加工過程一般包括多次光刻步驟,光刻的原理比較簡單,類似于照相時將底片轉移到相紙上的過程,光刻版上的鉻層不透光,當光線照射到光刻版上時,透光的區域光線穿過光刻版,按5:1的比例投影到涂有對光敏感的光刻膠的圓片上,光刻膠在特定波長的光線下發生反應,使原本交聯的高分子有機物打開,在特定的顯影液作用下,這些打開了交聯鍵的有機物會被從圓片表面去除(正膠),留下未被光照射到的區域,形成芯片的特定區域,該區域經過離子注入即形成PN結的一個區域,如P區;
(3)同樣的光刻步驟再來一次,再經過離子注入形成PN結的另一個結N區;
(4)在離子注入之后,對圓片進行高溫擴散工藝,可以將PN結濃度推到需要的程度,過程中一般會生長氧化層,然后一般會利用BOE(NH4.H20和HF酸的混合液體)將二氧化硅腐蝕掉;
(5)為了將PN結用金屬引出,需要將金屬與硅片之間隔離,一般用CVD(化學氣象沉積)的方法淀積一層氧化層,然后同樣光刻的方法,形成接觸孔的圖形,然后用干法或者濕法方法將接觸孔圖形對應的氧化層去除掉;
(6)用PVD(物理氣相沉積)的方法在圓片 表面淀積一層金屬層,然后用光刻的方法形成金屬走線圖形,將不需要金屬的區域去除掉;
(7)作為一個半導體器件,需要防刮傷,防水汽等,因此需要在最表面淀積一層防護層,我們稱之為“鈍化層”,鈍化層淀積好后,前面講到的要留出一塊區域來作為封裝時與金屬框架做鍵合的窗口區域,一般叫PAD區域,因此同樣需要光刻工藝將該區域打開,通過干法刻蝕的方法將鈍化層去除,漏出該區域的金屬,為后面鍵合做準備,一般最后在測試前需要做一步合金工藝,使金屬與硅片襯底形成良好的接觸,同時可以修復一些可動電荷帶來的損傷,再經過WAT/PCM測試合格后就完成了PN結芯片的全部加工步驟。
以上僅僅是簡單介紹一下一個芯片是如何加工的,具體會涉及到非常復雜的工藝步驟,后面有機會慢慢講解,本文僅僅是一個科普性質的文章,作為半導體入門的準備之用,想要做好半導體工程師,要學的東西還多著呢!
-
半導體
+關注
關注
335文章
28563瀏覽量
232193 -
晶圓
+關注
關注
52文章
5113瀏覽量
129140
原文標題:看完本文,你會發現半導體其實沒有那么神秘!
文章出處:【微信號:Semiconshop,微信公眾號:半導體商城】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
中國半導體的鏡鑒之路
常用半導體手冊
半導體制冷片電流過大
半導體的導電特性
半導體制程
半導體測試解決方案
半導體芯片內部結構詳解
半導體管的擴流方法
異步信號的處理真的有那么神秘嗎
小衛星制造沒有那么難,其實和IT攢機差不多






 其實半導體也沒有那么神秘
其實半導體也沒有那么神秘










評論