用于高端邏輯半導(dǎo)體量產(chǎn)的EUV(Extreme Ultra-Violet,極紫外線光刻)曝光技術(shù)的未來藍(lán)圖逐漸“步入”我們的視野,從7nm階段的技術(shù)節(jié)點(diǎn)到今年(2019年,也是從今年開始),每2年~3年一個階段向新的技術(shù)節(jié)點(diǎn)發(fā)展。
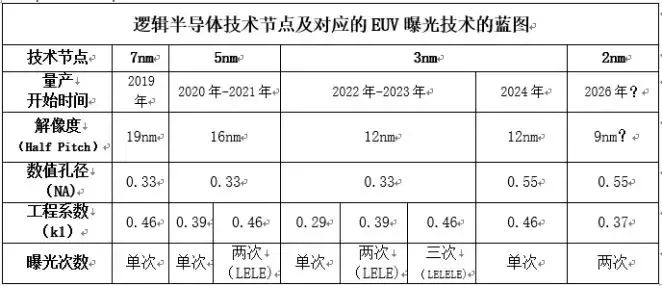
高端邏輯半導(dǎo)體的技術(shù)節(jié)點(diǎn)和對應(yīng)的EUV曝光技術(shù)的藍(lán)圖。
也就是說,在EUV曝光技術(shù)的開發(fā)比較順利的情況下,5nm的量產(chǎn)日程時間會大約在2021年,3nm的量產(chǎn)時間大約在2023年。關(guān)于更先進(jìn)的2nm的技術(shù)節(jié)點(diǎn),還處于模糊階段,據(jù)預(yù)測,其量產(chǎn)時間最快也是在2026年。
決定解像度(Half Pitch)
的是波長和數(shù)值孔徑、工程系數(shù)
技術(shù)節(jié)點(diǎn)的發(fā)展推動著半導(dǎo)體曝光技術(shù)解像度(Half Pitch)的發(fā)展,ArF液浸曝光技術(shù)和EUV曝光技術(shù)等的解像度(R)和曝光波長(λ)成正比,和光學(xué)的數(shù)值孔徑(NA,Numerical Aperture)成反比,也就是說,如果要增大解像度,需要在縮短波長的同時,擴(kuò)大數(shù)值孔徑。
實際上,解像度和被稱為“工程系數(shù)(k1)”的定數(shù)也成一定的比例關(guān)系。如果降低工程系數(shù),解像度就會上升。但是,工程系數(shù)如果降低到最小極限值(0.25),就無法再降低了。

ArF液浸曝光技術(shù)、EUV曝光技術(shù)中的解像度(Half Pitch)(R)和波長、數(shù)值孔徑(NA)、工程系數(shù)(k1)的關(guān)系。
在ArF液浸曝光技術(shù)、EUV曝光技術(shù)中,光源的波長是固定的,無法改變。順便說一下,ArF液浸曝光的波長是193nm,EUV曝光的波長是13.5nm。兩者有超過10倍的差距,單純計算的話,EUV曝光絕對是占優(yōu)勢。
對ArF液浸曝光技術(shù)以前的光制版(lithography)技術(shù)來說,提高數(shù)值孔徑是提高解像度的有效手段。具體來說,就是通過改良作為曝光設(shè)備的Stepper和Scanner,來提高數(shù)值孔徑。
與之相反,運(yùn)用EUV曝光技術(shù)的話,不怎么需要改變數(shù)值孔徑,EUV曝光技術(shù)利用X線的反射光學(xué)系統(tǒng),光學(xué)系統(tǒng)擁有非常復(fù)雜的構(gòu)造,同時光學(xué)系統(tǒng)的變化也會伴隨著巨額的開發(fā)投資。所以,過去一直以來EUV曝光設(shè)備方面從沒有更改過數(shù)值孔徑。最初的EUV scanner的數(shù)值孔徑是0.25,現(xiàn)行設(shè)備的數(shù)值孔徑是0.33,不管怎么說,和ArF Dry曝光技術(shù)的最高值(0.93)相比,都是很低的。
正如在本欄目中去年(2018年)12月報道的一樣(使用EUV曝光的高端邏輯半導(dǎo)體和高端DRAM的量產(chǎn)終于開始了!),用于量產(chǎn)7nm的最尖端邏輯半導(dǎo)體的EUV scanner--“NXE:3400B”內(nèi)置的數(shù)值孔徑是0.33。
而且,今后數(shù)年內(nèi),都會在使用數(shù)值孔徑為0.33的EUV scanner的同時,提高解像度。換句話說,也就是通過使用同樣數(shù)值孔徑的曝光設(shè)備來使解像度(Half Pitch)更細(xì)微化。
通過階段性地降低工程系數(shù)來提高解像度
所以,很多用來提高細(xì)微化的辦法都被限制了,因為波長和數(shù)值孔徑是固定的,剩下的就是工程系數(shù)。光學(xué)方面,通過降低工程系數(shù),可以提高解像度。和ArF液浸曝光技術(shù)一樣,通過和Multi-patterning 技術(shù)組合起來,就可以達(dá)到實質(zhì)上降低工程系數(shù)的效果。而且,機(jī)械方面,有必要降低曝光設(shè)備的重合誤差。

提高EUV曝光技術(shù)的解像度的方法(2019年以后)
據(jù)EUV曝光設(shè)備廠商ASML說,他們把未來EUV曝光技術(shù)方面的細(xì)微化工作分為“四代”。現(xiàn)行技術(shù)水平是第一代,同時也是7nm邏輯半導(dǎo)體的量產(chǎn)是用的技術(shù)。工程系數(shù)是0.45左右。
第二代是把工程系數(shù)降低到0.40以下,通過改良曝光技術(shù)的硬件(光學(xué)方面)和軟件(阻焊層,resist)得以實現(xiàn)。其技術(shù)核心也不過是改良現(xiàn)行技術(shù)。
第三代是把工程系數(shù)降低到0.30以下,要得以實現(xiàn),只改良現(xiàn)行技術(shù)比較困難,需要導(dǎo)入像Multi-pattering、新型mask材料、新型resist材料等這些基本要素。
第四代,由于工程系數(shù)無法再降低,所以開發(fā)新的光學(xué)系統(tǒng),它可以數(shù)值孔徑提高到0.55。

EUV曝光設(shè)備廠家ASML公布的EUV曝光技術(shù)的發(fā)展。
ASML公布的技術(shù)發(fā)展資料里面沒有提到工程系數(shù)的具體數(shù)值,不過我們把工程系數(shù)的假設(shè)值放進(jìn)去計算了一下,看看解像度可以提到何種程度,現(xiàn)行(第一代)的工程系數(shù)是0.46,其對應(yīng)的解像度(Half Pitch)是19nm。
假設(shè)第二代的工程系數(shù)為0.39,對應(yīng)的解像度為16nm,如果是最先進(jìn)的邏輯半導(dǎo)體的技術(shù)節(jié)點(diǎn)的話,可以適用于7nm~5nm的量產(chǎn)品。
假設(shè)第三代的工程系數(shù)是0.29,對應(yīng)的解像度是12nm,如果是最先進(jìn)的邏輯半導(dǎo)體的技術(shù)節(jié)點(diǎn)的話,可以適用于5nm~3nm的量產(chǎn)品。
由于第四代大幅度更改了數(shù)值孔徑,工程系數(shù)假設(shè)為0.46,和第一代相同。假設(shè)數(shù)值孔徑為0.55,工程系數(shù)即使增加為0.46,相對應(yīng)的解像度也和第三代基本相同,為11.3nm,可以適用于5nm~3nm的量產(chǎn)品。
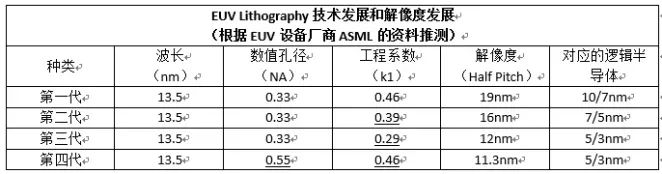
EUV曝光技術(shù)發(fā)展和解像度的發(fā)展。以EUV曝光機(jī)廠商ASML發(fā)布的數(shù)據(jù)為基礎(chǔ)作者推測的數(shù)字。
把Multi-patterning(多重曝光)
導(dǎo)入到EUV曝光技術(shù)里
不需要改良光學(xué)系統(tǒng)和阻焊層(resist)等曝光技術(shù),把工程系數(shù)k1實質(zhì)性地降低的辦法----Multi-patterning(多重曝光)技術(shù)。正在討論把ArF液浸曝光方面廣泛普及的多重曝光技術(shù)應(yīng)用到EUV曝光技術(shù)里。
比方說,兩次曝光就是導(dǎo)入LELE技術(shù),即重復(fù)兩次Lithography(L)和Etching(E),如果把LELE技術(shù)導(dǎo)入到工程系數(shù)為0.46的EUV曝光技術(shù)(數(shù)值孔徑為0.33)上,解像度會變?yōu)?6nm,這和把單次曝光時的工程系數(shù)降到0.39得到的效果一樣。
三次曝光,即導(dǎo)入LELELE技術(shù),重復(fù)三次Lithography(L)和Etching(E),再次降低解像度,為12nm,這和把單次曝光時的工程系數(shù)降低到0.29得到的效果一樣。
但是,利用多重曝光技術(shù)的話,“吞吐量(through-put)”會大幅度降低,單次曝光(SE技術(shù))的晶圓處理數(shù)量約為130片/小時,兩次曝光(LELE)曝光的話,下降為70片/小時,三次曝光(LELELE)曝光的“吞吐量”下降為單次的1/3,為40片/小時。

聯(lián)合運(yùn)用EUV曝光和多重曝光的解像度和“吐出量”的變化(k1是0.46),作者根據(jù)ASML公布的數(shù)據(jù)總結(jié)的數(shù)字。
總結(jié)一下,新型的5nm技術(shù)有兩個方向,第一、維持著單次曝光技術(shù)的同時,把工程系數(shù)下降到0.39;第二、通過利用兩次曝光(LELE技術(shù))技術(shù),實質(zhì)性地降低工程系數(shù)。兩個的解像度都是16nm,預(yù)計量產(chǎn)開始時間為2021年。如果采用兩次曝光技術(shù),預(yù)計量產(chǎn)時間可以提前到2020年。
第三代的3nm技術(shù)的節(jié)點(diǎn)稍微有點(diǎn)復(fù)雜,有三個方向:第一、把單次曝光的工程系數(shù)維持為0.29;第二、聯(lián)合兩次曝光(LELE技術(shù))和把工程系數(shù)改為0.39的曝光技術(shù);第三、利用三次曝光(LELELE)技術(shù)。三個方向的解像度都是12nm,預(yù)計量產(chǎn)時間為2023年。但是,如果采用三次曝光的話,量產(chǎn)時間有可能再提前。
關(guān)于第四代2nm技術(shù)節(jié)點(diǎn),如果用數(shù)值孔徑為0.33的EUV曝光技術(shù)估計很難實現(xiàn)。應(yīng)該是期待把數(shù)值孔徑提高到0.55的EUV曝光技術(shù)。
EUV曝光設(shè)備的組合運(yùn)用,
繼續(xù)改良精度和生產(chǎn)性能
EUV曝光技術(shù)的開發(fā)方面最重要的是EUV曝光設(shè)備(EUV scanner)的改良。EUV曝光設(shè)備廠商ASML已經(jīng)公布了繼用于現(xiàn)行量產(chǎn)品7nm的EUV scanner--“NXE:3400B”之后的開發(fā)藍(lán)圖。
據(jù)ASML的技術(shù)藍(lán)圖預(yù)測,以“NXE:3400B”為基礎(chǔ),首次開發(fā)降低重合誤差的版本,后面是以“降低重合誤差版本”為基礎(chǔ),開發(fā)提高“吐出量”(生產(chǎn)性能)的版本。預(yù)計在今年(2019年)的上半年,完成這些改良。
基于以上改良成果的新產(chǎn)品“NXE:3400C”預(yù)計會在今年年末開始出貨,預(yù)計“NXE:3400C”將要“擔(dān)任”5nm的量產(chǎn)工作。
而且,降低重合誤差的同時,還要開發(fā)提高產(chǎn)能的新版本,ASML還沒有公布新版本的型號,出貨時間預(yù)計在2021年的下半年,新版本應(yīng)該會承擔(dān)3nm的量產(chǎn)工作吧。
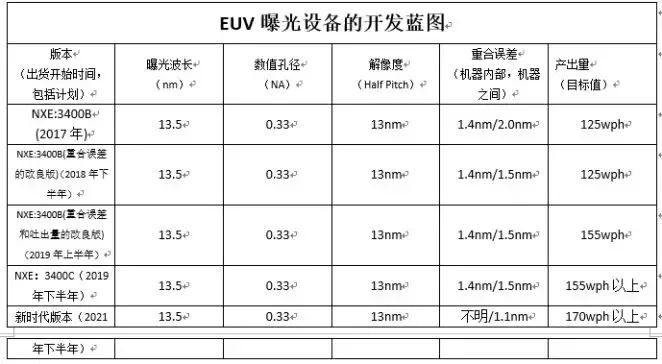
EUV曝光設(shè)備(EUV scanner)的開發(fā)藍(lán)圖,作者根據(jù)ASML公布的數(shù)據(jù)匯總的。
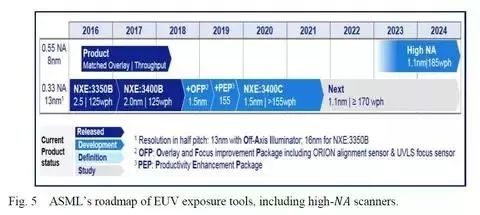
EUV曝光設(shè)備的開發(fā)藍(lán)圖,摘自2018年12月ASML在國際學(xué)會IEDM上發(fā)布的論文。
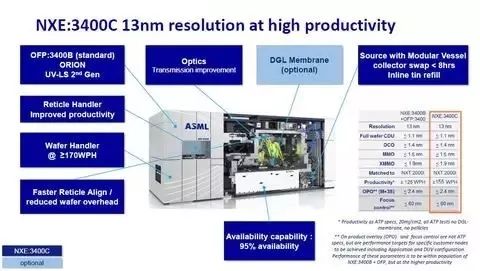
新一代用于量產(chǎn)的EUV曝光設(shè)備(EUV scanner)“NXE:3400C”的概要,出自ASML在2018年12月國際學(xué)會IEDM的演講資料。
這些曝光設(shè)備基本都是搭載了數(shù)值孔徑為0.33的光學(xué)系統(tǒng)。ASML同時也在致力于開發(fā)把數(shù)值孔徑提高到0.55的EUV曝光設(shè)備。
被ASML稱為“High NA”的、數(shù)值孔徑為0.55的EUV scanner的出貨時間預(yù)計在2023年的下半年,首批試驗設(shè)備預(yù)計在2021年年底做成。關(guān)于“High NA”設(shè)備的開發(fā)情況,我們后續(xù)會繼續(xù)報道。
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28504瀏覽量
231783 -
EUV
+關(guān)注
關(guān)注
8文章
609瀏覽量
86852
原文標(biāo)題:視角 | 從技術(shù)角度看:EUV光刻將走向何方?
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
混合信號設(shè)計的概念、挑戰(zhàn)與發(fā)展趨勢
工業(yè)電機(jī)行業(yè)現(xiàn)狀及未來發(fā)展趨勢分析
機(jī)械硬盤的未來發(fā)展趨勢探析
日本首臺EUV光刻機(jī)就位
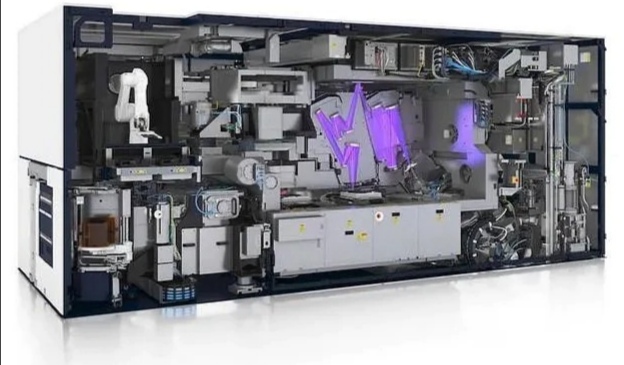
Zigbee智能家居的未來發(fā)展趨勢
未來物流發(fā)展趨勢與TMS的關(guān)系
最新CMOS技術(shù)發(fā)展趨勢
未來的ar技術(shù)發(fā)展趨勢
邊緣計算的未來發(fā)展趨勢
云計算技術(shù)的未來發(fā)展趨勢
未來AI大模型的發(fā)展趨勢
變阻器的未來發(fā)展趨勢和前景如何?是否有替代品出現(xiàn)?
未來隧道定位導(dǎo)航技術(shù)有哪些發(fā)展趨勢






 探析EUV光刻未來的發(fā)展趨勢
探析EUV光刻未來的發(fā)展趨勢
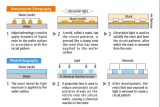










評論