* 本活動Banner由主辦方SEMI提供
Event
? 時間:3月25日
? 地點:上海浦東嘉里大酒店,浦東廳 1
芯和半導體科技(上海)股份有限公司(以下簡稱“芯和半導體”)將于3月25日參加在上海浦東舉辦的SEMICON CHINA展期間的重要會議——異構集成(先進封裝)國際會議。作為國內Chiplet先進封裝EDA的代表,芯和半導體創始人、總裁代文亮博士將于下午發表題為《多物理場協同仿真加速AI硬件集成系統設計》的主題演講。
活動簡介
自ChatGPT問世,生成式AI 和HPC的應用呈指數式增長,進一步推升了對于巨大算力、高速傳輸、海量存儲,極低能耗的芯片需求,半導體產業突破了晶體管尺寸微縮的單一路徑,以異構集成為代表的系統集成得到快速發展。異構集成利用2D, 2.5D, 3DIC封裝集成Chiplet,融合Hybrid bonding、TGV、HBM,通過系統協同設計集成多模塊和子系統,為塑造AI未來夯實基礎。
異構集成和Chiplet的發展現狀如何?產業主要挑戰和解決方案在哪里?
異構集成國際會議(HIIC 2025)聚焦異構集成關鍵技術與產業方向,凝聚產業鏈上下游智慧。在這里,您將聆聽行業領袖的深度見解,共同剖析技術難題,探索產業發展新路徑,把握AI智能浪潮下的半導體產業發展的新機遇。
主題演講
《多物理場協同仿真
加速AI硬件集成系統設計》
專題2:AI發展下的產業生態
演講人
芯和半導體創始人、總裁代文亮博士
時間
3月25日, 1530
演講摘要
隨著AI應用滲透到千行百業,模型的復雜度和參數數量不斷增加,導致對算力資源的需求爆發式上升,以便進行高效的訓練和推理。傳統基于DTCO (器件技術協同優化)構建的大算力芯片系統,需評估驗證大規模集群數據中心高功率高負荷運行帶來的影響,STCO(系統技術協同優化)的推行正成為行業共識。本次報告將聚焦AI硬件集成系統設計面臨的挑戰,闡述如何通過多物理場協同仿真EDA平臺,全面解決系統級的高速互連信號完整性,電源完整性、電熱/流體熱、應力可靠性等方面的問題,加速AI硬件集成系統的設計開發。
-
芯和半導體
+關注
關注
0文章
117瀏覽量
31719 -
異構集成
+關注
關注
0文章
36瀏覽量
2043 -
先進封裝
+關注
關注
2文章
460瀏覽量
501
原文標題:SEMICON異構集成國際會議 | 芯和半導體發表主題演講,聚焦AI硬件集成新趨勢
文章出處:【微信號:Xpeedic,微信公眾號:Xpeedic】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
會議邀請 | Aigtek與您相約智能材料與傳感國際會議暨第二屆鐵電壓電材料青年學者論壇!

茂睿芯亮相2025(春季)亞洲充電展

朗迅芯云半導體亮相SEMICON China 2025
應用材料公司受邀參加SEMICON China 2025和CSTIC 2025
砥礪創新 芯耀未來——武漢芯源半導體榮膺21ic電子網2024年度“創新驅動獎”
芯和半導體將參加重慶半導體制造與先進封測產業發展論壇
芯和半導體將參加2025年玻璃基板TGV產業鏈高峰論壇
2024人因工程與智能系統交互國際會議首次國內召開,米喬協力帶來新突破

華普微算法專家杜凡平出席ICCC 2024國際會議,并發表學術演講

中軟國際亮相無錫太湖流域水治理國際會議
青銅劍技術出席第二十屆IET交直流輸電國際會議
智芯科榮獲2024“芯力量”最具投資價值獎
芯和半導體出席2024 IEEE AP-S/URSI國際會議






 芯和半導體將參加SEMICON異構集成國際會議
芯和半導體將參加SEMICON異構集成國際會議
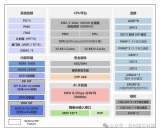










評論