傳統塑料基板已經無法滿足系統級封裝信號傳輸速度、功率傳輸、設計規則和封裝基板穩定性的復雜需求,玻璃基板需求暴漲,玻璃基板有比塑料基板更光滑的表面,同樣面積下,開孔數量要比在有機材料上有明顯優勢。
此外,玻璃芯通孔之間的間隔能夠小于 100 微米,這直接能讓晶片之間的互連密度提升10倍。互連密度的提升能容納更多數量的晶體管,從而實現更復雜的設計和更有效地空間利用。
與此同時,玻璃基板在熱學性能、物理穩定度方面表現都更出色、更耐熱,不容易因為溫度高而產生翹曲或變形的問題。
全球巨頭將玻璃基板聚焦于2.5D/3D封裝、系統級以及CPO和下一代AI芯片
康寧中國區表示半導體先進封裝是公司戰略布局的重要一環,康寧玻璃晶圓/面板主要服務于包括先進封裝和光電共封裝(CPO)客戶。以玻璃載板平整度以及熱膨脹系數(CTE)于客戶的晶圓相互匹配,康寧熔融下拉工藝可以提供非常完美的表面質量、平整度,以及大尺寸和可量產性。除了玻璃基板,還將它做成玻璃晶圓/面板成品給到客戶,包括先進封裝和光電共封裝(CPO)客戶。
康寧顯著的合作案例有:他們通過將Ayar Labs的TeraPHY光學I/O小芯片與康寧的玻璃基波導模塊相結合。另外愛立信正在與Ayar Labs和康寧合作開發這種人工智能驅動的解決方案,也融入了Intel的光電基板的光學和電學的實現技術路徑。
基于玻璃基板的混合光子集成系統
特種玻璃巨頭肖特發力半導體業務,新材料基板成為下一代芯片突破口。2024年8月肖特中國在蘇州設立“半導體先進封裝玻璃解決方案“部門,為中國半導體行業的合作伙伴提供定制化解決方案。已經在為頭部半導體企業量身定制玻璃基板產品,以支持HD Fanout、2.5D/3D、PLP等先進封裝工藝的實現,滿足小芯片集成度的提高,支持更高的算力需求。
肖特玻璃
英特爾在玻璃基板開發方面處于領先地位,這是由于當前 RDL 中介層解決方案的限制以及對更精細凸點間距的需求所驅動的。然而,玻璃基板技術面臨幾個挑戰,英特爾表示玻璃比傳統基板材料更脆,難以加工。形成穿透玻璃導孔(TGV)需要先進的蝕刻和沉積技術。必須開發新的工具和流程來有效處理玻璃基板。
盡管困難重重,但英特爾正在向數據中心、人工智能和圖形構建在2030年實現單個封裝體內集成1萬億個晶體管的目標挺近。此外,英特爾研發的共同封裝光學元件技術,CPO預計將于24年年底投入生產。
作為玻璃基板的最大潛在客戶,臺積電除維持 CoWoS擴張外,正在建立部署玻璃芯的扇出型面板級(515X510mm)封裝。其攻堅動力來自英偉達的未來AI芯片需求。臺積電強調了高集成良率的重要性,特別是對于在昂貴的先進邏輯節點上制造的頂層芯片。為解決集成水平的提高,分割和拾取放置的挑戰性,臺積電正在聯合業界支持開發、新型熱界面材料(TIMs)、有機模塑化合物、底填材料和先進的過程控制和計量工具。
臺積電正在根據英偉達的需求為其未來的FOPLP開發玻璃基板,以領先于競爭者將,最早2025-2026年推出解決方案進入市場。臺積電還和英特爾正在積極擴大研發力度。
為此,許多臺灣制造商將一人得道雞犬升天。臺灣制造商成立了“玻璃基板供應商電子核心系統聯盟”,以匯集專業知識。該聯盟專注于通過玻璃通孔(TGV)等精煉工藝,這是大規模生產玻璃基板的瓶頸。2024年對臺積電來說已經是一個重要的一年,該公司最近也啟動了蘋果的2納米芯片組試生產。
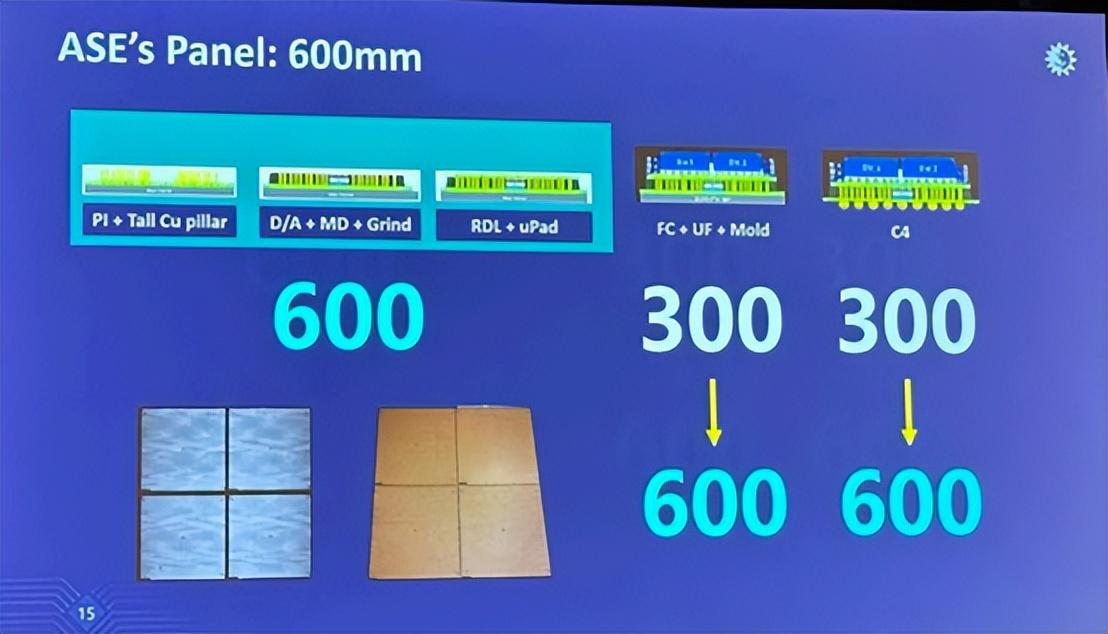
日月光作為半導體封裝和測試領域的領導者,在 FOPLP 技術上取得了重大進展。基于玻璃芯,構建更大尺寸的板級封裝成為日月光的探索目標。除了板級處理在大批量生產中可以帶來顯著的成本節約,還有更高的產出,如對于相同的中介層尺寸,600x600mm 的面板可以容納 8 倍于 12 英寸晶圓的中介層數量。目前日月光能夠控制 600x600mm 板級封裝并實現有效的翹曲和斷裂控制,5μm/5μm RDL 線寬/間距能力,還計劃在 2025 年前開發 2μm/2μm 原型。
隨著人工智能熱潮進入下一步,玻璃基板將在未來發揮巨大作用。玻璃芯基板可能在 2027-2028 年左右進入大規模生產,緊隨高性能應用中 FOPLP 的采用之后。激進者在2025年率先導入玻璃基產品。
更重要的是,看客們還在期待他們造出的玻璃基 AI、HPC 到底是什么樣的。目前為止,沒有一家大牛敢拿出他們的GPU展示給我們。
【近期會議】
10月30-31日,由寬禁帶半導體國家工程研究中心主辦的“化合物半導體先進技術及應用大會”將首次與大家在江蘇·常州相見,邀您齊聚常州新城希爾頓酒店,解耦產業鏈市場布局!https://w.lwc.cn/s/uueAru
11月28-29日,“第二屆半導體先進封測產業技術創新大會”將再次與各位相見于廈門,秉承“延續去年,創新今年”的思想,仍將由云天半導體與廈門大學聯合主辦,雅時國際商訊承辦,邀您齊聚廈門·海滄融信華邑酒店共探行業發展!誠邀您報名參會:https://w.lwc.cn/s/n6FFne
聲明:本網站部分文章轉載自網絡,轉發僅為更大范圍傳播。 轉載文章版權歸原作者所有,如有異議,請聯系我們修改或刪除。聯系郵箱:viviz@actintl.com.hk, 電話:0755-25988573
審核編輯 黃宇
-
封裝
+關注
關注
128文章
8446瀏覽量
144690 -
玻璃基板
+關注
關注
1文章
98瀏覽量
10691 -
3D封裝
+關注
關注
7文章
139瀏覽量
27640 -
AI芯片
+關注
關注
17文章
1966瀏覽量
35678
發布評論請先 登錄
2.5D/3D封裝技術升級,拉高AI芯片性能天花板
3D封裝與系統級封裝的背景體系解析介紹






 玻璃基板全球制造商瞄準2.5D/3D封裝、系統級、CPO和下一代AI芯片
玻璃基板全球制造商瞄準2.5D/3D封裝、系統級、CPO和下一代AI芯片



















評論