華宇電子Flip Chip封裝技術實現量產
Flip Chip是一種倒裝工藝,利用凸點技術在晶圓內部重新排布線路層(RDL),然后電鍍上bump。bump的結構一般為Cu+solder或Cu+Ni+solder。通過倒裝裝片機將芯片翻轉正面朝下,無需引線健合,通過回流焊爐熱熔芯片上的錫凸點(Bump)與引線框架或者基板進行焊接,使得芯片與載體焊接起來,直接替代了傳統的上芯與壓焊的工藝。電信號通過載體實現與封裝外殼互聯的技術無需引線鍵合。形成更短的電路,降低電阻;縮小了封裝尺寸,相比傳統引線鍵合產品,提高了電性能,熱性能。有更高的可靠性保障。
主要應用領域:無源濾波器、存儲器、CPU、GPU及芯片組等產品。
◆FCOL◆
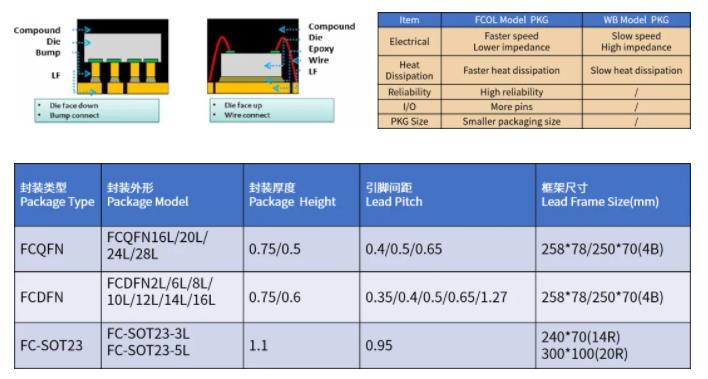
◆FCBGA◆
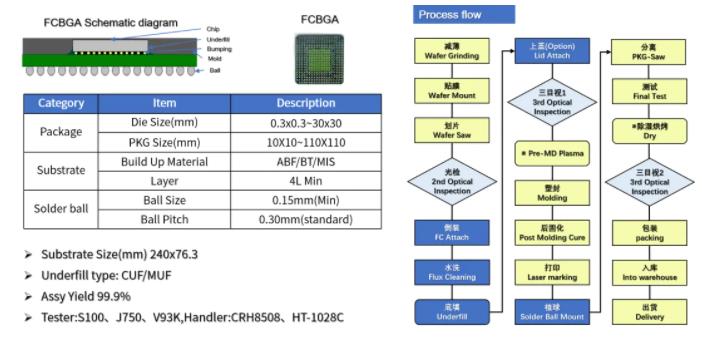
◆WBBGA◆
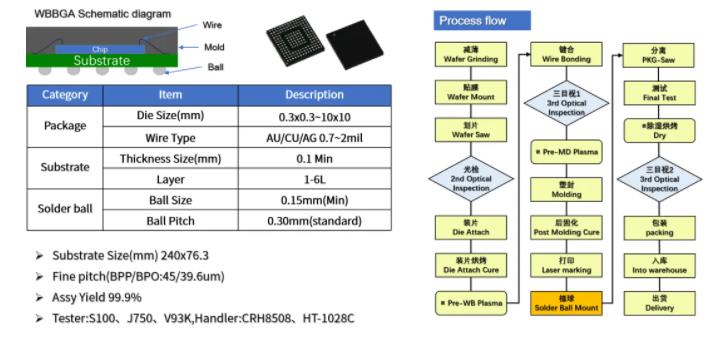
關于華宇電子
華宇電子是一家專注于集成電路封裝和測試業務,包括集成電路封裝、晶圓測試服務、芯片成品測試服務的高端電子信息制造業企業。在封裝領域具有多芯片組件(MCM)封裝、三維(3D)疊芯封裝、微型化扁平無引腳(QFN/DFN)封裝、高密度微間距集成電路封裝、倒裝技術(Flip Chip)、球柵陣列(WBBGA/FCBGA)封裝技術等核心技術。在測試領域形成了多項自主核心技術,測試晶圓的尺寸覆蓋12吋、8吋、6吋、5吋、4吋等多種尺寸,包含22nm、28nm及以上晶圓制程;芯片成品測試方面,公司已累計研發出MCU芯片、ADC芯片、FPGA芯片、GPU芯片、視頻芯片、射頻芯片、SoC芯片、數字信號處理芯片等累計超過30種芯片測試方案;公司自主研發的3D編帶機、指紋識別分選設備、重力式測編一體機等設備,已在實際生產實踐中成熟使用。產品廣泛應用于5G通訊、汽車電子、工業控制和消費類產品、智能家居、智能定位、信息安全、消防安全、智能穿戴等各行業。
-
封裝
+關注
關注
128文章
8445瀏覽量
144670 -
Flip Chip
+關注
關注
0文章
5瀏覽量
6358 -
封測
+關注
關注
4文章
363瀏覽量
35413
原文標題:華宇電子FCOL、FCBGA、WBBGA技術發布和量產
文章出處:【微信號:池州華宇電子科技股份有限公司,微信公眾號:池州華宇電子科技股份有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
華宇電子亮相2025東南亞半導體展
rPGA Sandy Bridge + FCBGA PCH Cougar Point-M+MXM IIl ×2
華宇電子加速先進封裝測試數字化轉型
華邦電子存儲芯片驅動智能汽車升級
武漢鐳宇科技激光焊錫技術推動汽車電子行業高精度焊接新標準
宇樹科技在物聯網方面
宇陽科技榮獲電子元件領軍品牌
華秋電子 | 電子發燒友亮相OpenHarmony人才生態大會2024
三星電機瞄準高端封裝市場,FCBGA技術引領未來增長
2024 RISC-V 中國峰會:華秋電子助力RISC-V生態!
華宇電子塑封 PMC 2030(C-MOLD)設備正式投入生產
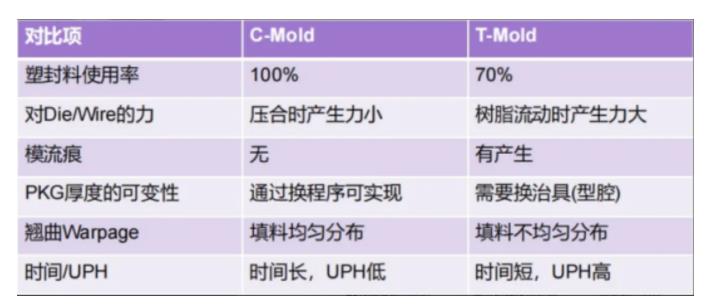
池州華宇電子SOP32L 300mil 封裝新品發布






 華宇電子FCOL、FCBGA、WBBGA技術發布和量產
華宇電子FCOL、FCBGA、WBBGA技術發布和量產

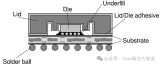











評論