焊錫是一種熔點較低的金屬,這種特性使其廣泛用于各種結構的電氣和機械連接。在半導體封裝中,焊錫被用于連接封裝和印刷電路板;在倒片封裝中,焊錫被用于連接芯片和基板。在連接封裝和印刷電路板時,通常采用錫球的形式,尺寸從30微米到760微米不等。如今,隨著電氣性能的不斷提升,連接封裝和印刷電路板之間所需的引腳數量也在增加,這也間接導致了錫球尺寸被要求不斷縮小。
制作錫球時需要保證其合金成分的均勻性,否則會對跌落沖擊或溫度循環測試的可靠性造成影響。同時,錫球還必須具有良好的抗氧化性,因為在原材料制備過程中或回流焊過程中,氧化物的過度堆積可能導致錫球出現粘合效果不佳或脫落的問題,也就是所謂的“不沾錫(Non-wetting)”問題,因此,在焊接過程中需要使用助焊劑來清除其表面的氧化膜聚集,在回流焊過程中則需要使用氮氣來形成惰性氣氛,以避免此類問題的產生。
除此之外,焊接過程中還需要避免出現空隙,否則可能導致焊錫量不足,降低焊點可靠性。錫球的尺寸也至關重要,大小均勻的錫球有助于提高工藝效率。最后,錫球表面必須潔凈無污染,以防止枝蔓晶體(Dendrite)^12^生長,上述這些現象都會增加故障率,降低焊點可靠性。
此前,錫球通常由錫合金(鉛錫合金)制成,因具有良好的機械性能和導電性。然而在被發現鉛對人體健康具有潛在危害后,鉛的使用開始受到歐盟RoHS指令^13^等環境保護法規的嚴格監管,因此目前主要采用鉛含量不超過百萬分之700ppm或更低含量的無鉛焊錫。
^12^枝蔓晶體(Dendrite):一種具有樹枝狀形態的晶體,是自然界中常見的一種分形現象。
^13^RoHS指令:歐盟出臺的《關于限制在電子電器設備中使用某些有害成分的指令》(RoHS),旨在通過使用更安全的替代品,來替換電子電氣設備中的有害物質,以保護環境和人類健康。
膠帶:用于永久和臨時鍵合的壓敏膠(PSA)
本節將重點介紹兩種類型的膠帶。第一種是用于將固體表面與同質或異質表面進行永久粘合的膠帶。另一種是臨時粘合膠帶,如切割膠帶(Dicing tape)和背面研磨保護膠帶(Back grinding tape),它們可以通過內聚力和彈性來實現粘合或清除作用,這些膠帶所使用的材料被稱為壓敏膠。
背面研磨保護膠帶貼在晶圓正面,作用是在背面研磨過程中保護晶圓上的器件。在背面研磨過程結束后,須將這些膠帶清除,以避免在晶圓表面留下粘合劑殘留物。
切割膠帶也被稱為承載薄膜(Mounting tape),用于將晶圓穩固地固定在貼片環架上,以確保在晶圓切割過程中晶圓上的芯片不會脫落,因此,晶圓切割過程中使用的切割膠帶必須具備良好的粘合力,也必須易于脫粘。由于壓敏膠會對紫外線產生反應,因此在移除芯片之前,需要通過紫外線照射來處理切割膠帶,這樣可以減弱粘合力,便于移除芯片。
過去,晶圓在經過背面研磨后會直接貼附在切割膠帶上;然而,隨著晶圓背面迭片覆膜作為芯片粘合劑的廣泛使用,如今,晶圓在經過背面研磨后,會貼附在晶圓背面迭片覆膜和切割膠帶相結合處的膠帶上。
引線:從金絲到銅絲,用于電氣芯片連接
在芯片的電氣連接中,用于連接芯片與基板、芯片與引線框架、或芯片與芯片的連接引線,通常由高純度金制成。金具有出色的延展性,既可以加工成極薄的片材,又可以拉伸成細線,這些特性都非常有助于布線過程的開展。此外,金具有良好的抗氧化性,因此相應可靠性也得到提升,同時卓越的導電性能又賦予其良好的電氣特性。
然而,由于金價較高,制造成本也相對較高,因此在布線過程中有時會使用較細的金絲,一旦拉伸過度便容易發生斷裂,這也限制了金絲的使用。為了解決這一問題,人們開始將銀等其他金屬與金混合制成合金,同時也會使用鍍金銀、銅、鍍鈀銅、鍍金鈀銅等金屬材料。
目前,銅絲正在逐漸替代金絲,這是因為銅的可鍛性和延展性僅略遜于金絲,同樣具備良好的導電性能,但卻具備明顯的成本優勢。然而,由于銅易氧化,銅絲可能會在布線過程中或之后被氧化,所以與金絲布線不同的是,銅絲布線的設備采用密封模式且內部充滿氮氣,以防止暴露在空氣中的銅絲被氧化。
包裝材料:裝運過程中的卷帶包裝
封裝和測試完成后,半導體產品會被運送給客戶。半導體產品包裝通常采用卷帶(T&R)包裝和托盤(Tray)包裝兩種形式。卷帶包裝是指將產品封裝放在帶有“口袋”的膠帶上,“口袋”的尺寸需與產品封裝尺寸一致,具體操作是將膠帶卷起形成一個卷軸,再將卷軸打包并發送給客戶。托盤包裝指將產品封裝放入一個專用托盤,然后將多個托盤堆疊起來,打包裝運。
晶圓級封裝材料的展望
在詳細介紹傳統封裝中各個工藝流程所使用的材料后,我們將在下一篇文章中重點探討晶圓級封裝所使用的材料。除了介紹這些材料的組成成分外,還將探索這些材料在確保半導體產品質量和耐用性方面發揮的關鍵作用。
審核編輯:劉清
-
晶圓
+關注
關注
52文章
5113瀏覽量
129137 -
半導體封裝
+關注
關注
4文章
289瀏覽量
14269
原文標題:半導體后端工藝:探索不同材料在傳統半導體封裝中的作用(下)
文章出處:【微信號:閃德半導體,微信公眾號:閃德半導體】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 半導體后端工藝:探索不同材料在傳統半導體封裝中的作用(下)
半導體后端工藝:探索不同材料在傳統半導體封裝中的作用(下)


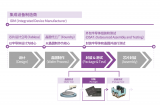
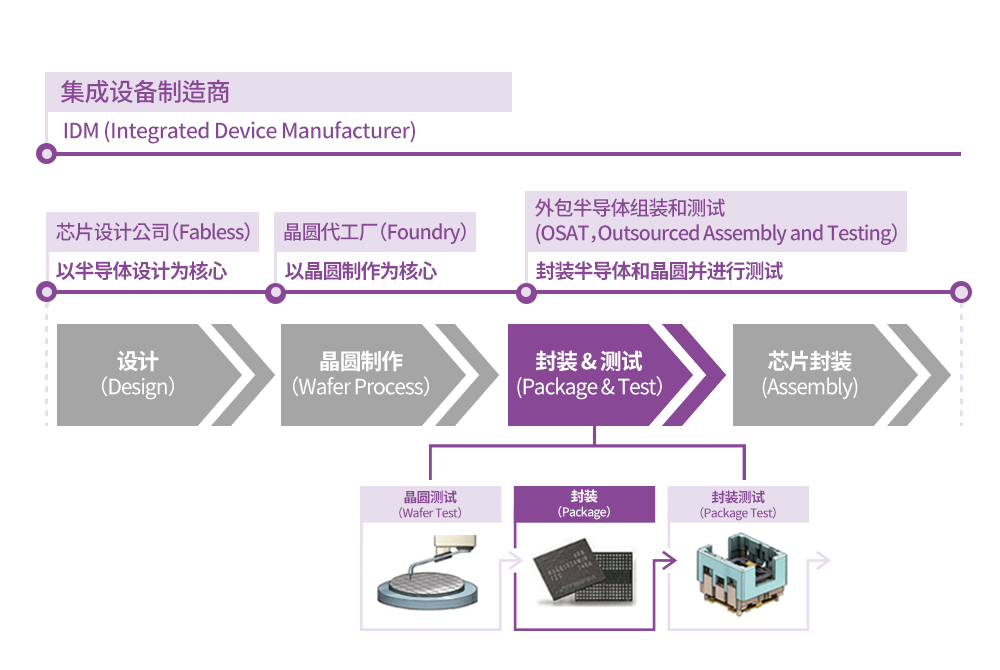










評論