1 先進封裝成為后摩爾時代提升系統性能的主流趨勢
1.1 摩爾定律經濟效能達到瓶頸,先進封裝提升芯片系統性能
摩爾定律持續推進帶來的經濟效能達到瓶頸。摩爾定律是指隨著技術演進,芯片上容 納的晶體管數量會呈指數級增長,每1.5-2年翻一倍,同時帶來芯片性能提升一倍或 成本下降一半的效應。隨著芯片制程工藝的不斷發展,芯片上容納的晶體管數量不斷 增加,但單位數量晶體管的成本下降幅度正在持續降低。根據IBS的統計及預測,從 16nm到10nm,每10億顆晶體管的成本降低了30.7%,從7nm到5nm成本下降了17.8%,而 從5nm到3nm成本僅下降了4.2%。
集成電路中晶體管尺寸的微縮逐漸接近硅原子的物理極限。芯片工藝尺寸日益走向 極致(3nm至1nm),而1nm的寬度中僅能容納2個硅原子晶格,如若 進一步微縮,就將進入量子物理的世界,面臨現階段較為棘手的量子隧穿效應和散熱 等問題。晶體管數量不斷增加會造成短溝道效應,即當通道長度縮短到量子物理閾值 時會產生量子隧穿效應,從而使晶體管的性能衰減。此外,晶體管工作會持續產生熱 量,當數以萬計的晶體管以較短的間隔放置時,也需要解決散熱問題。

先進封裝成為超越摩爾定律、提升系統性能的關鍵路徑之一。目前集成電路發展主要 沿著兩個技術路線進行,一個是摩爾定律的延伸,即向芯片小型化的方向發展,通過 微縮半導體器件的晶體管尺寸以增加可容納的晶體管數量,以單個芯片性能的提升 為目標;另一個是超越摩爾定律,即以先進封裝技術的發展為主要方向,將處理、模 擬等多種芯片集成在一個系統內,實現系統級封裝(System in Package, SiP),以系 統性能的提升為目標。
1.2 封裝技術發展趨勢:芯片性能不斷提高、系統趨于小型化
封裝技術的發展史是芯片性能不斷提高、系統不斷小型化的歷史。封裝是半導體晶圓 制造的后道工序之一,目的是支撐、保護芯片,使芯片與外界電路連接、增強導熱性 能等。封裝技術的發展大致分為4個階段:第一、第二階段(1990年以前)以DIP、SOP 和LCC等技術為主,屬于傳統封裝;第三階段(1990至2000年)已經開始應用先進封 裝技術,這一階段BGA、CSP和FC技術已開始大規模生產;第四階段(2000年至今), 先進封裝技術從二維開始向三維拓展,出現了2.5D/3D封裝、晶圓級封裝、扇出型封 裝等封裝技術。先進封裝也稱為高密度封裝(HDAP,High Density Advanced Package), 采用先進的設計和工藝對芯片進行封裝級重構,并有效提升系統性能。相較于傳統封 裝,先進封裝具有引腳數量增加、芯片系統更小型化且系統集成度更高等特點。
先進封裝技術的發展主要朝上游晶圓制程和下游模組兩個方向。1)向上游晶圓制 程領域發展,該方向發展的技術即晶圓級封裝,通過晶圓重構工藝在晶圓上完成重 布線,并通過晶圓凸點工藝形成與外部互聯的金屬凸點以進行封裝,該技術的特點 是可以在更小的封裝面積下容納更多的引腳;2)向下游模組領域拓展,即發展系 統級封裝技術,將以前分散貼裝在PCB板上的多種功能芯片,包括處理器、存儲器等功能芯片以及電容、電阻等元器件集成為一顆芯片,壓縮模塊體積、縮短電氣連接 距離,提升芯片系統整體功能性和靈活性。
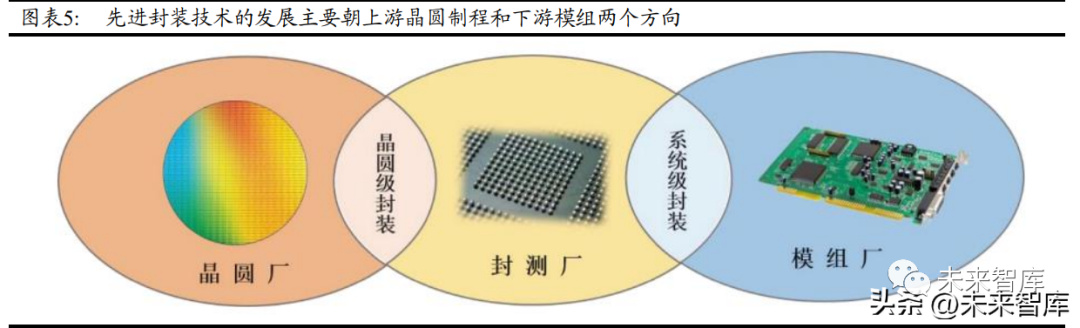
1.3 先進封裝的技術與形態根據需求不斷迭代,多應用于高性能場景
先進封裝的四要素是Bump、RDL、Wafer和TSV,具備四要素中任意一種技術即為先進 封裝。1)Bump(金屬凸點)技術,普遍應用于Flip-Chip(倒裝焊)技術中,處于晶 圓之間互聯的位置,起著電氣互聯和應力緩沖的作用,其發展趨勢是使金屬凸點越來 越小,直至發展為Hybrid Bonding(混合鍵合)技術,該技術制造的電介質表面光滑、 沒有凸點,且具有更高的集成密度;2)RDL(重布線層)技術,用于X與Y平面電氣延 伸和互聯,適用于為I/O端口進行寬松排布,廣泛應用于WLP(晶圓級封裝)技術和 2.5D/3D技術中,但不適用于Flip-Chip技術;3)Wafer(晶圓)技術,可以用作芯片 的基底和WLP封裝的載體,也可以與硅基板一同實現2.5D集成,技術發展趨勢是使 Wafer面積逐漸增大;4)TSV(硅通孔)技術,用于Z軸電氣互聯,是實現多維立體結 構封裝的關鍵技術。
RDL和TSV使封裝技術在X-Y-Z三維空間中具備延伸和發展的可能性。重布線層(RDL) 技術使得晶圓級封裝得以在X-Y平面進行延伸,誕生了WLCSP、FOWLP、INFO、FOPLP、 EMIB等技術。基于硅通孔(TSV)技術,封裝系統沿著Z軸進行延伸,實現了二維向三 維的拓展,出現了2.5D和3D集成,并演變出CoWoS、HBM、Co-EMIB、HMC、Wide-IO、 Foveros、SoIC、X-Cube等技術。
先進封裝的技術與形態會根據應用側需求不斷變化與迭代。從WLP、SiP、2.5D/3D等 技術方案出發,各廠商根據應用側需求進一步迭代出更深層的技術。以晶圓級封裝 (WLP)技術為例,起初WLP技術采用Fan-in形態,隨著引腳數要求增加,Fan-out形 態逐漸成為主流;而后出于提升系統性能的目標,臺積電將多個芯片Fan-out工藝集 成起來,誕生了INFO技術;而從節省成本的角度出發,單個芯片的FOWLP技術又進一 步迭代出面板級封裝技術(FOPLP)。
先進封裝技術能提升系統的功能密度,多應用于高性能場景。目前主流的先進封裝技 術主要由國際半導體龍頭廠商研發,技術研發的維度從2D逐漸提升至2.5D和3D,系統 的功能密度也隨之提升。同時,先進封裝主要應用于高性能計算、高端服務器等領域, 因此產品技術壁壘與價值量相對傳統封裝會更高。

系統級封裝(SiP)屬于廣義的先進封裝,側重于系統屬性。SiP是指在封裝內形成一 個系統,關注系統在封裝內的實現,所以系統是其重點關注的對象,與之對應的是CSP (單芯片封裝)。但SiP并不是先進封裝特定的某種技術方案,因為SiP可能采用傳統的Wire Bonding工藝,也可能采用先進封裝的Flip Chip工藝。但隨著系統對性能、 功耗、體積的要求越來越高,集成密度的需求也越來越高,SiP也會越來越多地采用 先進封裝工藝。
Chiplet通過先進封裝工藝實現。Chiplet也稱為小芯片或芯粒,該技術通過將多個芯 片裸片(Die)通過內部互聯技術集成在一個封裝內,構成專用功能的異構芯片。通 過采用2.5D、3D等高級封裝技術,Chiplet可實現多芯片之間的高速互聯,提高芯片 系統的集成度,擴展其性能、功耗優化的空間。相對SoC系統級芯片的傳統設計方法, Chiplet技術方案不需要購買IP或者自研生產,只需要購買已經實現好的小硅片進行 封裝集成,且IP可以復用。所以Chiplet可以看成是一種硬核形式的IP,但它是以芯 片的形式提供的。
3D Chiplet是Chiplet進一步的發展。3D Chiplet是由AMD在2021年6月首先提出的, 通過3D TSV將Chiplet集成在一起,同時為了提高互聯密度,采用了no Bump的垂直互 聯結構。目前3D Chiplet產品是由臺積電以SoIC的先進封裝技術進行代工,主要應用 在3D V-Cache上,將包含有64MB L3 Cache的Chiplet以3D堆疊的形式與處理器封裝 在一起。
2 先進封裝市場空間廣闊,為半導體設備行業帶來增量
2.1 先進封裝市場空間廣闊,中國大陸先進封裝產業蓬勃發展
先進封裝市場占比逐漸高于傳統封裝。據Yole數據,2021年全球封裝市場總營收為 844億美元,其中先進封裝占比44%,市場規模達374億美元。據Yole預測,2027年全 球封裝市場規模為1221億美元,其中先進封裝市場規模為650億美元,占比將提升至 53%。2021-2027年間先進封裝市場規模的年化復合增速為9.6%,將為全球封測市場貢 獻主要增量。

受益于國產替代加速及制造業的發展,中國大陸的先進封裝市場蓬勃發展。根據 Frost&Sullivan統計,中國大陸2020年先進封裝市場規模為351.3億元,預計2025年 將增長至1,136.6億元,2020-2025年間年化復合增速達26.47%,高于Yole對全球先進 封裝市場年化復合增速9.6%的預測值。
倒裝封裝目前是先進封裝行業營收規模最大的技術方案,嵌入式、3D堆疊和晶圓級扇 出型等高階封裝成長速度較快。根據互連技術的分類,目前倒裝封裝技術的營收規模 最大,其次是3D堆疊封裝及晶圓級扇出型封裝。許多普通規格的芯片產品均需要采用 倒裝封裝(Flip-chip)進行內部封裝,因此目前倒裝封裝的市場規模最大。而晶圓 級封裝(WLCSP)和嵌入式封裝(ED)屬于更高階的封裝技術,主要應用于高端芯片 封裝,目前市場應用規模相對較小。但是從成長速度看,高階封裝技術如嵌入式封裝、 3D堆疊、晶圓級扇出型封裝是發展最快的三種方案,根據Yole的預測,2020-2026年 市場規模年化復合增速預計分別為25%、22%及15%。
2.2 先進封裝為半導體設備行業帶來增量
在先進封裝工藝中,對傳統封裝設備的使用需求和精度要求都有所提升。傳統封裝測 試主要位于晶圓制造鏈的后道工序,包括減薄、切割、貼片、鍵合、打標、測試等步 驟,需要使用減薄機、劃片機、貼片機、引線鍵合機、激光打標機等半導體設備。隨 著先進封裝的發展,在傳統封裝工藝的基礎上也會有所改進,主要包括:(1)在先進 封裝工藝中,芯片堆疊的層數增加,為了保持芯片體積較小,對減薄設備的精度提出更高要求;(2)在Chiplet設計中,制造小芯片需要更多的的切割和貼合,使得劃片 機、貼片機的需求數量和精度要求都有所提升;同時Chiplet技術中每個裸片都需要 進行測試,且將小芯片集成后還需要進行系統性的測試,因而亦增加了測試設備的需 求。
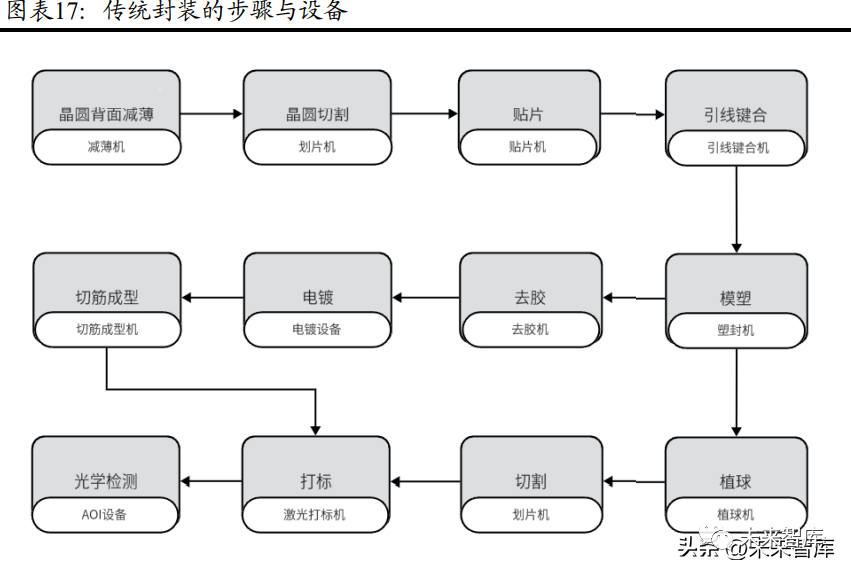
在先進封裝工藝中,除了傳統封裝設備,還需要使用晶圓制造前道工藝的設備。先進 封裝使用的設備與晶圓制造的前道工藝開始有所重疊,而不只是傳統封裝所需要的 減薄機、劃片機、貼片機等,刺激設備需求應封裝技術發展而增長。在RDL、Bumping、 TSV等互連技術中,均需要使用涂膠機、***等設備;TSV技術需要鉆孔,還增加了 刻蝕機的需求。此外對傳統封裝設備中的減薄機、劃片機也需要進行一定改進,比如 將設備進一步設計為帶凸點晶圓減薄機、帶凸點晶圓劃片機等,同時對厚度、劃切道 寬度等均提出了更高的精度要求。
國內先進封裝產業鏈所用設備有望部分實現國產替代。近年來國內半導體設備廠商 發展迅速,涌現了北方華創、中微半導體、沈陽拓荊、華海清科、精測電子等具備較 先進制程設備工藝實力的公司,對于先進封裝所使用的刻蝕機、涂膠顯影設備、清洗 設備、測試機等有望部分實現國產替代。
3 高性能計算驅動半導體產業發展,先進封裝實現算力提升
3.1 HPC 超越手機成為半導體第一大需求驅動力,大算力時代來臨
2022年Q1開始,HPC逐漸超越手機成為半導體第一大需求驅動力。5G手機滲透率逐漸 飽和,隨著人工智能的發展,需要處理的數據量指數級增長,AI服務器、高性能計算 等算力需求迎來爆發式增長。從2022年Q1開始,在臺積電下游應用領域的營收占比中, HPC(高性能計算)首次超越智能手機躍居第一,隨后繼續保持上升態勢,而手機營 收占比逐漸下行。

智能算力規模快速增長,大算力時代來臨。算力作為人工智能的要素之一,在數字經 濟發展、產業智能化升級的進程中發揮巨大作用。根據IDC預測,到2026年,我國智 能算力規模將達到1271.4EFLOPS,2022-2026年化復合增長率達47.58%。
3.2 AI 服務器產業鏈迎來高景氣,異構集成與異構計算共推算力發展
以AI服務器產業鏈為代表的硬件產品將充分受益于人工智能發展的浪潮。據 TrendForce集邦咨詢預測,在AI+應用廣泛落地的刺激下,AI服務器2023年出貨量預 計將同比增長38.4%,2022-2026年AI服務器的年化復合增長率將達22%。
AI服務器采用的是異構計算架構。異構計算(Heterogeneous Computing),是指將 CPU、GPU、FPGA、DSP等不同架構的運算單元整合到一起進行并行計算。例如,CPU擅 長管理和調度,比如讀取數據,管理文件,人機交互等;GPU管理弱,運算強,更適 合整塊數據進行流處理的算法;FPGA實時性高,能管理能運算,但是開發周期長,復 雜算法開發難度大;DSP適合特定算法的計算等。異構計算的實現架構通常是CPU+ GPU/FPGA/DSP,主要由CPU完成不可加速部分的計算以及整個系統的控制調度,由 GPU/FPGA/DSP完成特定的任務和加速,具備計算能力強、可擴展性好、資源利用率高、 發展潛力大等優點。

異構集成通過先進封裝工藝將多個高性能算力芯片集成在一個系統中,實現異構計 算以提升算力。異構集成(Heterogeneous Integration),準確的全稱為異質異構集 成,異構代表采用的不同工藝節點,異質代表不同模塊使用的半導體材料不同。異構 集成通過先進封裝工藝將不同工藝節點、不同材質的高性能芯片集成在一起,使在單 個封裝內構建復雜系統成為了可能,能夠快速達到異構計算系統內的芯片所需要的 功耗、體積、性能的要求,從而使異構計算可以通過整合不同架構的運算單元來進行 并行計算,達到提升算力的目的。
在存算一體大算力領域,已有國內企業走在前列。存算一體架構將不同類型的處理器 和存儲組件等集成到同一個芯片上,是異構集成的一種形式,目前在該領域已有國內 企業取得突破。2023年5月,后摩智能正式發布國內首款存算一體智駕芯片——鴻途 H30。該芯片僅用12nm工藝制程,其物理算力實現了高達256TOPS,在Int8全精度的計 算提供下,計算延時只有1.5ns,能效比為30-150 TOPS/W,比業界同等精度計算條件 下的水平提高了3倍以上。H30芯片采用的是后摩智能自研的AI處理器架構—IPU (Intelligence Processing Unit),將面向智能駕駛、通用人工智能等領域。與國 際巨頭的某款智能駕駛8nm芯片相比,在Resnet50網絡的條件下,后摩智能H30的性能 可以達到友商的2倍以上。
3.3 Chiplet 優勢明顯,是***“破局”路徑之一
高性能計算的應用場景不斷拓寬,對算力芯片性能提出更高要求,進而拉動了先進封 裝及Chiplet工藝的需求。隨著AI大模型數據處理需求的持續提升,對算力芯片性能 提出更高要求。Chiplet是高性能算力芯片的封裝解決方案之一,其在設計、生產環 節均進行了效率優化,能有效降低成本并持續提高系統集成度。Chiplet需要采用先 進封裝工藝中的異構集成技術進行實現,因而Chiplet的高增長亦將帶動異構集成的 需求提升。根據Omdia預測,隨著人工智能、高性能計算、5G等新興應用領域需求滲 透,2035年全球Chiplet市場規模有望達到570億美元,2018-2035年復合年均增長率 為30.16%,發展勢頭強勁。
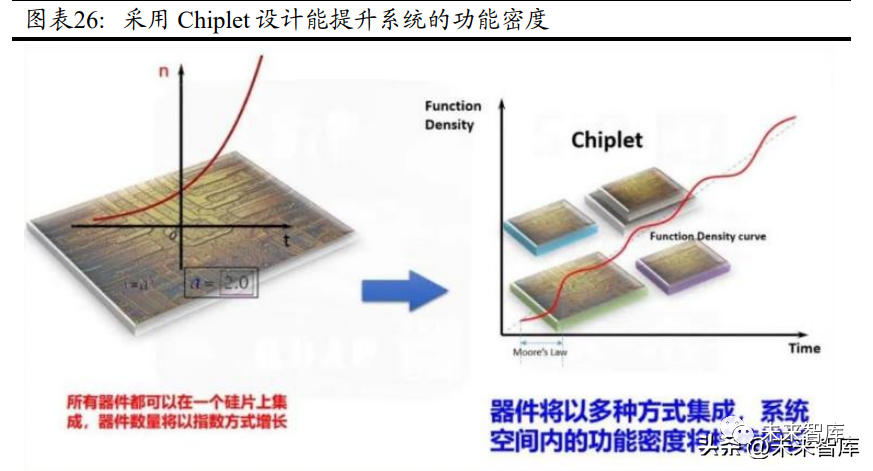
與傳統SoC相比,Chiplet在設計靈活度、良率等方面優勢明顯。相對單片集成技術SoC 而言,Chiplet是由不同工藝節點的模塊共同組成,在相同的系統性能目標下,部分 模塊對制程的要求有所降低,節省了部分開發時間;由于芯片面積越大越容易產生缺 陷,而Chiplet每個模塊的載體都是較小的硅片,有效降低了生產中產生的缺陷數量;同時每個小硅片擁有單獨的IP,并且可以重復使用,根據特定客戶的獨特需求定制產 品,節省開發時間。不同工藝生產制造的Chiplet可以通過SiP技術結合,典型的方案 就是XPU+DRAM,通過異構集成把內存和算力單元直接整合到一起,提升系統性能、突 破算力瓶頸。
針對先進制程,Chiplet更具成本優勢。一方面小芯片形式的制造良率有所提升,另 一方面是Chiplet允許使用不同的制程制造異構芯片,例如高性能模塊采用7nm,其他 模塊只需要14nm或28nm就可以做到性能最大化,使系統整體的功能密度非常接近于 7nm的集成。AMD采用“7nm+14nm”的Chiplet設計方案,較7nm的單芯片集成的成本下 降了接近一半。AMD認為是否使用Chiplet設計思想的動機,在于性能、功耗與造價能 否妥協。Chiplet對成本下降的效果會隨著核數(芯片核心的數量)的降低而邊際減 小,因此未來可能會出現一個價格的均衡點來判斷采用Chiplet技術是否更具有經濟 效益。
中美科技摩擦加劇背景下國內先進制程發展受限,Chiplet是***“破局”路徑 之一。近年來美國以《芯片與科學法案》、貿易管制“實體清單”及與日本、荷蘭組 成芯片聯盟等手段限制我國芯片先進制程的發展,使我國高端芯片領域面臨“卡脖子” 問題。Chiplet降低了芯片設計的成本與門檻,且其IP復用的特性提高了設計的靈活 性,是***“破局”路徑之一。2023年2月,北極雄芯發布了國內首款基于異構 Chiplet集成的智能處理芯片。該芯片采用12nm工藝生產,HUB Chiplet采用RISC-V CPU核心,可通過靈活搭載多個NPU Side Die提供8-20TOPS(INT8)稠密算力。該芯 片可用于AI推理、隱私計算、工業智能等不同場景,有效解決了下游客戶在算法適配、 迭代周期、算力利用率、算力成本等各方面難以平衡的核心痛點。
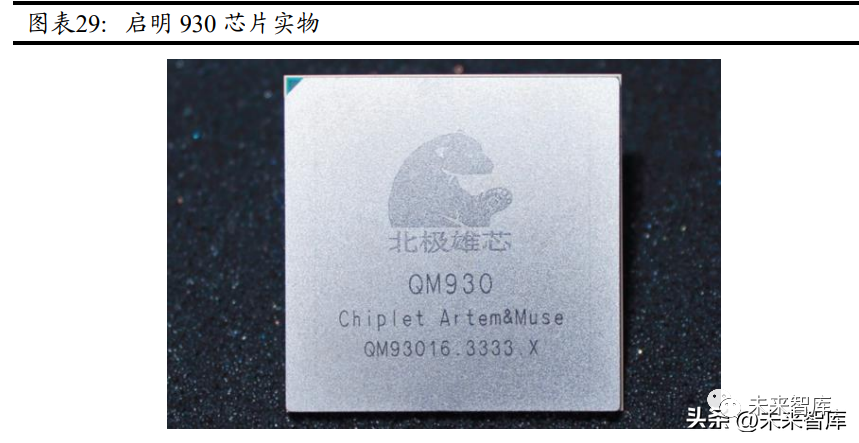
4 龍頭積極布局先進封裝,中國大陸封裝廠商蓬勃發展
4.1 晶圓廠和封測廠積極布局先進封裝,側重點各有不同
封測廠及晶圓廠龍頭均積極布局先進封裝。根據Yole數據,2021年各行業龍頭在先進 封裝行業的資本支出合計約為119億美元。晶圓廠陣營方面,英特爾以35億美元的資 本支出排名第一,主要用以支持Foveros和EMIB技術。臺積電、三星以30.5億美元和 15億美元的資本支出分別排名第二、第四。而封測廠陣營方面,日月光以20億美元的 資本支出排名第三,其是最大也是唯一能夠與代工廠和集成設備制造商形成競爭的 OSAT。中國大陸封測廠長電科技和通富微電在先進封裝資本支出方面則分居第6、7名。
英特爾致力于實現每毫米立方體里功能最大。在英特爾的技術發展路線圖中,先進封 裝主要關注互連密度、功率效率和可擴展性三個方面。其中,Foveros和混合鍵合技 術主要關注功率效率、互連密度方面,而Co-emib和ODI技術則體現了集成的可擴展性 特點。從Foveros到混合鍵合技術,英特爾逐漸實現凸點間距越來越小,使系統擁有 更高的電流負載能力、更好的熱性能。未來英特爾將繼續致力于實現每毫米立方體里 功能最大。
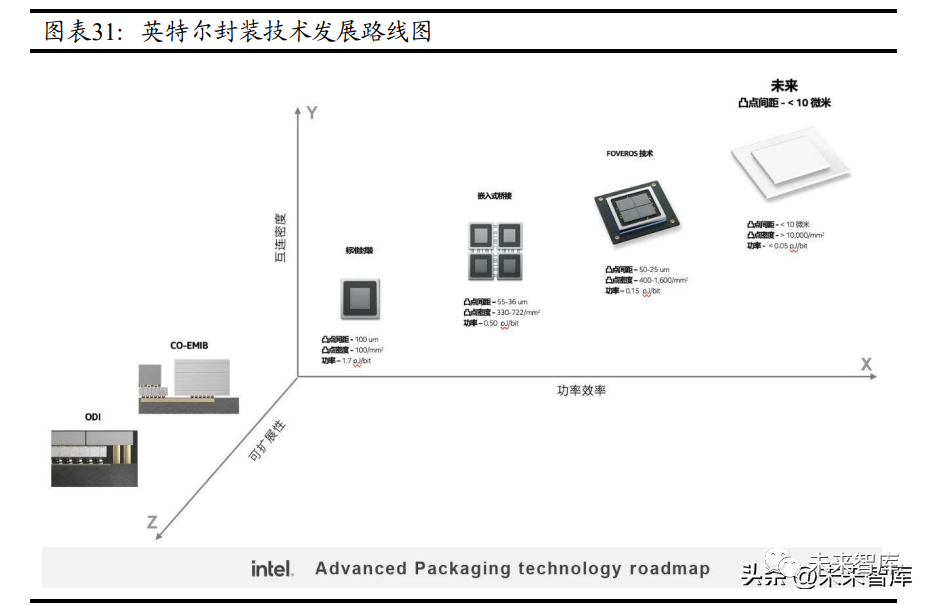
臺積電推出“3D Fabric”先進封裝平臺。臺積電將2.5D和3D先進封裝技術整合為“3D Fabric”平臺,在2.5D層面推出了CoWoS及InFO等技術,在3D層面推出了3D SoIC技術。其中前段技術包含3D的整合芯片系統(SoIC InFO-3D),后端組裝測試相關技術包含 2D/2.5D的整合型扇出(InFO)以及2.5D的CoWoS系列。目前最新的第五代CoWoS-S封 裝技術,將增加3倍的中介層面積、8個HBM2e堆棧(容量高達128GB)、全新的硅通孔 (TSV)解決方案等,有望將晶體管數量翻至第3代封裝解決方案的20倍。
日月光半導體推出“VIPack”先進封裝平臺,提供垂直互連整合封裝解決方案。該平 臺由六大核心封裝技術組成,包括日月光基于高密度RDL的Fan Out Package-onPackage(FOPoP)、Fan Out Chip-on-Substrate(FOCoS)、Fan Out Chip-on-SubstrateBridge(FOCoS-Bridge)和Fan Out System-in-Package(FOSiP),以及基于硅通孔 (TSV)的2.5D/3D IC和Co-Packaged Optics。平臺具備先進的RDL制程、嵌入式整合 以及2.5D/3D封裝等技術,提供可優化時脈速度、頻寬和電力傳輸的高度整合硅封裝 解決方案所需的制程能力,能縮短共同設計時間、產品開發和上市時程。其中FOPoP 是由日月光在2023年3月14日發布的,該技術實現了電氣路徑減少3倍(降低延遲性)、 帶寬密度提高8倍(提高帶寬優勢)的提升,主要應用于移動裝置和網絡通訊市場。

晶圓廠陣營及封測廠陣營關注側重點各有不同。晶圓廠由于在前道環節的經驗更豐 富,能更快掌握需要刻蝕等前道步驟的TSV技術,因而在2.5D/3D封裝技術方面較為領 先,如英特爾的Foveros技術和臺積電的CoWoS技術,均是高維集成的領先技術。而后 道封裝廠商則更熟悉異質異構集成且封裝技術布局全面,因此在SiP技術的發展方面 更有優勢,比如日月光的“VIPack”平臺中就將FOSiP等系統級封裝技術列為核心技 術之一。在后摩爾時代,先進封裝為封裝行業帶來核心增量,亦成為晶圓廠和封測廠 的兵家必爭之地。我們預計未來晶圓制造廠的工藝程序將會演變成從制造到封裝的 一體化工程,而OSAT則會呈現馬太效應,技術迭代能力強、客戶資源豐富的龍頭企業 更具優勢,市場份額有望更加集中。
4.2 OSAT 競爭格局較為穩定,中國大陸廠商蓬勃發展
OSAT競爭格局較為穩定,中國大陸封測廠營收名列前茅。根據2022年海內外已經上市 的封測廠(OSAT,Outsourced Semiconductor Assembly and Test)營收情況,OSAT 行業整體營收排名變化不大,競爭格局較為穩定。中國大陸封測廠中有長電科技、通 富微電、華天科技和甬矽電子進入前三十名的榜單,其中長電科技、通富微電和華天 科技穩居榜單前十。從毛利率和研發營收比來看,中國大陸封測廠的研發投入水平處 于國際領先水平,但毛利率與海外巨頭相比仍有提升空間。
中國大陸封測廠蓬勃發展,以長電科技最為突出。在芯思想發布的委外封測前十大榜 單中,中國大陸市占率占比24.55%,僅次于中國臺灣地區。在中國大陸封測廠中,長 電科技市占率占比44%,是國內封測行業的龍頭企業。
長電科技在國內封測廠中具有領先優勢,先進封裝技術布局全面且背靠中芯系。近年 來長電科技重點發展系統級、晶圓級和2.5D/3D等先進封裝技術,提供的解決方案包 括扇入型晶圓級封裝(FIWLP)、扇出型晶圓級封裝(FOWLP)、集成無源器件(IPD)、硅通孔(TSV)、包封芯片封裝(ECP)、射頻識別(RFID)等。在SiP封裝領域,長電科技擁 有雙面塑形、EMI電磁屏蔽、激光輔助鍵合(LAB)等先進技術,具有電氣性能更佳、 EMI屏蔽效果更好、可靠性更強等優勢。此外,中芯國際為長電科技股東之一,雙方 合作緊密,且中芯國際作為國內晶圓代工龍頭,在需要前道工藝輔助的2.5D/3D封裝 環節可以與長電科技協同合作,增強長電科技較其他封測廠的競爭優勢。
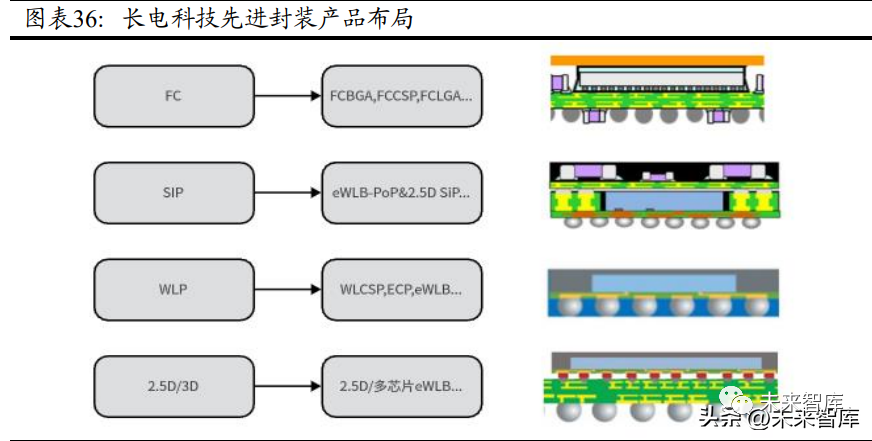
通富微電聚焦算力芯片封測,與AMD深度合作。通富微電不斷加強自主創新,并在多 個先進封裝技術領域積極開展國內外專利布局,截至2022年12月31日累計國內外專 利申請達1,383件,其中發明專利占比約70%。公司在多芯片組件、集成扇出封裝、 2.5D/3D等先進封裝技術方面均有前瞻性布局,已能提供多樣化的Chiplet封裝解決方 案,且現已具備7nm、Chiplet封裝技術規模量產能力。此外,通富微電是AMD最大的 封裝測試供應商,占其訂單總數的80%以上。未來隨著和AMD的深入合作,通富微電將 持續深耕算力芯片封測領域,分享算力產業鏈加速發展的紅利。
華天科技持續發力先進封裝,推出3D-Matrix先進封裝技術平臺。華天科技為國內第 三大、全球第六大的封測廠,現已掌握了SiP、FC、TSV、Bumping、Fan-Out、WLP、 3D等集成電路先進封裝技術。在Fan-Out領域,華天科技擁有完全自主知識產權的晶 圓級扇出型封裝解決方案-eSiFO(embedded Silicon Fan-Out),可以提供8寸,12寸 晶圓級扇出封裝的服務。此外公司實現了3D FO SiP 封裝工藝平臺的開發,現已具備 由TSV、eSiFo、3D SiP構成的最新先進封裝技術平臺——3D Matrix。未來華天科技 將持續加強技術創新工作,推進2.5D Interposer(RDL+Micro Bump)項目的研發, 布局UHDFO、FOPLP封裝技術,加大在FCBGA、汽車電子等封裝領域的技術拓展,提升 公司在先進封裝領域的競爭力。
甬矽電子定位中高端先進封裝,后起之秀蓬勃發展。甬矽電子于2017年11月設立,從 成立之初即聚焦集成電路封測業務中的先進封裝領域,且堅持中高端先進封裝業務 定位,車間潔凈等級、生產設備、產線布局、工藝路線、技術研發、業務團隊、客戶 導入均以先進封裝業務為導向。公司全部產品均為QFN/DFN、WB-LGA、WB-BGA、HybridBGA、FC-LGA等中高端先進封裝形式,并在系統級封裝(SiP)、高密度細間距凸點倒 裝產品(FC類產品)、大尺寸/細間距扁平無引腳封裝產品(QFN/DFN)等先進封裝領 域具有較為突出的工藝優勢和技術先進性。
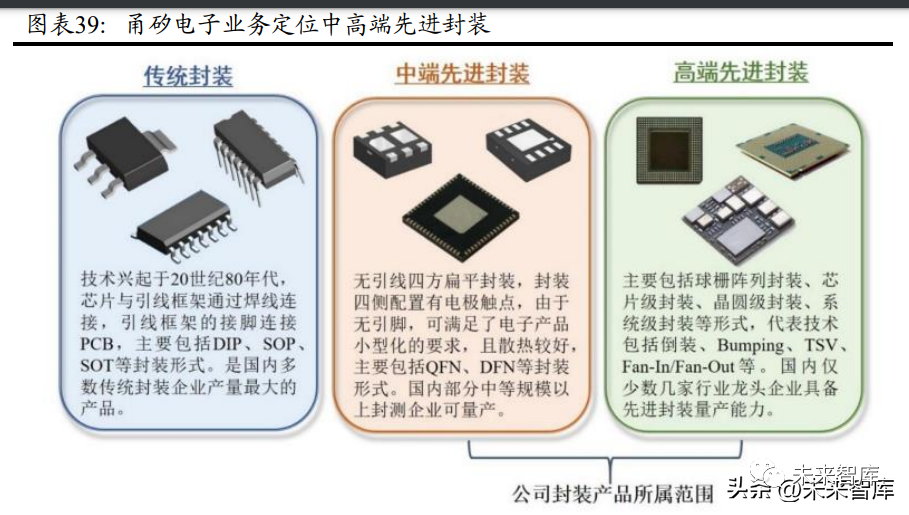
晶方科技聚焦傳感器封裝,持續拓展差異化競爭優勢。晶方科技是晶圓級硅通孔(TSV) 封裝技術的領先者,具備8英寸、12英寸晶圓級芯片尺寸封裝技術規模量產封裝線, 涵蓋晶圓級到芯片級的一站式綜合封裝服務能力。公司重點聚焦以影像傳感芯片為 代表的智能傳感器市場,封裝的產品主要包括CIS芯片、TOF芯片、生物身份識別芯片、 MEMS芯片等,同時針對汽車電子應用領域的性能提升需求,大力推進車規STACK封裝 工藝的開發創新,持續提升在車規CIS領域的技術領先優勢與業務規模。
-
摩爾定律
+關注
關注
4文章
638瀏覽量
79684 -
晶體管
+關注
關注
77文章
9977瀏覽量
140627 -
芯片制程
+關注
關注
0文章
52瀏覽量
4916 -
先進封裝
+關注
關注
2文章
460瀏覽量
501
原文標題:電子行業專題分析報告:大算力時代下先進封裝大有可為
文章出處:【微信號:CloudBrain-TT,微信公眾號:云腦智庫】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
AI 算力報告來了!2025中國AI算力市場將達 259 億美元


芯和半導體:國產EDA大有可為
九章云極DataCanvas公司「算力包」產品璀璨亮相2024中國算力大會!

AI網絡物理層底座: 大算力芯片先進封裝技術
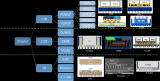





 電子行業專題分析報告:大算力時代下先進封裝大有可為
電子行業專題分析報告:大算力時代下先進封裝大有可為



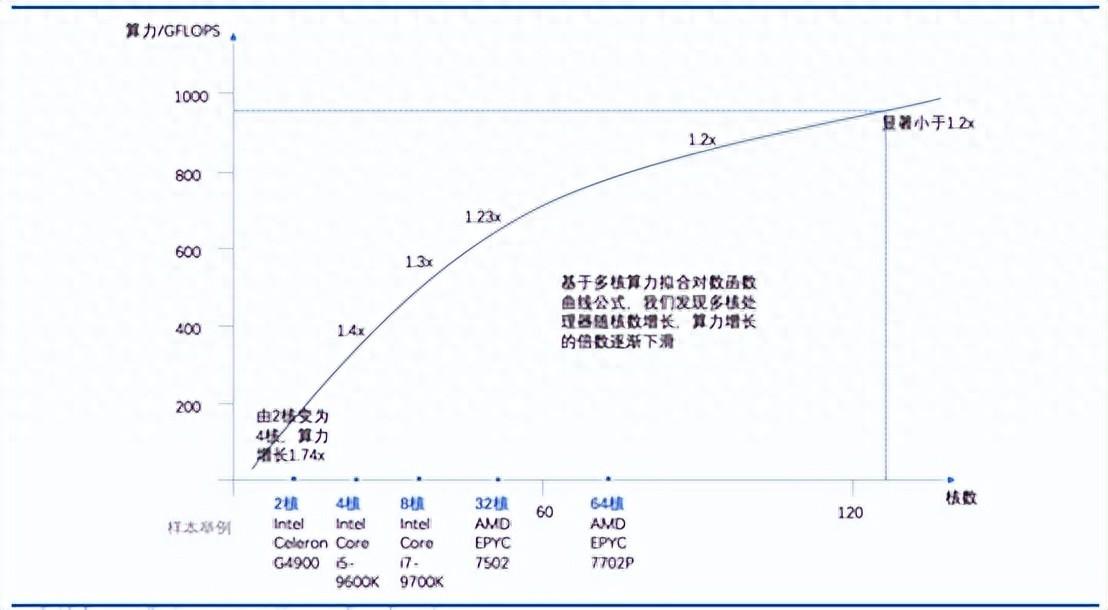












評論