本文轉(zhuǎn)自半導(dǎo)體行業(yè)觀察
感謝半導(dǎo)體行業(yè)觀察對(duì)新思科技的關(guān)注
過(guò)去50多年來(lái),半導(dǎo)體行業(yè)一直沿著摩爾定律的步伐前行,晶體管的密度不斷增加,逐漸來(lái)到百億級(jí)別,這就帶來(lái)了密度和成本上的極大挑戰(zhàn)。隨著摩爾定律逼近極限,傳統(tǒng)的單片半導(dǎo)體器件已不再能夠滿足某些計(jì)算密集型、工作負(fù)載重的應(yīng)用程序的性能或功能需求。如何進(jìn)一步有效提高芯片性能同時(shí)把成本控制在設(shè)計(jì)公司可承受的范圍內(nèi),成為了半導(dǎo)體產(chǎn)業(yè)鏈一致的難題。
對(duì)此,新思科技提出了一個(gè)新的設(shè)計(jì)理念——“SysMoore”。“Sys”取自System(系統(tǒng)),指的是要在系統(tǒng)層面提升芯片的性能,而不僅僅是在晶圓中集成更多的晶體管數(shù)量。在SysMoore的時(shí)代,Multi-Die系統(tǒng)正在成為超越摩爾定律和解決系統(tǒng)復(fù)雜性挑戰(zhàn)的解決方案,它能實(shí)現(xiàn)以經(jīng)濟(jì)高效的方式更快地?cái)U(kuò)展系統(tǒng)功能、降低風(fēng)險(xiǎn)、縮短產(chǎn)品上市時(shí)間、以更低的功耗實(shí)現(xiàn)更高的吞吐量,以及快速打造新的產(chǎn)品類別。而戈登·摩爾本人也預(yù)言道,“事實(shí)可能證明,用較小的分別封裝并相互連接的功能構(gòu)建大型系統(tǒng)更經(jīng)濟(jì)。”
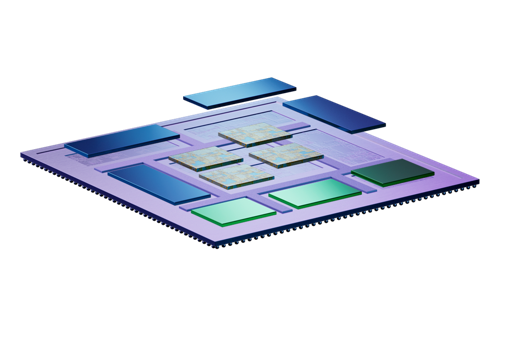
圖1:我們正邁入“SysMoore”時(shí)代

將多個(gè)die(或小芯片)放在一個(gè)封裝下的Multi-Die系統(tǒng),有諸多優(yōu)勢(shì):
-
以具有成本效益的價(jià)格加速擴(kuò)展系統(tǒng)功能(>2X reticle limits)
-
通過(guò)重復(fù)使用經(jīng)過(guò)驗(yàn)證的設(shè)計(jì)/die,降低了風(fēng)險(xiǎn)和上市時(shí)間
-
在降低系統(tǒng)功耗的同時(shí)提高吞吐量,最高可達(dá)30%
-
為靈活的投資組合管理快速創(chuàng)建新的產(chǎn)品變體
那么哪些市場(chǎng)會(huì)比較青睞于采用Multi-Die系統(tǒng)呢?據(jù)新思科技對(duì)采用Multi-Die系統(tǒng)設(shè)計(jì)的調(diào)查,從應(yīng)用領(lǐng)域來(lái)看,服務(wù)器/AI占主導(dǎo)地位,網(wǎng)卡/交換機(jī)也比較常用,智能手機(jī)/圖形/PC領(lǐng)域上的采用主要是一些專用芯片,再就是一些光電共封和汽車領(lǐng)域正在向Multi-Die發(fā)展;從制程節(jié)點(diǎn)來(lái)看,5nm工藝采用Multi-Die的比例最大,再就是7nm和3nm。
隨著2.5D、3D這樣先進(jìn)封裝技術(shù)的進(jìn)步,Multi-Die系統(tǒng)的實(shí)現(xiàn)也越來(lái)越成為可能。目前業(yè)內(nèi)已有多個(gè)Multi-Die的商業(yè)實(shí)例,不僅僅是傳統(tǒng)的芯片制造商在向Multi-Die發(fā)展,超大規(guī)模數(shù)據(jù)中心廠商、自動(dòng)駕駛汽車廠商、網(wǎng)絡(luò)公司等也都在設(shè)計(jì)自己的芯片,并以多種方式推動(dòng)Multi-Die架構(gòu)的轉(zhuǎn)變,譬如AMD 的3D V-Cache、蘋果的M2、英特爾Meteor Lake處理器、索尼的CIS、Lightmatter、特斯拉等。這些廠商對(duì)性能、安全和可靠性有著特殊的要求,Multi-Die則可以滿足他們?cè)谔囟I(lǐng)域下的這些需求。
但是從單片SoC到Multi-Die系統(tǒng)的遷移也不是易事。從單片SoC向Multi-Die系統(tǒng)遷移帶來(lái)了必須從整體上解決的獨(dú)特挑戰(zhàn):例如異構(gòu)系統(tǒng)集成、功耗和熱管理、系統(tǒng)設(shè)計(jì)規(guī)劃、Die-to-Die連接、軟件開發(fā)和建模、系統(tǒng)驗(yàn)證能力/性能、系統(tǒng)簽核分析、分層測(cè)試和修復(fù)、可靠性和安全性、系統(tǒng)良率、內(nèi)存利用率和一致性等等。在做每一個(gè)選擇和決定時(shí),都應(yīng)考慮到方方面面及其對(duì)設(shè)計(jì)總體PPA目標(biāo)的影響。

圖2:從單片SoC遷移到Multi-Die系統(tǒng)過(guò)程中的諸多挑戰(zhàn)
所以此時(shí)就需要EDA和IP產(chǎn)品的介入,來(lái)幫助客戶從系統(tǒng)規(guī)劃到實(shí)現(xiàn)和固件/硬件/軟件聯(lián)合開發(fā),助力Multi-Die系統(tǒng)更好的實(shí)現(xiàn)。

那么,要設(shè)計(jì)Multi-Die系統(tǒng),從整個(gè)系統(tǒng)的角度來(lái)看,有哪些重要的步驟和需要考量的點(diǎn)呢?
首先,在設(shè)計(jì)之初時(shí),即在早期架構(gòu)探索階段,必須采取分析驅(qū)動(dòng)法來(lái)考慮各項(xiàng)宏觀架構(gòu)決策,如IP選擇、硬件/軟件分解、系統(tǒng)級(jí)功耗分析和互連/存儲(chǔ)尺寸標(biāo)注。此外,還要考慮與聚合(利用多個(gè)裸片組裝系統(tǒng))和分解(將應(yīng)用分解到多個(gè)裸片上)相關(guān)的Multi-Die宏觀架構(gòu)決策。
圍繞幾個(gè)關(guān)鍵領(lǐng)域做出的早期架構(gòu)決策可以從以下方面改進(jìn)設(shè)計(jì)過(guò)程:一是將系統(tǒng)分成多個(gè)裸片,并且要滿足擴(kuò)展、制造和功能的需求;二是需要優(yōu)化Multi-Die系統(tǒng),包括優(yōu)化帶寬密度、每比特的能量、成本和延遲,選擇芯片的的協(xié)議和接口,如UCIe等;最后是使用Multi-Die系統(tǒng)模型,評(píng)估不同制造和封裝技術(shù)對(duì)性能的影響,加速架構(gòu)的實(shí)現(xiàn)。

圖3:對(duì)Multi-Die進(jìn)行早期架構(gòu)探索
架構(gòu)探索做完之后,另一大重要的挑戰(zhàn)是散熱問(wèn)題。Multi-Die系統(tǒng)將多個(gè)組件集成在一起,密集的晶體管密度產(chǎn)生大量的熱量,尤其是Multi-Die System的架構(gòu)設(shè)計(jì)幾乎沒(méi)有什么散熱的空間,如果熱量散不出去,芯片的功能可能會(huì)受到機(jī)械應(yīng)力或翹曲的影響。所以就需要進(jìn)行熱分析,對(duì)整個(gè)系統(tǒng)進(jìn)行功率分析、電源完整性、電熱模擬、力學(xué)分析,來(lái)滿足功耗和散熱關(guān)鍵性能指標(biāo)。
另外很重要的一點(diǎn)是,Multi-Die系統(tǒng)還需要一種統(tǒng)一的方法來(lái)進(jìn)行die和封裝的協(xié)同設(shè)計(jì),包括設(shè)計(jì)、分析和signoff,以加速這些系統(tǒng)的設(shè)計(jì)閉環(huán)。
同時(shí),考慮到如此復(fù)雜的系統(tǒng)所運(yùn)行的軟件也相當(dāng)復(fù)雜,必須盡早開始驗(yàn)證過(guò)程,因此需要?jiǎng)?chuàng)建多模系統(tǒng)的虛擬原型來(lái)支持軟件開發(fā)。Multi-Die系統(tǒng)軟件開發(fā)和系統(tǒng)驗(yàn)證,需要進(jìn)行一些關(guān)鍵的考慮和解決方法。多抽象系統(tǒng)建模可以利用快速、可伸縮的執(zhí)行平臺(tái),這些平臺(tái)使用虛擬原型、仿真、混合仿真和原型。一般而言,300億的門是Multi-Die最佳的擴(kuò)展系統(tǒng)。通過(guò)使用經(jīng)過(guò)驗(yàn)證的模型、處理程序、速度適配器,優(yōu)化軟件的驗(yàn)證周期,包括die-to-die接口的驗(yàn)證、Multi-Die系統(tǒng)驗(yàn)證,以此來(lái)將啟動(dòng)時(shí)間最小化。

圖4:軟件開發(fā)和系統(tǒng)驗(yàn)證的一些考量和解決方法
值得一提的是,目前工具流程中的自動(dòng)化已經(jīng)提高架構(gòu)探索效率,超越了過(guò)去幾年基于電子表格的手動(dòng)預(yù)測(cè)。展望未來(lái),統(tǒng)一的設(shè)計(jì)空間探索將進(jìn)一步提高這個(gè)過(guò)程的準(zhǔn)確性和效率。

由此可以看出,Multi-Die系統(tǒng)的實(shí)現(xiàn)需要理解上述所有設(shè)計(jì)過(guò)程之間的相互依賴性。對(duì)此,新思科技提供了業(yè)界較全面、具有可擴(kuò)展的Multi-Die解決方案,為Multi-Die的成功實(shí)現(xiàn)提供了更快的路徑。該解決方案包含全面的EDA工具和IP,不僅支持早期架構(gòu)探索、快速的軟件開發(fā)和驗(yàn)證、高效的裸片/封裝協(xié)同設(shè)計(jì),以及穩(wěn)健和安全的die-to-die連接,而且還能改進(jìn)芯片的健康狀況和可靠性。久經(jīng)生產(chǎn)考驗(yàn)的設(shè)計(jì)引擎以及黃金簽核和驗(yàn)證技術(shù)能夠更大限度地降低風(fēng)險(xiǎn),并加速打造出色的系統(tǒng)。(如下圖5所示)。

圖5:新思科技Multi-Die系統(tǒng)解決方案
具體來(lái)看,在早期架構(gòu)探索方面,新思科技的Platform Architect為架構(gòu)師和系統(tǒng)設(shè)計(jì)師提供了一個(gè)基于SystemC事務(wù)級(jí)模型(TLM)的工具和高效方法,可以用于早期分析和優(yōu)化多核 SoC 架構(gòu)的性能和功耗。Platform Architect使開發(fā)者能夠探索和優(yōu)化SoC基礎(chǔ)設(shè)施的硬件—軟件分區(qū)和配置,特別是全局互連和內(nèi)存子系統(tǒng),以實(shí)現(xiàn)合適的系統(tǒng)性能、功耗和成本。

圖6:新思科技的Platform Architect工作示意圖
在軟件開發(fā)方面,新思科技的Virtualizer可以加速M(fèi)ulti-Die系統(tǒng)虛擬原型的開發(fā)和部署,Virtualizer解決方案能提供更高的生產(chǎn)力,使開發(fā)者能夠以最快的速度獲得高質(zhì)量的軟件(如圖7所示)。在系統(tǒng)驗(yàn)證仿真方面,新思科技的ZeBu和HAPS則可以用于復(fù)雜軟件和系統(tǒng)驗(yàn)證(圖8)。其中,新思科技ZeBuEP1是業(yè)界首個(gè)統(tǒng)一仿真和原型設(shè)計(jì)系統(tǒng),它能使用戶可以在整個(gè)芯片開發(fā)生命周期中利用這個(gè)單一驗(yàn)證硬件系統(tǒng)。HAPS-100能允許設(shè)計(jì)人員、軟件開發(fā)人員和驗(yàn)證工程師通過(guò)HAPS Gateway管理multi-design、多用戶部署,以實(shí)現(xiàn)最大的生產(chǎn)力和成本效率。

圖7

圖8
在Multi-Die系統(tǒng)設(shè)計(jì)實(shí)現(xiàn)上,新思科技3DIC Compiler平臺(tái)是一個(gè)完整的端到端解決方案,它結(jié)合了許多變革的、Multi-Die設(shè)計(jì)功能,提供了一個(gè)完整的從架構(gòu)到簽核的平臺(tái),可實(shí)現(xiàn)高效的2.5D和3D Multi-Die系統(tǒng)集成,其內(nèi)部的黃金signoff工具可以保證每個(gè)參數(shù)都能準(zhǔn)確、完整和方便地signoff。
除此之外,新思科技還可以提供一系列經(jīng)過(guò)硅驗(yàn)證的可靠和安全I(xiàn)P,包括用于高帶寬、低延遲的die-to-die連接的UCIe、用于高帶寬、低功耗內(nèi)存的HBM和用于防止篡改和物理攻擊的安全接口等等。

圖9:新思科技可以提供一系列經(jīng)過(guò)硅驗(yàn)證的UCIe IP
為了確保最終制造的良率和產(chǎn)品的可靠性,需要對(duì)產(chǎn)品質(zhì)量進(jìn)行測(cè)試,包括對(duì)Multi-Die系統(tǒng)中的各個(gè)裸片、內(nèi)存、互聯(lián)以及整個(gè)系統(tǒng)進(jìn)行全面的測(cè)試、調(diào)試、維修,特別是像3DIC這樣的多系統(tǒng)設(shè)計(jì)提出了獨(dú)特的測(cè)試挑戰(zhàn),IEEE Std 1838-2019就是3DIC一個(gè)必須要滿足的標(biāo)準(zhǔn)。最終保證已知合格裸片(KGD)、封裝和系統(tǒng)的可用性。
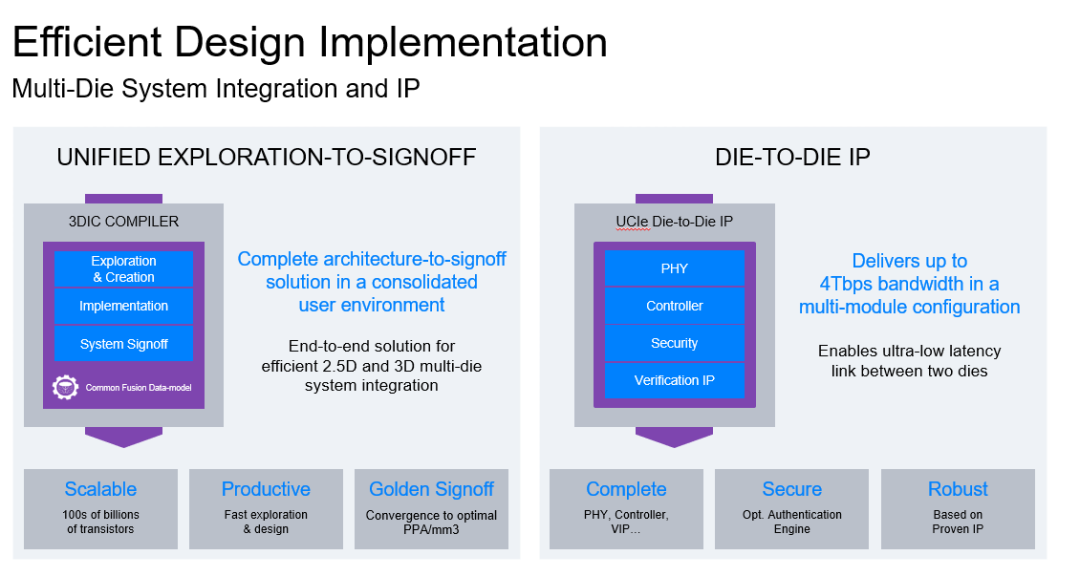
圖10:需要對(duì)產(chǎn)品質(zhì)量進(jìn)行測(cè)試,對(duì)芯片全生命周期進(jìn)行管理
在測(cè)試方面,新思科技的TestMAX系列可以為半導(dǎo)體設(shè)備的所有數(shù)字、存儲(chǔ)和模擬部分提供創(chuàng)新的測(cè)試和診斷功能。通過(guò)完整的RTL集成支持復(fù)雜可測(cè)性設(shè)計(jì)(DFT) 邏輯的早期驗(yàn)證,同時(shí)通過(guò)與新思科技Fusion Design Platform的直接鏈接保持物理、時(shí)序和功耗感知。這些新功能,再結(jié)合對(duì)早期可測(cè)試性分析和規(guī)劃、分層ATPG壓縮、物理感知診斷、邏輯 BIST、內(nèi)存自測(cè)試和修復(fù)以及模擬故障模擬的全面支持。

圖11:新思科技的TestMAX 系列
另一方面可以通過(guò)芯片全生命周期管理(SLM)技術(shù)進(jìn)行評(píng)估,SLM將監(jiān)視器集成到設(shè)計(jì)的組件中,以便在設(shè)備的整個(gè)生命周期中提取數(shù)據(jù),甚至在設(shè)備在現(xiàn)場(chǎng)的時(shí)候。從硅到系統(tǒng)收集到的深入的、可操作的見解允許持續(xù)的分析和優(yōu)化。對(duì)于Multi-Die這一體系結(jié)構(gòu),重點(diǎn)將放在系統(tǒng)上,因此監(jiān)控基礎(chǔ)設(shè)施應(yīng)該跨多個(gè)系統(tǒng),在這方面,新思科技的SLM系列產(chǎn)品改進(jìn)了設(shè)備生命周期每個(gè)階段的操作指標(biāo),該系列有一整套集成工具、IP和方法,在系統(tǒng)的整個(gè)生命周期內(nèi)智能高效地收集和存儲(chǔ)監(jiān)控?cái)?shù)據(jù),并通過(guò)使用強(qiáng)大的分析提供可操作的見解。

圖12:新思科技的芯片生命周期管理產(chǎn)品(SLM)系列

Multi-Die系統(tǒng)的出現(xiàn)為電子行業(yè)指明了一個(gè)新的發(fā)展方向,人工智能、超大規(guī)模數(shù)據(jù)中心、網(wǎng)絡(luò),手機(jī)和汽車等技術(shù)正在改變硅行業(yè)的格局,將Multi-Die設(shè)計(jì)推向前沿。但是我們需要明確的是,Multi-Die系統(tǒng)也面臨著重大的設(shè)計(jì)挑戰(zhàn),整個(gè)行業(yè)需要共同努力,一起推動(dòng)芯片的創(chuàng)新。
-
新思科技
+關(guān)注
關(guān)注
5文章
849瀏覽量
51107
原文標(biāo)題:愛“拼”才會(huì)贏:Multi-Die如何引領(lǐng)后摩爾時(shí)代的創(chuàng)新?
文章出處:【微信號(hào):Synopsys_CN,微信公眾號(hào):新思科技】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
利用新思科技Multi-Die解決方案加快創(chuàng)新速度

新思科技與英特爾攜手完成UCIe互操作性測(cè)試
新思科技全新40G UCIe IP解決方案助力Multi-Die設(shè)計(jì)
廣電計(jì)量受邀參加后摩爾器件研討會(huì) 攜半導(dǎo)體綜合技術(shù)解決方案亮相

利用Multi-Die設(shè)計(jì)的AI數(shù)據(jù)中心芯片對(duì)40G UCIe IP的需求
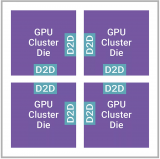
新思科技Multi-Die系統(tǒng)如何滿足現(xiàn)代計(jì)算需求
回顧:奇異摩爾@ ISCAS 2024 :聚焦互聯(lián)技術(shù)與創(chuàng)新實(shí)踐

摩爾斯微電子榮獲2024年WBA行業(yè)大獎(jiǎng)最佳Wi-Fi創(chuàng)新獎(jiǎng)等多項(xiàng)殊榮
高密度互連,引爆后摩爾技術(shù)革命

南京國(guó)高電氣備自投 —— 技術(shù)創(chuàng)新引領(lǐng)電力切換新時(shí)代
多通道開關(guān)濾波器的創(chuàng)新者,引領(lǐng)電磁兼容技術(shù)新趨勢(shì)
智馭未來(lái),AI拼才會(huì)贏—鄭弘孟董事長(zhǎng)寄語(yǔ)工業(yè)富聯(lián),拼搏共贏新篇章






 愛“拼”才會(huì)贏:Multi-Die如何引領(lǐng)后摩爾時(shí)代的創(chuàng)新?
愛“拼”才會(huì)贏:Multi-Die如何引領(lǐng)后摩爾時(shí)代的創(chuàng)新?










評(píng)論