點(diǎn)擊藍(lán)字關(guān)注我們
SiC MOSFET 在功率半導(dǎo)體市場中正迅速普及,因為它最初的一些可靠性問題已得到解決,并且價位已達(dá)到非常有吸引力的水平。隨著市場上的器件越來越多,必須了解 SiC MOSFET 與 IGBT 之間的共性和差異,以便用戶充分利用每種器件。本系列文章將概述安森美 M 1 1200 V SiC MOSFET 的關(guān)鍵特性及驅(qū)動條件對它的影響,作為安森美提供的全方位寬禁帶生態(tài)系統(tǒng)的一部分,還將提供NCP51705(用于 SiC MOSFET 的隔離柵極驅(qū)動器)的使用指南。本文為第一部分,將重點(diǎn)介紹安森美M 1 1200 V SiC MOSFET的靜態(tài)特性。
原版文檔獲取點(diǎn)擊文末的“贊”和“在看”,并發(fā)送截圖和您的郵箱地址到后臺,即可領(lǐng)取原版文檔哦~
碳化硅 (SiC) 是用于制造分立功率半導(dǎo)體的寬禁帶 (WBG) 半導(dǎo)體材料系列的一部分。如表 1 所示,傳統(tǒng)硅 (Si) MOSFET 的帶隙能量為 1.12 eV,而 SiC MOSFET 的帶隙能量則為 3.26 eV。
SiC 和氮化鎵 (GaN) 具有更寬的帶隙能量,意味著將電子從價帶移動到導(dǎo)帶需要大約 3 倍的能量,從而使材料的表現(xiàn)更像絕緣體而不像導(dǎo)體。這使得 WBG 半導(dǎo)體能夠承受更高的擊穿電壓,其擊穿場穩(wěn)健性是硅的 10 倍。對于給定的額定電壓,較高的擊穿場可以減小器件的厚度,從而轉(zhuǎn)化為較低的導(dǎo)通電阻和較高的電流能力。SiC 和 GaN 都具有與硅相同數(shù)量級的遷移率參數(shù),這使得兩種材料都非常適合高頻開關(guān)應(yīng)用。SiC 的熱導(dǎo)率是硅和 GaN 的三倍。對于給定的功耗,較高的熱導(dǎo)率將轉(zhuǎn)化為較低的溫升。
特定所需擊穿電壓的 RDS(ON)是 MOSFET的一部分,它與遷移率乘以臨界擊穿場的立方成反比。即使 SiC 的遷移率低于硅,但其臨界擊穿場高 10 倍,導(dǎo)致給定擊穿電壓的 RDS(ON)要低得多。
商用 SiC MOSFET 的保證最高工作溫度為 150℃< TJ< 200℃。相比之下,可以實現(xiàn)高達(dá) 600℃ 的 SiC 結(jié)溫,但其主要受鍵合和封裝技術(shù)的限制。這使得 SiC 成為適用于高壓、高速、高電流、高溫、開關(guān)電源應(yīng)用的優(yōu)質(zhì) WBG 半導(dǎo)體材料。
表 1:半導(dǎo)體材料屬性
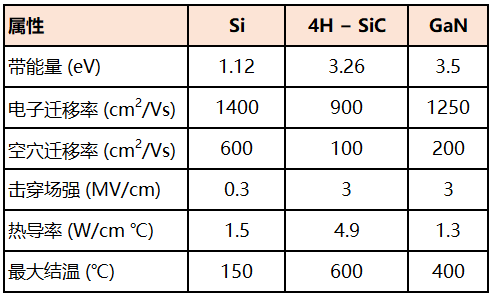
SiC MOSFET 通常在 650 V < BVDSS < 1.7 kV 范圍內(nèi)可用。盡管 SiC MOSFET 的動態(tài)開關(guān)行為與標(biāo)準(zhǔn)硅 MOSFET 非常相似,但必須考慮其器件特性決定的獨(dú)特柵極驅(qū)動要求。
靜態(tài)特性
 阻斷電壓能力
阻斷電壓能力安森美 M 1 1200 V SiC MOSFET 的額定電壓為 1200 V,具有每個特定器件的數(shù)據(jù)表中規(guī)定的最大零柵極電壓漏極電流 (IDSS)。然而,SiC MOSFET 的阻斷電壓能力會隨著溫度的升高而降低。以 1200 V 20 m SiC MOSFET 電源模塊為例,與 25℃ 時的值相比,?40℃ 時阻斷電壓 (VDS) 的典型降額約為 11%。即使安森美的器件通常留有一些裕度,在設(shè)計期間,也應(yīng)考慮 VDS 的降額,尤其是在器件將在極低溫度下運(yùn)行時。在圖 1 中可以看到擊穿電壓與溫度的典型分布。
重要提示:這些是典型的參考值,無法保證一定會實現(xiàn),請參考數(shù)據(jù)表中的值或聯(lián)系您當(dāng)?shù)氐募夹g(shù)支持人員。


圖 1:VDS 與溫度的典型分布
 RDS(ON) 特性和驅(qū)動安森美 M 1 1200 V SiC MOSFET 的推薦 VGS
RDS(ON) 特性和驅(qū)動安森美 M 1 1200 V SiC MOSFET 的推薦 VGS與硅相關(guān)產(chǎn)品相比,SiC MOSFET 的主要區(qū)別之一是漏極-源極電壓 (VDS) 與特定漏極電流 (ID) 的柵源電壓 (VGS) 的相關(guān)性,并且在這個安森美 1200 V SiC MOSFET 中也不例外。圖 2 顯示傳統(tǒng)的 Si MOSFET 在線性(歐姆)和有源區(qū)(飽和)之間顯示出明顯的過渡。另一方面,參見圖 3,SiC MOSFET 并不會出現(xiàn)這種狀況,實際上沒有飽和區(qū),這意味著 SiC MOSFET 的表現(xiàn)更像是可變電阻,而不是非理想型的電流源。

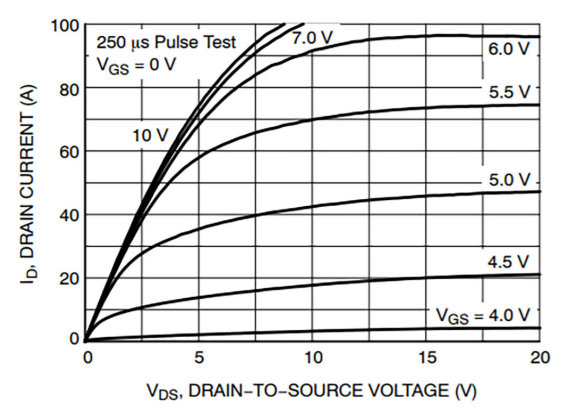
圖 2:SJ MOSFET 的典型靜態(tài)特性
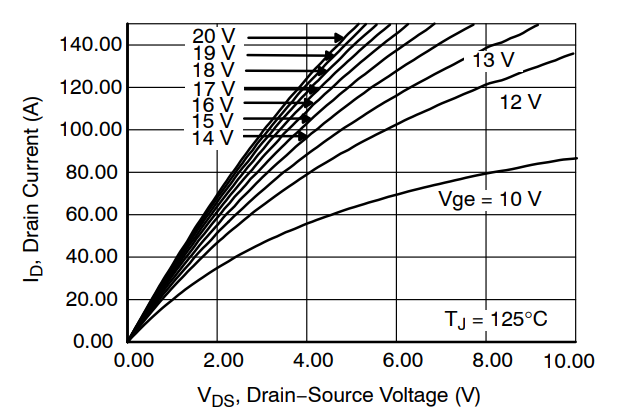
圖 3:安森美 1200 V SiC MOSFET M 1 的典型靜態(tài)特性
在選擇適當(dāng)?shù)?VGS 時需要考慮的一個重要方面是,與硅基器件不同,當(dāng) VGS 增加時,即使在相對較高的電壓下,SiC MOSFET 也仍會表現(xiàn)出 RDS(ON)的顯著改善。這可以從圖 3 中看出:當(dāng) VGS增加時,曲線向左移動。如果我們看一下圖 2,當(dāng) VGS >> VTh 時,Si MOSFET 的 RDS(ON) 未表現(xiàn)出顯著改善,因此,大多數(shù) Si MOSFET 通常以 VGS≤ 10 V 驅(qū)動。因此,如果用 SiC 替換 Si MOSFET,建議修改驅(qū)動電壓。盡管 10 V 高于 SiC MOSFET 的典型閾值電壓,但在如此低的 VGS 下的傳導(dǎo)損耗很可能會導(dǎo)致器件的熱失控。這是建議使用 VGS ≥ 18 V 來驅(qū)動安森美 1200 V M 1 SiC MOSFET 的原因之一。
如果選擇的電壓過高,則會在柵極氧化物中引入更高的應(yīng)力,這可能導(dǎo)致長期可靠性問題或關(guān)鍵特性變化,如 VTH 漂移。在資質(zhì)認(rèn)定階段,安森美 M 1 1200 V SiC MOSFET 經(jīng)過大量測試,以確定 + 25 V 的最大柵極電壓。例如,在圖 4 中,正柵極偏壓應(yīng)力測試的結(jié)果以綠色顯示。與其他供應(yīng)商相比,安森美 M 1 1200 V SiC MOSFET 在持續(xù)施加 + 25 V 電壓時表現(xiàn)出良好的穩(wěn)定性。


圖 4:正柵極偏壓應(yīng)力測試。測試條件:VGS = 25 V,T = 175℃
即使采用最佳布局和最少電感封裝,也無法避免管芯柵極處的瞬態(tài)電壓尖峰。為了不超過 + 25 V 的勢壘,建議最大向 MOSFET 施加 VGS ≤ 20 V 的恒定電壓。
 RDS(ON),溫度相關(guān)性
RDS(ON),溫度相關(guān)性需要考慮的另一個因素是 SiC MOSFET 的溫度系數(shù)。在低溫下,SiC MOSFET 通常呈現(xiàn)負(fù)溫度系數(shù) (NTC),直到其達(dá)到某一溫度并開始具有正溫度系數(shù) (PTC)。這個轉(zhuǎn)折點(diǎn)受 VGS 影響。在較低的 VGS 下,NTC 會一直持續(xù)到較高的溫度,而如果這個電壓增加,則轉(zhuǎn)折點(diǎn)將在較低的溫度下發(fā)生。在圖 5 中,可以看出安森美 M 1 SiC MOSFET 在不同 VGS 下 RDS(ON) 與溫度的典型相關(guān)性。如果我們觀察 VGS = 15 V 時的曲線,NTC 在負(fù)溫度下非常陡峭,在大約 50℃ 時仍然明顯,這導(dǎo)致高溫下的 RDS(ON) 在所有情況下都低于負(fù)溫度下的 RDS(ON)。如果兩個組件并聯(lián)切換,就像我們的許多電源模塊一樣,其中一個組件可能會過載,特別是當(dāng)器件在負(fù)環(huán)境溫度下啟動時,可能會導(dǎo)致熱失控。如果 VGS 增加,此現(xiàn)象將得到糾正。在 18 V 時,溫度系數(shù)的轉(zhuǎn)折點(diǎn)約為 25℃,在 100℃ 時,RDS(ON) 值已經(jīng)高于 ?40℃ 時的值,這使其成為并聯(lián)切換器件的安全電壓,即使在寒冷的環(huán)境中使用也是如此。

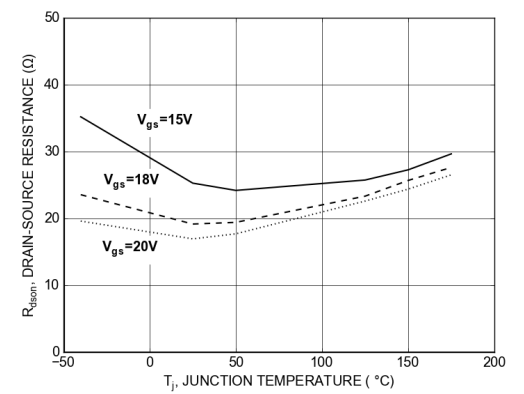
圖 5:不同 VGS 下 RDS(ON) 的溫度相關(guān)性
為了計算 SiC MOSFET 器件的靜態(tài)損耗或為了比較不同的供應(yīng)商,不僅要查看器件在 25℃ 時的 RDS(ON)(通常在出于營銷目的而定義器件時使用),還要查看目標(biāo)應(yīng)用溫度下的 RDS(ON)。如前一段所述,在某個轉(zhuǎn)折點(diǎn)之后,SiC MOSFET 會具有 PTC。個中好處已經(jīng)解釋過了,但如果系數(shù)很高,25℃ 和應(yīng)用中實際溫度下的 RDS(ON)之間的差異會變得非常關(guān)鍵,導(dǎo)致在目標(biāo)工作溫度下的傳導(dǎo)損耗顯著增加。在選擇 SiC MOSFET 時需要考慮這一點(diǎn)。
當(dāng)溫度升高時,安森美 M 1 1200 V SiC MOSFET 在 RDS(ON)方面表現(xiàn)出良好的穩(wěn)定性。圖 6 顯示了在不同漏極電流 (ID) 下,20 m 器件在 25℃ 和 150℃ 時的差異。當(dāng) ID = 50 A 時,RDS(ON) 增加了 33%,這足以確保良好的并聯(lián)工作,且不會導(dǎo)致靜態(tài)損耗顯著增加。

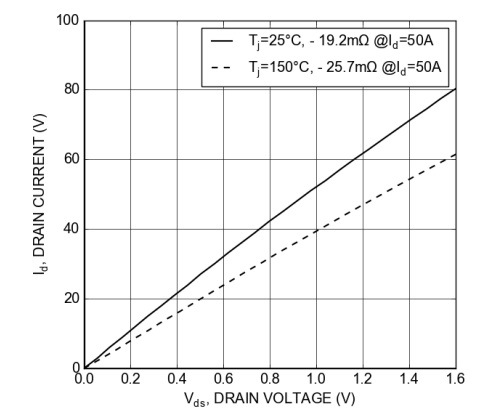
圖 6:1200 V、20 mΩ SiC MOSFET 電源模塊在不同溫度下的 VDS 與 ID
 選擇負(fù)柵極偏壓
選擇負(fù)柵極偏壓到目前為止,已經(jīng)討論了用于定義正柵極偏壓的不同參數(shù)。結(jié)論是,安森美 M 1 1200 V SiC MOSFET 的 VGS 在靜態(tài)操作期間應(yīng)設(shè)置為 + 18 V ≤ VGS ≤ 20 V,而在動態(tài)瞬態(tài)中不應(yīng)超過 + 25 V。但如何定義負(fù)柵極偏壓呢?當(dāng)然,該值應(yīng)足夠低,以確保器件正確關(guān)閉,同時避免在那些容易產(chǎn)生直通電流的拓?fù)洌ㄈ绨霕颍┲谐霈F(xiàn)寄生導(dǎo)通。
就 VTH 而言,目前市場上有兩種類型的 SiC MOSFET,即典型值高于 3.5V 的高閾值電壓 SiC MOSFET 和典型值低于 3V 至 3.5V 的低閾值電壓 SiC MOSFET。安森美 M 1 1200 V SiC MOSFET 屬于第二類,其典型 VTH 值在 2.75 V 的范圍內(nèi)(各個器件的具體值見數(shù)據(jù)表)。該值隨溫度變化,可能低至 1.8 V,也可能高達(dá) 4.3 V。
在可能產(chǎn)生直通電流的應(yīng)用中,建議使用 ? 5 V 的負(fù)柵極偏壓,以留有足夠的安全裕度,避免寄生導(dǎo)通,尤其是在較高的開關(guān)頻率下。將負(fù) VTH 設(shè)置為 ? 5 V 還應(yīng)給予足夠的裕度,以避免瞬態(tài)柵極電壓低于在 ?15 V 設(shè)置的最小限值。
在直通電流風(fēng)險不存在(即升壓器拓?fù)洌┗蚪柚F(xiàn)有技術(shù)而降低(即用寄生電感解耦半橋輸出)的情況下,負(fù)柵極偏壓可以增加到高達(dá) 0V 的任何安全值。這對器件的性能有其他影響,將在下一章進(jìn)行討論。
與正柵極偏壓一樣,具有非常低的負(fù)柵極偏壓可能會觸發(fā) SiC 晶體的缺陷,導(dǎo)致可靠性問題或關(guān)鍵參數(shù)的修改,例如 VTH 或 RDS(ON) 漂移,這在談?wù)撠?fù)柵極偏壓和當(dāng)前可用的 SiC 溝槽 MOSFET 時尤其關(guān)鍵。為了防止這些問題,安森美在設(shè)計中考慮了這一點(diǎn),并對 M 1 1200 V SiC MOSFET 進(jìn)行了大量的靜態(tài)和動態(tài)測試,以確認(rèn)沒有漂移。圖 7 顯示了靜態(tài)負(fù)柵極偏壓的結(jié)果及其在 VTH 方面的影響。此外,我們的生產(chǎn)線還進(jìn)行了老化測試,以限制過早發(fā)生故障的情況。


圖 7:負(fù)柵極偏壓應(yīng)力測試。測試條件:VGS = -20 V,T = 175 ℃
 體二極管正向電壓 (Vf) vs. VGS
體二極管正向電壓 (Vf) vs. VGS眾所周知,與其他類型的二極管相比,SiC MOSFET 的體二極管具有較高的正向電壓。在使用 SiC MOSFET 時應(yīng)考慮這一特性,通常,不建議在許多拓?fù)涞乃绤^(qū)時間之外使用,以避免高損耗。減少體二極管使用的一種有效方式是在需要反向?qū)〞r激活 MOSFET 的溝道。這樣做可以顯著減少損耗。
但是,對于在激活溝道之前需要死區(qū)時間的拓?fù)洌?a target="_blank">同步整流中的典型半橋,無法有效地停用體二極管,因為需要更多器件和/或修改電流路徑。此外,即使采取許多預(yù)防措施,也可能無法完全避免在死區(qū)時間使用體二極管。安森美 M 1 1200 V SiC MOSFET 可以使用體二極管,且不會導(dǎo)致可靠性下降或 MOSFET 主要參數(shù)出現(xiàn)重大漂移。
考慮到這一點(diǎn),必須要知道 VGS 將對體二極管的靜態(tài)性能產(chǎn)生影響。圖 8 顯示了當(dāng)應(yīng)用不同的 VGS 時,安森美 M 1 1200 V SiC MOSFET 的體二極管與正向電流 (If) 的 Vf相關(guān)性。如圖所示,當(dāng)負(fù)柵極偏壓減小時,Vf 略微增加。此圖具有一些誤導(dǎo)性,因為它可能會讓用戶得出將 VGS 設(shè)置為 0 V 是最佳解決方案的結(jié)論。然而,這個 Vf 較低的原因是 MOSFET 的溝道處于微導(dǎo)通狀態(tài),所以外部看起來 Vf較低的實際上是從體二極管接收部分電流的溝道。當(dāng)二極管停止導(dǎo)通時,溝道仍將保持微導(dǎo)通。根據(jù)開關(guān)拓?fù)洌@可能會對總損耗產(chǎn)生負(fù)面影響,并增加泄漏。此外,在 0 V 時,開關(guān)損耗將急劇增加,具體稍后會進(jìn)行解釋。這種現(xiàn)象在 SiC 技術(shù)中很常見,可以通過將 VGS 降低到 ?5 V 來避免。

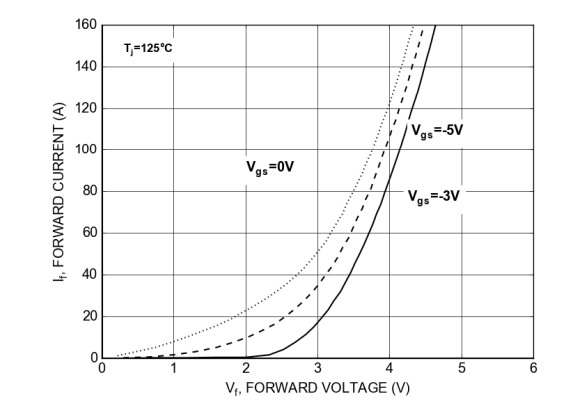
圖 8:20 mΩ、1200 V SiC MOSFET 模塊中不同 VGS 的 Vf 與 If
 VTH,溫度相關(guān)性
VTH,溫度相關(guān)性在前幾章中,已經(jīng)介紹了當(dāng)施加正或負(fù)柵極偏壓時的 VTH 漂移。影響 VTH 的另一個因素是溫度。與所有 MOSFET 一樣,安森美 M 1 1200 V SiC MOSFET 具有負(fù)溫度系數(shù)。結(jié)果是,VTH 可以從 25℃ 時的約 2.6 V 典型值降低到 175℃ 時的 1.8 V。圖 9 顯示了 40 mΩ 器件在不同溫度下的典型 VTH 值。在設(shè)計柵極驅(qū)動器電路時必須考慮這一點(diǎn),以避免不必要的寄生導(dǎo)通。再次重申,應(yīng)在實際應(yīng)用溫度下考慮此數(shù)據(jù)。例如,與 125℃ 時相比,室溫下柵極處的 2 V 電壓尖峰觸發(fā)寄生導(dǎo)通的可能性更低。

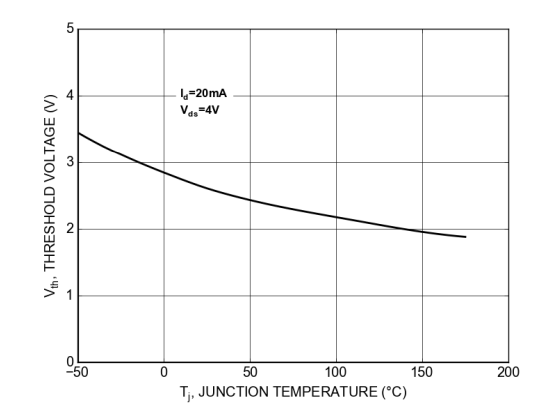
圖 9:40 mΩ、1200 V SiC MOSFET 中的典型 VTH 值與溫度
為了在對寄生導(dǎo)通敏感的拓?fù)洌ㄈ绨霕颍┲斜3职踩6取=ㄗh在器件關(guān)閉時設(shè)置負(fù) VGS。
原版文檔獲取點(diǎn)擊文末的“贊”和“在看”,并發(fā)送截圖和您的郵箱地址到后臺,即可領(lǐng)取原版文檔哦~


原文標(biāo)題:安森美 M 1 1200 V SiC MOSFET 靜態(tài)特性分析
文章出處:【微信公眾號:安森美】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
-
安森美
+關(guān)注
關(guān)注
32文章
1767瀏覽量
92778
原文標(biāo)題:安森美 M 1 1200 V SiC MOSFET 靜態(tài)特性分析
文章出處:【微信號:onsemi-china,微信公眾號:安森美】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
Nexperia推出采用X.PAK封裝的1200V SiC MOSFET
?安森美推出基于碳化硅的智能功率模塊
SiC MOSFET的靜態(tài)特性

安森美SiC cascode JFET并聯(lián)設(shè)計的挑戰(zhàn)

安森美SiC Cascode JFET的背景知識和并聯(lián)設(shè)計

安森美新型SiC模塊評估板概述
國產(chǎn)SiC MOSFET在T型三電平拓?fù)渲械膽?yīng)用分析
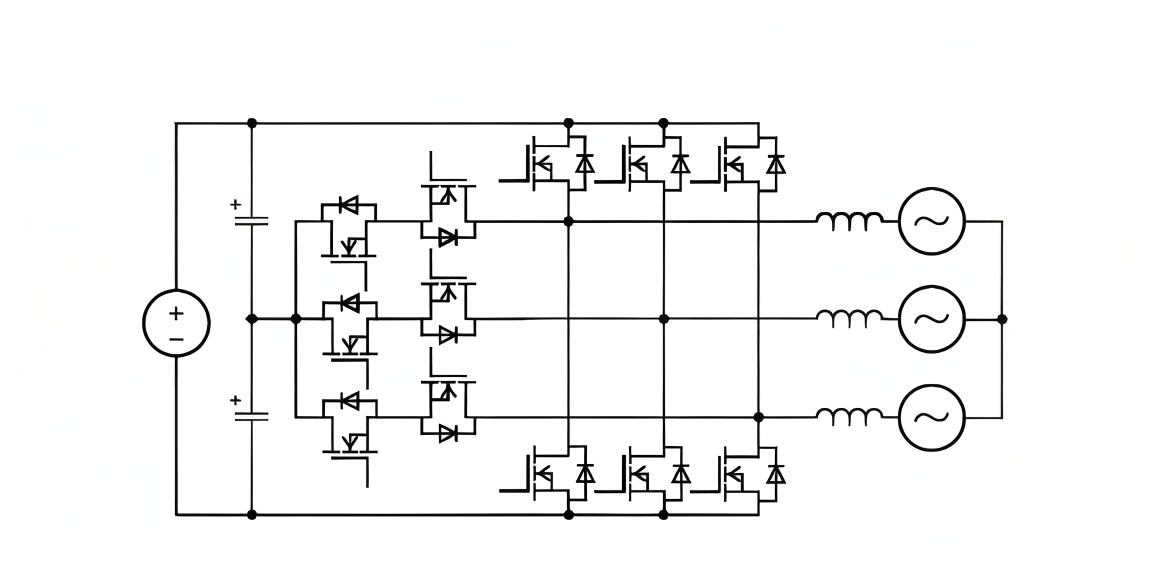
安森美M3S與M2 SiC MOSFET的性能比較

SiC MOSFET的參數(shù)特性
又一大廠確定下一代SiC MOSFET采用溝槽設(shè)計
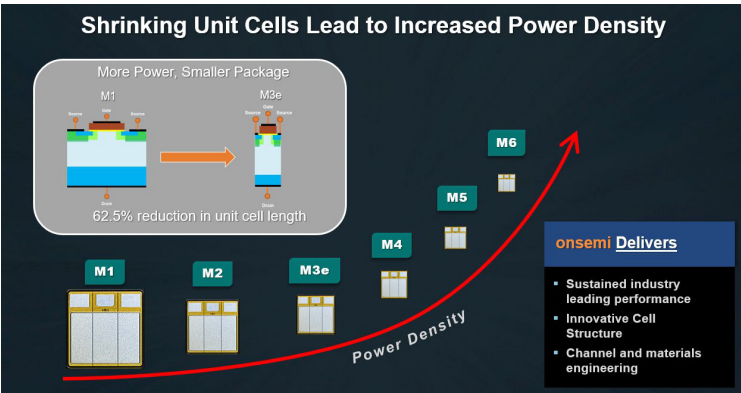
三菱電機(jī)1200V級SiC MOSFET技術(shù)解析
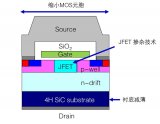
揭秘安森美在SiC市場的未來布局
本土IDM廠商SiC MOSFET新進(jìn)展,將應(yīng)用于車載電驅(qū)
瞻芯電子第三代1200V 13.5mΩ SiC MOSFET通過車規(guī)級可靠性測試認(rèn)證






 安森美 M 1 1200 V SiC MOSFET 靜態(tài)特性分析
安森美 M 1 1200 V SiC MOSFET 靜態(tài)特性分析
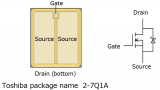










評論