減薄晶片有四種主要方法,(1)機械研磨,(2)化學機械平面化,(3)濕法蝕刻(4)等離子體干法化學蝕刻(ADP DCE)。四種晶片減薄技術由兩組組成:研磨和蝕刻。為了研磨晶片,將砂輪和水或化學漿液結合起來與晶片反應并使之變薄,而蝕刻則使用化學物質來使基板變薄。
機械研磨
機械(常規(guī))磨削–該工藝具有很高的稀化率,使其成為非常普遍的技術。它使用安裝在高速主軸上的金剛石和樹脂粘合的砂輪,類似于旋涂應用中使用的砂輪。研磨配方決定主軸的速度以及材料的去除率。為了準備機械研磨,將晶片放在多孔陶瓷卡盤上,并通過真空將其固定在適當?shù)奈恢谩>A的背面朝著砂輪放置,而砂帶則放置在晶圓的前側,以防止晶圓在減薄過程中受到任何損壞。當去離子水噴灑到晶圓上時,兩個齒輪以相反的方向旋轉,以確保砂輪和基材之間有足夠的潤滑。這也可以控制溫度和減薄率,以確保不會將晶片切割得太薄。
總而言之,該過程分兩個步驟:粗磨以?5μm/ sec的速度進行大部分的細化。用1200至2000粗砂和poligrind精磨精磨。通常以≤1μm/ sec的速度去除?30μm或更小的材料,并在晶片上提供最終的光潔度。1200粗砂的粗糙表面帶有明顯的磨痕,而2000粗砂的粗糙程度較小,但是仍然有一些磨痕。Poligrind是一種拋光工具,可提供最大的晶片強度,并消除了大部分的次表面損傷。
化學機械平面化(CMP)
化學機械平面化(CMP)–此過程使晶片變平并去除表面的不規(guī)則形貌。CMP使用小顆粒研磨化學漿料和拋光墊進行。盡管它傾向于清潔程度較低,但它比機械研磨提供了更多的平面化效果。化學機械平面化分為三個步驟:
1.將晶片安裝到背面膜上,例如蠟架,以將其固定在適當?shù)奈恢谩?/p>
2.從上方涂抹化學漿,并用拋光墊將其均勻分布。
3.每次拋光都旋轉拋光墊約60-90秒,具體取決于最終厚度規(guī)格。
CMP的稀化速度比機械研磨慢,每秒僅清除幾微米。這將導致近乎完美的平整度和可控的TTV。
刻蝕濕蝕刻
濕蝕刻使用液體化學藥品或蝕刻劑從晶圓上去除材料。這在僅晶圓部分需要減薄的情況下很有用。通過在蝕刻之前在晶片上放置一個硬掩模,變薄只會在沒有襯底的部分襯底上發(fā)生。有兩種執(zhí)行濕法蝕刻的方法:各向同性(在所有方向均勻)和各向異性(在垂直方向上均勻)。此過程分為三個步驟:
1.液體蝕刻劑擴散到晶圓表面。液體蝕刻劑根據(jù)所需的厚度以及是否需要各向同性或各向異性蝕刻而變化。在各向同性蝕刻中,最常見的蝕刻劑是氫氟酸,硝酸和乙酸(HNA)的組合。最常見的各向異性蝕刻劑是氫氧化鉀(KOH),乙二胺鄰苯二酚(EDP)和氫氧化四甲銨(TMAH)。
2.薄薄的蝕刻劑流噴灑在旋轉晶片的表面上,液體蝕刻劑與基板反應使基板變薄。盡管大多數(shù)反應以?10μm/ min的速度進行反應,但反應速率可能會根據(jù)反應中使用的蝕刻劑而變化。
3.化學副產物從晶片表面擴散。
大氣下游等離子體(ADP)干法蝕刻(DCE)ADP DCE是最新的晶圓減薄技術,與濕法蝕刻類似。代替使用液體,干式化學蝕刻使用等離子體或蝕刻劑氣體去除材料。為了執(zhí)行減薄過程,可以在目標晶圓上發(fā)射高動能粒子束,化學物質與晶圓表面發(fā)生反應或兩者結合。干法刻蝕的去除速度約為20μm/ min,并且沒有機械應力或化學物質,因此這種方法能夠以高產量生產出非常薄的晶片。
審核編輯:湯梓紅
-
等離子體
+關注
關注
0文章
128瀏覽量
14477 -
晶圓
+關注
關注
52文章
5113瀏覽量
129157 -
蝕刻
+關注
關注
10文章
424瀏覽量
15934 -
CMP
+關注
關注
6文章
152瀏覽量
26497 -
晶片
+關注
關注
1文章
406瀏覽量
31921
原文標題:簡述晶圓減薄的幾種方法
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
宜特晶圓:成功開發(fā)晶圓減薄達1.5mil(38um)技術
同茂線性馬達談新面世的高精密晶圓減薄機
單面晶圓減薄和處理研究報告
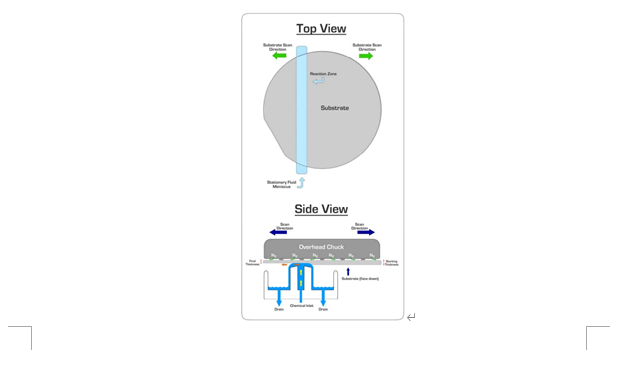
微機械結構硅片的機械減薄研究
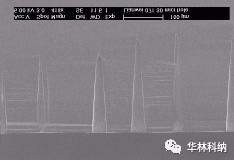
晶圓減薄工藝的主要步驟

晶盛機電減薄機實現(xiàn)12英寸30μm超薄晶圓穩(wěn)定加工
芯豐精密第二臺12寸超精密晶圓減薄機成功交付
改善晶圓出刀TTV異常的加工方法有哪些?






 簡述晶圓減薄的幾種方法
簡述晶圓減薄的幾種方法














評論