1、Chiplet是國內(nèi)半導(dǎo)體彎道超車的重要途徑,市場規(guī)模有望快速增長
1.1、Chiplet為后摩爾時(shí)代提升芯片算力與集成度的重要途徑
摩爾定律指引過去幾十年集成電路產(chǎn)業(yè)發(fā)展。摩爾定律由英特爾創(chuàng)始人之一的戈登·摩 爾(Gordon Moore)提出,其核心內(nèi)容為:在價(jià)格不變時(shí),集成電路上可以容納的晶體 管數(shù)量每 18-24 個(gè)月便會(huì)增加一倍,即:處理器性能大約每兩年翻一倍,同時(shí)價(jià)格下降 為之前的一半。在過去幾十年,摩爾定律指引著集成電路產(chǎn)業(yè)發(fā)展。隨著工藝進(jìn)步,集 成電路上晶體管密度不斷提升,驅(qū)動(dòng)計(jì)算機(jī)性能保持幾何級(jí)數(shù)增長,而性能的快速提升 則推動(dòng)芯片價(jià)格迅速下降。
“摩爾定律”發(fā)展陷入瓶頸,集成電路進(jìn)入后摩爾時(shí)代。從 1987 年的 1um 制程至 2015 年的 14nm 制程,集成電路制程迭代大致符合“摩爾定律”的規(guī)律。但自 2015 年以來, 集成電路先進(jìn)制程的發(fā)展開始放緩,7nm、5nm、3nm 制程的量產(chǎn)進(jìn)度均落后于預(yù)期。隨 著臺(tái)積電宣布 2nm 制程工藝實(shí)現(xiàn)突破,集成電路制程工藝已接近物理尺寸的極限,摩爾 定律發(fā)展陷入瓶頸,行業(yè)進(jìn)入了“后摩爾時(shí)代”。
Chiplet 可在不改變制程的前提下提升算力,且保證芯片良率。Chiplet 俗稱“芯粒”, 又稱“小芯片組”,從字面意義上可以理解為“粒度更小的芯片”。它是將一類滿足特 定功能的 die,通過 die-to-die 內(nèi)部互聯(lián)技術(shù)實(shí)現(xiàn)多個(gè)模塊芯片與底層基礎(chǔ)芯片封裝 在一起,進(jìn)而形成一個(gè)系統(tǒng)芯片。它可以有效提升芯片的集成度,是在不改變制程的前 提下提升算力,并且保證芯片生產(chǎn)良率的一種手段。
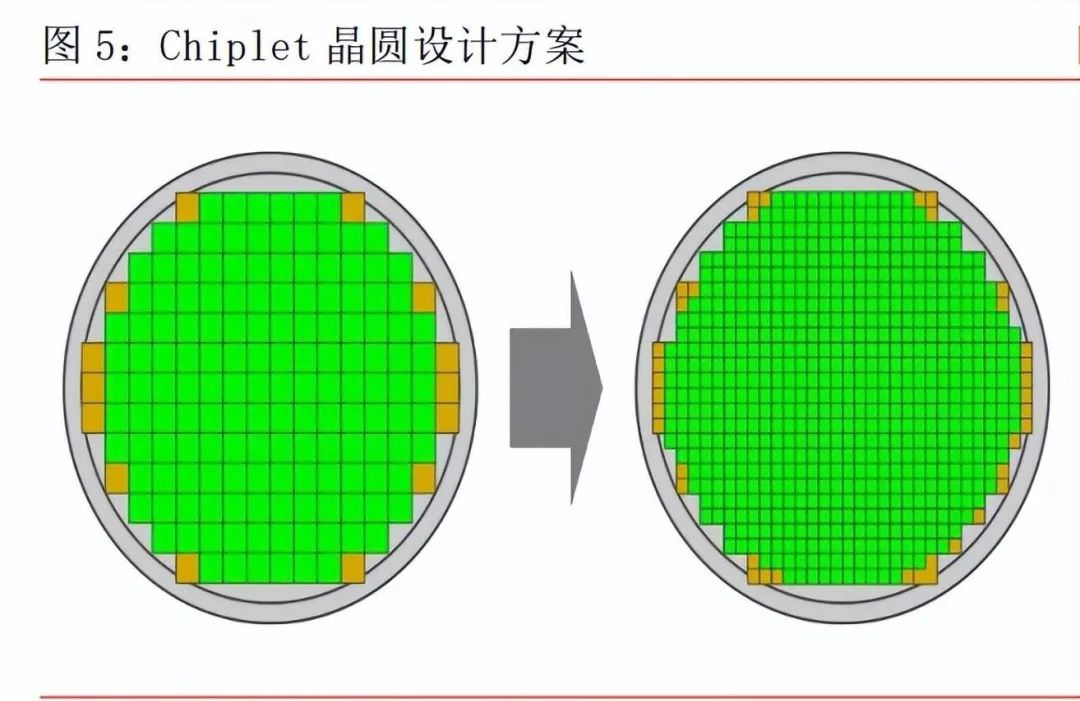
資料來源:EE Times,東莞證券研究所
與傳統(tǒng) SoC 相比,Chiplet 在設(shè)計(jì)靈活度、設(shè)計(jì)與生產(chǎn)成本、上市周期等方面優(yōu)勢明顯。傳統(tǒng) SoC,即系統(tǒng)級(jí)單芯片,是將多個(gè)負(fù)責(zé)不同類型計(jì)算任務(wù)的計(jì)算單元,通過光刻的 形式制作到同一塊晶圓上。隨著摩爾定律放緩,傳統(tǒng)的 SoC 的生產(chǎn)周期越來越長,在成 本大幅增加的情況下性能提升幅度有限,行業(yè)接近制造瓶頸;與 SoC 不同,Chiplet 是 將一塊原本復(fù)雜的 SoC 芯片,從設(shè)計(jì)時(shí)就先按照不同的計(jì)算單元或功能單元對(duì)其進(jìn)行分 解,然后每個(gè)單元選擇最適合的半導(dǎo)體制程工藝進(jìn)行分別制造,再通過先進(jìn)封裝技術(shù)將 各個(gè)單元彼此互聯(lián),最終集成封裝為一個(gè)系統(tǒng)級(jí)芯片組。
相比傳統(tǒng)的 SoC,Chiplet 能夠有效降低研發(fā)、設(shè)計(jì)與制造成本,并顯著提升芯片良率。英特爾公司高級(jí)副總裁、中國區(qū)董事長王銳在 2022 世界集成電路大會(huì)上表示,Chiplet 技術(shù)是產(chǎn)業(yè)鏈生產(chǎn)效率進(jìn)一步優(yōu)化的必然選擇。“不但提高芯片制造良品率,利用最合 適的工藝滿足數(shù)字、模擬、射頻、I/O 等不同技術(shù)需求,而且更將大規(guī)模的 SoC 按照不 同的功能,分解為模塊化的芯粒,減少重復(fù)的設(shè)計(jì)和驗(yàn)證環(huán)節(jié),大幅度降低設(shè)計(jì)復(fù)雜程 度,提高產(chǎn)品迭代速度。且有利于后續(xù)的產(chǎn)品迭代,縮短上市周期。”
Chiplet 優(yōu)勢一:降低芯片設(shè)計(jì)的復(fù)雜程度,有效降低研發(fā)與設(shè)計(jì)成本。Chiplet 芯粒 設(shè)計(jì)靈活,且可重復(fù)使用,通過將已知的合格芯片裸片進(jìn)行集成,能夠縮短芯片的研發(fā) 與設(shè)計(jì)周期,降低研發(fā)設(shè)計(jì)成本。據(jù)悉,設(shè)計(jì) 28nm 芯片的平均成本為 4,000 萬美元, 設(shè)計(jì) 7nm 芯片的成本上升至 2.17 億美元。而 The Linley Group 的白皮書《Chiplets Gain Rapid Adoption:Why Big Chips Are Getting Small》中提出,Chiplet 技術(shù)可以將大 型 7nm 設(shè)計(jì)的成本降低 25%。
Chiplet 優(yōu)勢二:提升良率。SoC 將多個(gè)不同類型計(jì)算任務(wù)的計(jì)算單元以光刻形式集成 在同一片晶圓上,隨著先進(jìn)制程不斷推進(jìn),單位面積上集成的晶體管數(shù)量越來越多,設(shè) 計(jì)周期越來越廠,芯片面積也在加大。高性能計(jì)算等領(lǐng)域巨大運(yùn)算需求推動(dòng)邏輯芯片運(yùn) 算核心數(shù)量上升,配套 SRAM 容量、I/O 數(shù)量隨之提升。隨著芯片面積的加大和集成的 晶體管數(shù)量增多,對(duì)制造過程中的芯片良率提出較高挑戰(zhàn),讓芯片生產(chǎn)中的工藝誤差和 加工缺陷顯得愈發(fā)明顯,一個(gè)微小的缺陷就可能導(dǎo)致整個(gè)大芯片報(bào)廢。Chiplet 技術(shù)將 大芯片分割成不同功能模塊進(jìn)行獨(dú)立制造,通過將廣泛的、成熟的芯片裸片進(jìn)行集成, 只需保障各個(gè)被集成的成熟芯片良率即可,能夠降低先進(jìn)制程的研發(fā)與制造風(fēng)險(xiǎn),有效 提升良率。

資料來源:臺(tái)積電法說會(huì),東莞證券研究所
Chiplet 優(yōu)勢三:大幅降低芯片制造成本。SoC 中的邏輯計(jì)算單元對(duì)性能要求高,整體 依賴先進(jìn)制程,具有極高的生產(chǎn)壁壘與制造成本;Chiplet 方案則可針對(duì)不同的模塊采取不同的合適的制程,分開制造,最后采用先進(jìn)封裝技術(shù)進(jìn)行組裝,能大幅降低芯片的 制造成本。
后摩爾時(shí)代,Chiplet 成為提高芯片算力與集成度的重要途徑。后摩爾時(shí)代,隨著集成 度提升,SoC 開始在供電、功耗和散熱等方面面臨挑戰(zhàn),芯片全流程設(shè)計(jì)成本大幅增加, 而制程工藝接近極限,每次迭代升級(jí)都需要付出極大的額外成本,而隨著性能提升,發(fā) 熱功耗等方面的問題也日益凸顯,繼續(xù)追求極致工藝的意義已經(jīng)不大。Chiplet 作為當(dāng) 下較受關(guān)注的半導(dǎo)體發(fā)展方向,可有效降低能夠有效降低芯片設(shè)計(jì)與制造的門檻,提升 良率和節(jié)約成本,因此成為摩爾定律趨緩背景下提升芯片集成度與算力的重要途徑。
1.2、海外科技領(lǐng)域制裁加劇,Chiplet助力國內(nèi)半導(dǎo)體產(chǎn)業(yè)彎道超車
海外科技領(lǐng)域制裁加劇,國內(nèi)半導(dǎo)體先進(jìn)制程發(fā)展受限。近年來中美摩擦加劇,美國針 對(duì)中國在高科技領(lǐng)域的限制增多,企圖通過加大制裁力度來限制國內(nèi)集成電路產(chǎn)業(yè)發(fā)展。2020 年 12 月,美國將中芯國際列入“實(shí)體清單”,限制企業(yè) 14nm 及以下半導(dǎo)體制程的 擴(kuò)產(chǎn);2022 年 8 月,美國簽署《芯片與科學(xué)法案》,主要用于增強(qiáng)美國本土晶圓廠的競 爭力,并明確規(guī)定獲得美國政府補(bǔ)貼的企業(yè),10 年內(nèi)不得在中國大陸擴(kuò)產(chǎn) 28nm 以下的 芯片制造。《芯片法案》的簽署,進(jìn)一步加劇了中美在高科技領(lǐng)域的脫鉤程度,導(dǎo)致國 內(nèi)芯片先進(jìn)制程發(fā)展受到限制。
先進(jìn)制程是提高算力的必要途徑,臺(tái)積電先進(jìn)制程占比不斷提高。近年來,人工智能、 大數(shù)據(jù)、自動(dòng)駕駛和 AIoT 等下游應(yīng)用的不斷發(fā)展,對(duì)芯片處理與運(yùn)算能力提出更高的 要求,高性能、低功耗成為先進(jìn)制程的發(fā)展方向。從全球晶圓代工龍頭臺(tái)積電的各制程 營收占比來看,近年來臺(tái)積電先進(jìn)制程營收占比不斷提升:2022 年前三季度,臺(tái)積電實(shí) 現(xiàn)營收 6,131.4 億元新臺(tái)幣,其中 5nm 制程占比 28%,7nm 制程占比 26%。而分地區(qū)看, 近年來臺(tái)積電來自大陸市場的營收占比有所下滑。2022 年,美國市場成為臺(tái)積電最大來 源,營收規(guī)模達(dá) 1.49 萬億新臺(tái)幣,占比 65.96%,中國大陸市場營收 2,451.68 億元,占 比 10.82%,相比 2020 年的 17.45%大幅下滑。

資料來源:Omdia,東莞證券研究所
海外制裁加劇,Chiplet 有望助力國內(nèi)半導(dǎo)體產(chǎn)業(yè)實(shí)現(xiàn)彎道超車。通過先進(jìn)制程可實(shí)現(xiàn) 芯片性能的迅速提升,因此全球晶圓代工龍頭先進(jìn)制程占比不斷提升,而中國大陸先進(jìn) 制程發(fā)展受到限制。Chiplet 技術(shù)僅對(duì)核心 Chip 采用先進(jìn)制程,其他如存儲(chǔ)芯片、I/O 芯片采用成熟制程,有效降低對(duì)先進(jìn)制程的依賴,有望成為我國半導(dǎo)體產(chǎn)業(yè)彎道超車的 突破口。2022 年 12 月,我國第一個(gè)原生 Chiplet 技術(shù)標(biāo)準(zhǔn)——《小芯片接口總線技術(shù) 要求》團(tuán)體標(biāo)準(zhǔn)正式發(fā)布,這個(gè)標(biāo)準(zhǔn)涵蓋了多種應(yīng)用場景的小芯片接口總線技術(shù)要求, 包括總體概述、接口要求、鏈路層、適配層、物理層和封裝要求等,能夠靈活應(yīng)對(duì)不同 的應(yīng)用場景、適配不同能力的技術(shù)供應(yīng)商。《總線技術(shù)要求》的發(fā)布,對(duì)于我國集成電 路產(chǎn)業(yè)延續(xù)“摩爾定律”,打破先進(jìn)制程限制因素,提升產(chǎn)業(yè)綜合競爭力,具有重要意 義。
1.3、新互聯(lián)標(biāo)準(zhǔn)提供行業(yè)規(guī)范,Chiplet市場規(guī)模有望快速擴(kuò)張
新互聯(lián)標(biāo)準(zhǔn) UCle 出臺(tái),為集成不同芯片提供標(biāo)準(zhǔn)與技術(shù)支持。盡管 Chiplet 優(yōu)勢明顯, 但由于過去 Chiplet 互聯(lián)標(biāo)準(zhǔn)并不統(tǒng)一,各類 Chiplet 產(chǎn)品接口有所不同,無法“拼接” 在一起,因此行業(yè)發(fā)展受到制約。2022 年 3 月,AMD、英特爾、臺(tái)積電、三星、美光、 微軟、Meta、Google 等十余家半導(dǎo)體、互聯(lián)網(wǎng)行業(yè)巨頭聯(lián)合成立了 Chiplet 標(biāo)準(zhǔn)聯(lián)盟, 正式推出了通用 Chiplet 高速互聯(lián)標(biāo)準(zhǔn)“Universal Chiplet Interconnect Express” (通用芯粒互連,簡稱“UCIe”),旨在定義一個(gè)開放、可互操作的 Chiplet 生態(tài)系統(tǒng) 標(biāo)準(zhǔn)。業(yè)內(nèi)巨頭聯(lián)手推動(dòng) Chiplet 接口規(guī)范的標(biāo)準(zhǔn)化,以實(shí)現(xiàn) Chiplet 在封裝級(jí)別的普 遍互聯(lián),構(gòu)建開放的 Chiplet 生態(tài)系統(tǒng),有助于 Chiplet 行業(yè)快速發(fā)展。
UCle 是唯一具有裸片間接口堆棧的標(biāo)準(zhǔn),成為 Chiplet 設(shè)計(jì)的首選標(biāo)準(zhǔn)。此前為應(yīng)對(duì) Chiplet 設(shè)計(jì)中所面臨的挑戰(zhàn),行業(yè)出現(xiàn)了集中不同的標(biāo)準(zhǔn),但 UCle 是唯一具有完整裸 片間接口堆棧的標(biāo)準(zhǔn),其他標(biāo)準(zhǔn)都沒有為協(xié)議棧提供完整裸片間接口的全面規(guī)范,大多 僅關(guān)注在特定層。而且 UCIe 支持 2D、2.5D 和橋接封裝,預(yù)計(jì)未來還會(huì)支持 3D 封裝。新思科技(Synosys)指出,Ucle 的堆棧本身擁有三層:協(xié)議層:最上層為協(xié)議層,通過基于流量控制單元(FLIT)的協(xié)議實(shí)現(xiàn),確保最大效率 和降低延遲,支持最流行的協(xié)議,包括 PCI Express(PCIe)、Compute Express Link (CXL)和/或用戶定義的流協(xié)議;
中間層:用于對(duì)協(xié)議進(jìn)行仲裁與協(xié)商,以及通過裸片間適配器進(jìn)行連接管理。基于循環(huán)冗余檢查(CRC)和重試機(jī)制,該層還包括可選的錯(cuò)誤糾正功能;物理層:定義了與封裝介質(zhì)的電氣接口,是電氣模擬前端(AFE)、發(fā)射器和接收器以 及邊帶通道允許兩個(gè)裸片之間進(jìn)行參數(shù)交換與協(xié)商的層級(jí)。邏輯 PHY 實(shí)現(xiàn)了連接初始化、 訓(xùn)練和校準(zhǔn)算法,以及測試和修復(fù)功能。

資料來源:Yole,東莞證券研究所
國內(nèi)廠商紛紛加入,直接受益于 Chiplet 發(fā)展趨勢。Ucle 的提出,為集成不同制程工藝、 不同廠商、不同技術(shù)的芯片提供了標(biāo)準(zhǔn)與技術(shù)支持,讓晶圓代工廠可以對(duì)不同類型的芯 片進(jìn)行集成,有助于 Chiplet 行業(yè)快速走向成熟。經(jīng)過數(shù)年發(fā)展,Chiplet 技術(shù)已逐漸 走向商用,成為芯片廠商較為依賴的技術(shù)手段,也被認(rèn)為是未來芯片行業(yè)發(fā)展的重要方 向。截至目前,芯原股份、長電科技、OPPO、阿里巴巴等眾多國內(nèi)知名企業(yè)已加入 UCle 聯(lián)盟中,直接受益于相關(guān)技術(shù)標(biāo)準(zhǔn),共同構(gòu)建 Chiplet 生態(tài)體系,助力行業(yè)快速發(fā)展。
Chiplet 市場規(guī)模不斷擴(kuò)張,預(yù)計(jì) 2034 年有望達(dá)到 570 億美元。Chiplet 可在一定程度 上避免摩爾定律放緩的窘境,全球半導(dǎo)體龍頭企業(yè)積極推進(jìn),市場規(guī)模有望實(shí)現(xiàn)高速增 長。Omdia 指出,2018 年全球 chiplet 市場規(guī)模約為 6.45 億美元,至 2024 年將達(dá)到 58 億美元,預(yù)計(jì)到 2035 年有望突破 570 億美元,2018-2035 年復(fù)合增長率超過 30%。
2、Chiplet技術(shù)持續(xù)推進(jìn),先進(jìn)封裝、IC載板、半導(dǎo)體IP等多環(huán)節(jié)受益
2.1、Chiplet拉動(dòng)先進(jìn)封裝、半導(dǎo)體測試需求
近年我國封測產(chǎn)業(yè)穩(wěn)步發(fā)展,行業(yè)增速高于全球平均水平。封測行業(yè)位于半導(dǎo)體生產(chǎn)制 造環(huán)節(jié)的下游,需要大量的設(shè)備與人員投入,屬于資本密集型、人員密集型產(chǎn)業(yè)。過去 十余年,在半導(dǎo)體產(chǎn)業(yè)轉(zhuǎn)移、人力資源成本優(yōu)勢、稅收優(yōu)惠等因素促進(jìn)下,全球集成電 路封測產(chǎn)能逐步向亞太地區(qū)轉(zhuǎn)移,目前亞太地區(qū)占據(jù)全球約 80%集成電路封測產(chǎn)能。近 年來,全球集成電路封測產(chǎn)業(yè)進(jìn)入穩(wěn)步發(fā)展期,2014-2021 年行業(yè)市場規(guī)模復(fù)合增長率 為 4.27%,而我國受益于下游智能手機(jī)等終端應(yīng)用的蓬勃發(fā)展,封測產(chǎn)業(yè)增速領(lǐng)先全球。據(jù)中國半導(dǎo)體行業(yè)協(xié)會(huì)數(shù)據(jù)統(tǒng)計(jì),中國集成電路封測業(yè)年度銷售額從 2014 年的 1,256 億美元增至 2021 年的 2,763 億美元,2014-2021 年符合增長率約為 11.92%,遠(yuǎn)高于同 期全球平均水平,隨著下游應(yīng)用持續(xù)發(fā)展以及先進(jìn)封裝工藝不斷進(jìn)步,國內(nèi)封測行業(yè)成 長空間廣闊。
本土 IC 設(shè)計(jì)企業(yè)增多,增大下游封測需求。我國的集成電路設(shè)計(jì)產(chǎn)業(yè)發(fā)展起點(diǎn)較低, 但依靠著巨大的市場需求和良好的產(chǎn)業(yè)政策環(huán)境等有利因素,已成為全球集成電路設(shè)計(jì) 產(chǎn)業(yè)的新生力量。從產(chǎn)業(yè)規(guī)模來看,我國大陸集成電路設(shè)計(jì)行業(yè)銷售規(guī)模從 2010 年的 550.0 億元增長至 2022 年的 5,345.7 億美元,年復(fù)合增長率約為 20.87%;而本土產(chǎn)業(yè) 鏈的逐步完善,也為國內(nèi)初創(chuàng)芯片設(shè)計(jì)公司提供了晶圓制造支持,疊加產(chǎn)業(yè)資金與政策 支持,以及海外人才回流,我國芯片設(shè)計(jì)公司數(shù)量快速增加。據(jù)中國半導(dǎo)體行業(yè)協(xié)會(huì)數(shù) 據(jù),自 2010 年以來,我國芯片設(shè)計(jì)公司數(shù)量大幅提升,2010 年僅為 582 家,2022 年增 長至 3,243 家,2010-2022 年年均復(fù)合增長率約為 15.39%。不斷擴(kuò)大的集成電路設(shè)計(jì)市 場規(guī)模與不斷增加的 IC 設(shè)計(jì)企業(yè)數(shù)量也增大對(duì)下游半導(dǎo)體封裝、測試需求,推動(dòng)我國 集成電路封測產(chǎn)業(yè)發(fā)展。

資料來源:中國半導(dǎo)體行業(yè)協(xié)會(huì)集成電路設(shè)計(jì)分會(huì)
封測為我國集成電路領(lǐng)域最具競爭力環(huán)節(jié),共有四家廠商營收進(jìn)入全球前十。目前我國 集成電路領(lǐng)域整體國產(chǎn)自給率較低,尤其是在半導(dǎo)體設(shè)備、材料與晶圓制造等環(huán)節(jié),與 國際領(lǐng)先水平差距較大,而封測為我國集成電路領(lǐng)域最具國際競爭力的環(huán)節(jié)。近年來, 以長電為代表的幾家國內(nèi)封測龍頭企業(yè)通過自主研發(fā)和并購重組,在先進(jìn)封裝領(lǐng)域不斷 發(fā)力,現(xiàn)已具備較強(qiáng)的市場競爭力,有能力參與國際市場競爭。據(jù)芯思想研究院,2022, 中國大陸有 4 家企業(yè)進(jìn)入全球封測廠商前十名,分別為長電科技、通富微電、華天科技 和智路封測、全年?duì)I收分列全球第 3、第 4、第 6 和第 7 位。
后摩爾時(shí)代,先進(jìn)封裝成為提升芯片性能的重要途徑。“后摩爾時(shí)代”制程技術(shù)突破難 度較大,工藝制程受成本大幅增長和技術(shù)壁壘等因素,進(jìn)步速度放緩。據(jù)市場調(diào)研機(jī)構(gòu) ICInsights 統(tǒng)計(jì),28nm 制程節(jié)點(diǎn)的芯片開發(fā)成本為 5,130 萬美元,16nm 節(jié)點(diǎn)的開發(fā)成 本為 1 億美元,7nm 節(jié)點(diǎn)的開發(fā)成本需要 2.97 億美元,而 5nm 節(jié)點(diǎn)開發(fā)成本則上升至 5.4 億美元。從產(chǎn)品開發(fā)角度,產(chǎn)品進(jìn)入到大規(guī)模量產(chǎn)前需要多次流片驗(yàn)證,帶來費(fèi)用 支出成倍增加。由于集成電路制程工藝短期內(nèi)難以突破,且制程升級(jí)對(duì)芯片性能提升的 邊際收益有所收窄,通過先進(jìn)封裝技術(shù)提升芯片整體性能成為了集成電路行業(yè)的一個(gè)重 要發(fā)展趨勢。
先進(jìn)封裝相比傳統(tǒng)封裝優(yōu)勢明顯。先進(jìn)封裝是相對(duì)傳統(tǒng)封裝提出來的概念。傳統(tǒng)封裝主 要是以引線框架作為載體,采用引線鍵合互聯(lián)的形式進(jìn)行封裝,包含 DIP、SOP、SOT、 DFN、BGA 等封裝形式;先進(jìn)封裝指當(dāng)下最前沿的封裝形式與技術(shù),目前帶有倒裝芯片 (Flip Chip,F(xiàn)C)結(jié)構(gòu)的封裝、晶圓級(jí)封裝(Wafer Level Package,WLP)、2.5D 封 裝、3D 封裝等被認(rèn)為屬于先進(jìn)封裝的范疇。
隨著先進(jìn)制程持續(xù)演進(jìn),以及電子產(chǎn)品不斷向小型化、高速化、系統(tǒng)化與低成本化發(fā)展, 傳統(tǒng)封裝的局限性愈發(fā)突出。與傳統(tǒng)封裝相比,先進(jìn)封裝能夠提升芯片的集成密度與互 聯(lián)速度,有效降低設(shè)計(jì)門檻,優(yōu)化功能搭配的靈活性,能夠增強(qiáng)芯片性能,并改善散熱 和可靠性,因此在高端邏輯芯片、存儲(chǔ)芯片、射頻、圖像處理和觸控芯片等領(lǐng)域得到廣 泛應(yīng)用。Yole 指出,2019 年全球先進(jìn)封裝市場規(guī)模占總封裝市場比重約為 42.60%,預(yù) 計(jì) 2019-2025 年將以 6.6%的年均復(fù)合增長率持續(xù)增長,至 2025 年先進(jìn)封裝占整個(gè)封裝 市場的比重有望接近 50%。
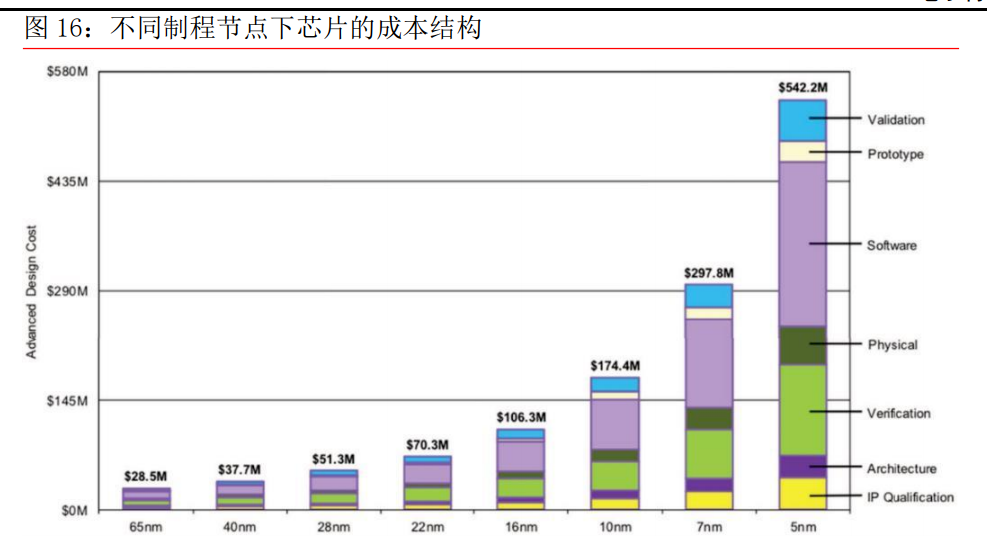
資料來源:IBS,東莞證券研究所
先進(jìn)封裝技術(shù)是 Chiplet 的基礎(chǔ),Chiplet 方案大概率會(huì)采用先進(jìn)封裝,推動(dòng)先進(jìn)封裝 發(fā)展。Chiplet 具有成本低、周期短、良率高等優(yōu)點(diǎn),其核心是實(shí)現(xiàn)芯片間的高速互聯(lián), 且兼顧多種芯片互聯(lián)后的重新布線,為實(shí)現(xiàn)既定性能,對(duì) Chiplet 之間的布線密度、信 號(hào)傳輸質(zhì)量提出較高要求,封裝加工精度與難度進(jìn)一步加大,并且要考慮散熱和功率分配等問題。因此,Chiplet 技術(shù)因此需要高密度、大帶寬的先進(jìn)封裝技術(shù)提供硬件支持, 大概率采用先進(jìn)封裝方案,如 SiP(系統(tǒng)級(jí)封裝技術(shù))、RDL(晶圓重布線技術(shù))、Bumping (晶圓凸點(diǎn)工藝)、Fan-in/out(扇入/扇出式封裝)等。
Chiplet 提升半導(dǎo)體測試需求,利好下游封測廠商、半導(dǎo)體獨(dú)立測試廠商和測試設(shè)備供 應(yīng)商。Chiplet 通過將多個(gè)裸芯(die)進(jìn)行堆疊合封的先進(jìn)封裝,通常使用較為復(fù)雜的 芯片。由于在 Chiplet 中封裝了多個(gè) die,為確保正常運(yùn)行,需要對(duì) Chiplet 進(jìn)行全檢, 以確保每一個(gè)裸芯片都能正常工作,此外需通過邊界掃描(Boundary Scan)測試,才能 確保多個(gè)裸芯(die)互聯(lián)的可靠性。
中芯國際在其 2020 年的技術(shù)發(fā)展性報(bào)告中說道:以 Chiplet 技術(shù)生產(chǎn)芯片的可測試性是一個(gè)挑戰(zhàn),特別是一旦這些小系統(tǒng)被封裝在一起, 只有數(shù)量較少的測試引線可以延伸到封裝外;因此,測試必須分階段進(jìn)行,先測試單個(gè) 的芯片,然后測試封裝后的完整系統(tǒng)。由此可見,Chiplet 既要對(duì)每一個(gè)裸芯片進(jìn)行測 試,也要對(duì)裸芯片下的互聯(lián)進(jìn)行測試,因此會(huì)增大對(duì)半導(dǎo)體封測、半導(dǎo)體封測設(shè)備的需 求。并對(duì)測試設(shè)備的數(shù)量和性能都提出更高要求,利好封測企業(yè)、半導(dǎo)體獨(dú)立測試廠商與半導(dǎo)體測試設(shè)備供應(yīng)商。
全球、國內(nèi)大廠積極布局 Chiplet 先進(jìn)封裝,共同推動(dòng)封測產(chǎn)業(yè)發(fā)展。Chiplet 優(yōu)勢顯 著,提高對(duì)先進(jìn)封裝與測試需求,國內(nèi)及全球 OSAT 廠、晶圓代工大廠積極布局支持 Chiplet 方案的先進(jìn)封裝,目前已取得初步成果。國內(nèi)方面,長電科技 XDFOI 平臺(tái)以 2.5D 無 TSV 為基本技術(shù)平臺(tái),并于 2023 年 1 月宣布,XDFOI Chiplet 高密度度多維異構(gòu)集成 系列工藝已按計(jì)劃進(jìn)入穩(wěn)定量產(chǎn)階段,基于利用有機(jī)重布線堆疊中介層可實(shí)現(xiàn) 2D/2.5D/3D 集成,并已實(shí)現(xiàn)國際客戶 4nm 多芯片系統(tǒng)集成封裝產(chǎn)品出貨;
通富微電與 AMD 合作緊密,利用次微米級(jí)硅中介層以 TSV 將多芯片整合于單一封裝,已實(shí)現(xiàn) 7nm 量 產(chǎn),5nm 有望于 22H2 實(shí)現(xiàn)小規(guī)模試產(chǎn);華天科技于 3 月 28 日晚間公告,公司全資子公 司華天江蘇擬投資 28.58 億元,進(jìn)行“高密度高可靠性先進(jìn)封測研發(fā)及產(chǎn)業(yè)化”項(xiàng)目的 建設(shè)。項(xiàng)目建成投產(chǎn)后形成 Bumping84 萬片、WLCSP48 萬片、超高密度扇出 UHDFO 2.6 萬片的晶圓級(jí)集成電路年封測能力。

資料來源:觀研天下,東莞證券研究所
2.2、IC載板是先進(jìn)封裝的關(guān)鍵材料,國產(chǎn)替代前景廣闊
IC 載板是先進(jìn)封裝的關(guān)鍵材料,下游應(yīng)用廣泛。IC 封裝基板(IC Package Substrate, 又稱 IC 載板)是先進(jìn)封裝所采用的一種關(guān)鍵專用基礎(chǔ)材料,它用于建立 IC 與 PCB 之間 的信號(hào)連接,此外還起到保護(hù)、支撐、散熱以及形成標(biāo)準(zhǔn)化的安裝尺寸的作用。IC 載板 作為一種高端 PCB 板,具有高密度、高精度、小型化和輕薄化的特點(diǎn),廣泛應(yīng)用于移動(dòng) 終端、通信設(shè)備、服務(wù)/儲(chǔ)存等下游應(yīng)用領(lǐng)域。
價(jià)值占比:IC 載板為半導(dǎo)體封裝中價(jià)值量占比最大的耗材。半導(dǎo)體封裝中所用耗材種類 較多,包括封裝基板、引線框架、鍵合線、封裝樹脂、陶瓷封裝和芯片粘接等,其中封 裝基板占比最高,價(jià)價(jià)值占比接近一半,連接線/鍵合線、引線框架、封裝樹脂和其他 材料占比分別為 46%、13%、10%和 15%。IC 載板行業(yè)壁壘高于普通 PCB 產(chǎn)品。
IC 載板具有高精度、高密度、高性能、小型化及輕薄化等特點(diǎn),在各種技術(shù)參數(shù)上要求較高,尤其是最核心的線寬/線距參數(shù)要遠(yuǎn)小于 其他種類 PCB 產(chǎn)品,因此具有較高的技術(shù)門檻;資金投入方面,相較其他 PCB 品類,IC 載板產(chǎn)線在投產(chǎn)前研發(fā)投入巨大且用時(shí)良久,在產(chǎn)線建設(shè)、后續(xù)運(yùn)營等方面也需要巨大 資金持續(xù)投入,尤其是需要巨額的設(shè)備采購支出;客戶壁壘方面,IC 載板客戶認(rèn)證體系 較普通 PCB 產(chǎn)品更嚴(yán)格,業(yè)內(nèi)通常采用合格供應(yīng)商認(rèn)證制度,認(rèn)證過程復(fù)雜且周期較長, 由此可見,相比其他 PCB 品類,IC 載板具有更高的技術(shù)門檻、資金壁壘和客戶認(rèn)證壁壘。
ABF/BT 載板原材料被海外企業(yè)壟斷,原料供應(yīng)瓶頸制約行業(yè)產(chǎn)能擴(kuò)張。按照封裝材料不 同,IC 載板可分為硬質(zhì)基板、柔性基板和 IC 載板,硬質(zhì)基板又可進(jìn)一步分為 BT、ABF 和 MIS 載板。目前 ABF 載板與 BT 載板生產(chǎn)所需的重要原材料——ABF/BT 有機(jī)樹脂被日 本頭部企業(yè)壟斷,原材料供給較為緊缺。主要原材料的供應(yīng)短板也制約了行業(yè)產(chǎn)能擴(kuò)張, 預(yù)計(jì)行業(yè)供不應(yīng)求局面有望持續(xù)較長時(shí)間。

資料來源:Omdia,東莞證券研究所
行業(yè)競爭格局:日、韓、臺(tái)份額絕對(duì)領(lǐng)先,大陸企業(yè)占比較低。從 IC 載板發(fā)展過程看, 行業(yè)基本遵循“日本-韓國-中國臺(tái)灣-中國大陸”的產(chǎn)業(yè)轉(zhuǎn)移路徑。目前全球 IC 載板產(chǎn) 能集中在東亞地區(qū),但由于我國在該領(lǐng)域起步較晚,目前日、韓、臺(tái)企業(yè)仍占據(jù)行業(yè)主 導(dǎo)地位,在技術(shù)儲(chǔ)備、產(chǎn)能規(guī)模、收入與利潤等方面全方位領(lǐng)先大陸廠商。
據(jù) Prismark 統(tǒng)計(jì),全球 IC 載板前三大企業(yè)分別為臺(tái)灣欣興電子、日本揖斐電和韓國三星電機(jī),行 業(yè)市場份額高度集中,前十大廠商份額占比超過 80%。雖然大陸企業(yè)起步時(shí)間晚,且面 臨較高的行業(yè)壁壘,但受益于本土巨大的市場空間、產(chǎn)業(yè)配套和成本優(yōu)勢,疊加近年來 全球半導(dǎo)體封測產(chǎn)業(yè)逐漸向中國大陸轉(zhuǎn)移,有望直接拉動(dòng)封裝材料需求。日益旺盛的下 游需求和稀缺的產(chǎn)能供給之間已形成較大缺口,本土以興森、深南為代表去企業(yè)積推動(dòng) 封裝基板擴(kuò)產(chǎn),以滿足下游客戶需求。
先進(jìn)封裝拉動(dòng) IC 載板需求增長。IC 載板在高端封裝領(lǐng)域已取代傳統(tǒng)引線框架,成為封 裝過程中的必備材料。先進(jìn)封裝增加 IC 載板的層數(shù),有效拉動(dòng)行業(yè)增長,而 Chiplet 封裝技術(shù)也大大增加了 ABF 載板的需求面積,帶動(dòng) ABF 載板需求提升。據(jù) Prismark 統(tǒng) 計(jì),,2021 年全球 IC 封裝基板行業(yè)規(guī)模達(dá)到 142 億美元,同比增長近 40%,預(yù)計(jì) 2026 年將達(dá)到 214 億美元(約 1474 億元),2021-2026 年 IC 載板 CAGR 為 8.6%。國內(nèi)方面, 預(yù)計(jì) 2025 年國內(nèi) IC 載板市場規(guī)模將達(dá)到 412.4 億元,占全球比重接近 30%。
2.3、Chiplet采用新型的IP復(fù)用模式,為半導(dǎo)體IP發(fā)展提供新機(jī)遇
半導(dǎo)體 IP 指預(yù)先設(shè)計(jì)好的功能模塊。半導(dǎo)體 IP 是指集成電路設(shè)計(jì)中預(yù)先設(shè)計(jì)、驗(yàn)證好 的功能模塊,它位于 IC 設(shè)計(jì)上游,提供 SoC 所需的核心功能模塊。在芯片設(shè)計(jì)的過程 中,通過結(jié)合使用 EDA 軟件和半導(dǎo)體 IP,能有效縮短的設(shè)計(jì)周期,降低開發(fā)成本。目前 大部分芯片廠商采用外購+自主設(shè)計(jì)部分 IP 相結(jié)合的生產(chǎn)模式,并結(jié)合外購 EDA 工具進(jìn) 行獨(dú)立芯片設(shè)計(jì),因此 fabless 企業(yè)與 IDM 企業(yè)為半導(dǎo)體 IP 廠商的主要下游客戶。
半導(dǎo)體 IP 在 IC 設(shè)計(jì)中起到不可或缺的作用。半導(dǎo)體 IP 具有性能高、功耗優(yōu)、成本適 中、技術(shù)密集度高、知識(shí)產(chǎn)權(quán)集中、商業(yè)價(jià)值昂貴等特征,是集成電路設(shè)計(jì)產(chǎn)業(yè)的核心 產(chǎn)業(yè)要素和競爭力體現(xiàn)。隨著芯片種類愈加豐富與先進(jìn)制程不斷推進(jìn),集成電路的設(shè)計(jì) 流程愈發(fā)復(fù)雜,導(dǎo)致研發(fā)費(fèi)用加大,半導(dǎo)體 IP 為簡化 IC 設(shè)計(jì)流程提供便利,配合先進(jìn) 的 EDA 工具,IC 設(shè)計(jì)借助半導(dǎo)體 IP 實(shí)現(xiàn)了極大的便利。

資料來源:IBS,芯原股份招股說明書,東莞證券研究所
Chiplet 開啟新型 IP 復(fù)用模式,為半導(dǎo)體 IP 發(fā)展提供機(jī)遇。Chiplet 采取搭積木的方 式,通過 3D 集成等先進(jìn)集成技術(shù)將特定功能的芯片裸片集成在一起,從而形成一個(gè)系 統(tǒng)芯片。Chiplet 開啟了 IP 復(fù)用新模式,即硅片級(jí)別的 IP 復(fù)用;不同功能的 IP,如 CPU、 存儲(chǔ)器、模擬接口等,可靈活選擇不同的工藝分別進(jìn)行生產(chǎn),從而可以靈活平衡計(jì)算性 能與成本,實(shí)現(xiàn)功能模塊的最優(yōu)配置而不必受限于晶圓廠工藝;Chiplet 的發(fā)展演進(jìn), 為 IP 供應(yīng)商,尤其是具有芯片設(shè)計(jì)能力的 IP 供應(yīng)商,拓展了商業(yè)靈活性和發(fā)展空間。目前 chiplet 已有少量商業(yè)應(yīng)用,并吸引英特爾和 AMD 等國際芯片廠商投入相關(guān)研發(fā), 在當(dāng)前 SOC 早于工藝節(jié)點(diǎn)和成本瓶頸的情況下有望發(fā)展成為一種新的芯片生態(tài)。
單個(gè)芯片可集成 IP 數(shù)量增加,半導(dǎo)體 IP 市場有望實(shí)現(xiàn)快速增長。隨著先進(jìn)制程的演進(jìn), 線寬的縮小使得芯片中晶體管數(shù)量大幅提升,使得單顆芯片中可集成的 IP 數(shù)量也大幅 增加。以 28nm 工藝節(jié)點(diǎn)為例,單顆芯片中已可集成的 IP 數(shù)量為 87 個(gè),當(dāng)工藝節(jié)點(diǎn)演 進(jìn)至 7nm 時(shí),可集成的 IP 數(shù)量達(dá)到 178 個(gè)。單顆芯片可集成 IP 數(shù)量增多為更多 IP 在 SoC 中實(shí)現(xiàn)可復(fù)用提供新的空間,從而推動(dòng)半導(dǎo)體 IP 市場進(jìn)一步發(fā)展。據(jù) IBS 數(shù)據(jù)顯示, 導(dǎo)體 IP 市場將從 2018 年的 46 億美元增長至 2027 年的 101 億美元,年均復(fù)合增長率為 9.13%。其中處理器 IP 市場預(yù)計(jì)在 2027 年達(dá)到 62.55 億美元,2018 年為 26.20 億美元, 年均復(fù)合增長率為 10.15%;數(shù)模混合 IP 市場預(yù)計(jì)在 2027 年達(dá)到 13.32 億美元,2018 年為 7.25 億美元,年均復(fù)合增長率為 6.99%;射頻 IP 市場預(yù)計(jì)在 2027 年達(dá)到 11.24 億美元,2018 年為 5.42 億美元,年均復(fù)合增長率為 8.44%。
芯原股份為國內(nèi)半導(dǎo)體 IP 佼佼者,助力 Chiplet 技術(shù)發(fā)展。芯原股份為國內(nèi)半導(dǎo)體 IP 龍企業(yè),主營業(yè)務(wù)包括一站式芯片定制服務(wù)與半導(dǎo)體 IP 授權(quán)服務(wù),已向市場推出多款 一站式芯片定制方案,致力于打造芯片一體化設(shè)計(jì)平臺(tái)。公司在 IP 技術(shù)儲(chǔ)備深厚,已 加入 UCle 聯(lián)盟并推出高端應(yīng)用處理器平臺(tái),積極推動(dòng) Chiplet 相關(guān)技術(shù)發(fā)展,加快 Chiplet 產(chǎn)業(yè)化落地。。2022 年,公司實(shí)現(xiàn)營收 26.79 億元,同比增長 25.23%,實(shí)現(xiàn)歸 母凈利潤 7,381.48 萬元,同比增長 455.31%。在全球半導(dǎo)體景氣下行的大背景下,得益 于公司無產(chǎn)品庫存風(fēng)險(xiǎn)、無應(yīng)用領(lǐng)域邊界的獨(dú)特商業(yè)模式,以及逆產(chǎn)業(yè)周期的屬性,報(bào) 告期內(nèi)公司業(yè)務(wù)實(shí)現(xiàn)快速發(fā)展,行業(yè)地位和市場競爭力不斷提升。
審核編輯 :李倩
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28509瀏覽量
231793 -
封裝
+關(guān)注
關(guān)注
128文章
8447瀏覽量
144699 -
chiplet
+關(guān)注
關(guān)注
6文章
451瀏覽量
12853
原文標(biāo)題:2、Chiplet技術(shù)持續(xù)推進(jìn),先進(jìn)封裝、IC載板、半導(dǎo)體IP等多環(huán)節(jié)受益
文章出處:【微信號(hào):CADCAM_beijing,微信公眾號(hào):智能制造IMS】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評(píng)論請先 登錄
摩爾線程與AI算力平臺(tái)AutoDL達(dá)成深度合作
大算力芯片的生態(tài)突圍與算力革命
AI算力:智能時(shí)代的核心驅(qū)動(dòng)力


對(duì)話郝沁汾:牽頭制定中國與IEEE Chiplet技術(shù)標(biāo)準(zhǔn),終極目標(biāo)“讓天下沒有難設(shè)計(jì)的芯片”

Chiplet在先進(jìn)封裝中的重要性

后摩爾定律時(shí)代,提升集成芯片系統(tǒng)化能力的有效途徑有哪些?
GPU算力開發(fā)平臺(tái)是什么
UCIe規(guī)范引領(lǐng)Chiplet技術(shù)革新,新思科技發(fā)布40G UCIe IP解決方案
AI網(wǎng)絡(luò)物理層底座: 大算力芯片先進(jìn)封裝技術(shù)
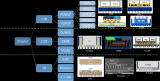
高集成度雙通道差分式電容型傳感芯片-MC11
高算力AI芯片主張“超越摩爾”,Chiplet與先進(jìn)封裝技術(shù)迎百家爭鳴時(shí)代






 Chiplet為后摩爾時(shí)代提升芯片算力與集成度的重要途徑
Chiplet為后摩爾時(shí)代提升芯片算力與集成度的重要途徑











評(píng)論