失效分析。失效分析的工作程序通常分為明確要求,調(diào)查研究,分析失效機(jī)制和提出
發(fā)表于 11-29 16:39
原因,根據(jù)失效分析結(jié)論提出相應(yīng)對(duì)策,它包括器件生產(chǎn)工藝,設(shè)計(jì),材料,使用和管理等方面的有關(guān)改進(jìn),以便消除失效分析報(bào)告中所涉及到的
發(fā)表于 11-29 17:13
SMT制程不良原因及改善對(duì)策
發(fā)表于 08-11 09:58
本文基于LED發(fā)光二極管的工作原理、制程,找出了LED單燈失效的幾種常見原因,并闡述了在材料、生產(chǎn)過程、應(yīng)用等環(huán)節(jié)如何預(yù)防和改善的對(duì)策
發(fā)表于 12-12 16:04
結(jié)論,改善建議”。其中,第①步主要是了解不良PCB板的失效內(nèi)容、工藝流程、結(jié)構(gòu)設(shè)計(jì)、生產(chǎn)狀況、使用狀況、儲(chǔ)存狀況等信息,為后續(xù)分析過程展開作準(zhǔn)備;第②步是根據(jù)失效信息,確定
發(fā)表于 03-10 10:42
判斷失效的模式, 查找失效原因和機(jī)理, 提出預(yù)防再失效的對(duì)策的技術(shù)活動(dòng)和管理活動(dòng)稱為失效分析。
發(fā)表于 03-15 14:21
?121次下載

對(duì) PCBA 上的 CPU 與 ?Flash 器件焊接質(zhì)量進(jìn)行分析。 圖 ?1 ?BGA焊接樣品的外觀照片 二 ?分析過程 2.1 外觀檢查 用立體顯微鏡對(duì)空白PCB 和BGA 器件進(jìn)
發(fā)表于 11-06 09:51
?2348次閱讀
就深圳宏力捷的經(jīng)驗(yàn)來(lái)看,BGA錫球裂開的問題其實(shí)很難僅靠工廠的制程管理與加強(qiáng)焊錫來(lái)得到全面改善,如果產(chǎn)品設(shè)計(jì)時(shí)RD可以多出一點(diǎn)力氣,制造上就會(huì)省下很多的成本。
![的頭像]() 發(fā)表于
發(fā)表于 11-28 15:37
?2162次閱讀
smt貼片中錫珠的改善方法及對(duì)策分析?需要挑選合適產(chǎn)品工藝要求的錫膏。以下幾點(diǎn):
![的頭像]() 發(fā)表于
發(fā)表于 02-11 09:38
?1435次閱讀
本文通過對(duì)BGA器件側(cè)掉焊盤問題進(jìn)行詳細(xì)的分析,發(fā)現(xiàn)在BGA應(yīng)用中存在的掉焊盤問題,并結(jié)合此次新發(fā)現(xiàn)的問題,對(duì)失效現(xiàn)象進(jìn)行詳細(xì)的分析和研究,
![的頭像]() 發(fā)表于
發(fā)表于 06-08 12:37
?2465次閱讀

BGA失效分析與改善對(duì)策
![的頭像]() 發(fā)表于
發(fā)表于 06-26 10:47
?1096次閱讀

本文涵蓋HIP失效分析、HIP解決對(duì)策及實(shí)戰(zhàn)案例。希望您在閱讀本文后有所收獲,歡迎在評(píng)論區(qū)發(fā)表您的想法。
![的頭像]() 發(fā)表于
發(fā)表于 10-16 15:06
?908次閱讀

介紹LGA器件焊接失效分析及對(duì)策
![的頭像]() 發(fā)表于
發(fā)表于 11-15 09:22
?2296次閱讀
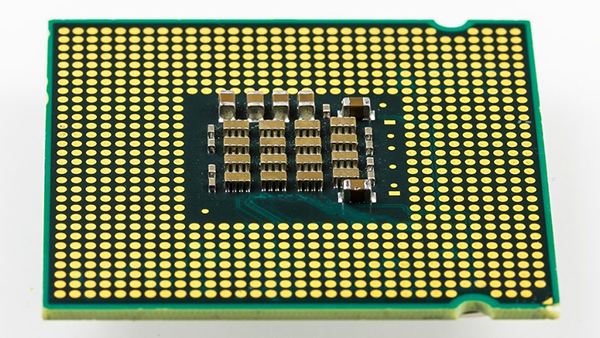
BGA(Ball Grid Array)是一種高密度的表面貼裝封裝技術(shù),它將芯片的引腳用焊球代替,并以網(wǎng)格狀排列在芯片的底部,通過回流焊與印刷電路板(PCB)上的焊盤連接。然而,BGA也存在一些可靠性問題,其中最常見的就是焊點(diǎn)失效
![的頭像]() 發(fā)表于
發(fā)表于 12-27 09:10
?1791次閱讀
BGA焊點(diǎn)不良可能由多種因素引起,包括設(shè)計(jì)、材料、工藝和設(shè)備等方面。以下是一些建議,以改善BGA焊點(diǎn)不良的問題。
發(fā)表于 04-01 10:14
?1697次閱讀







































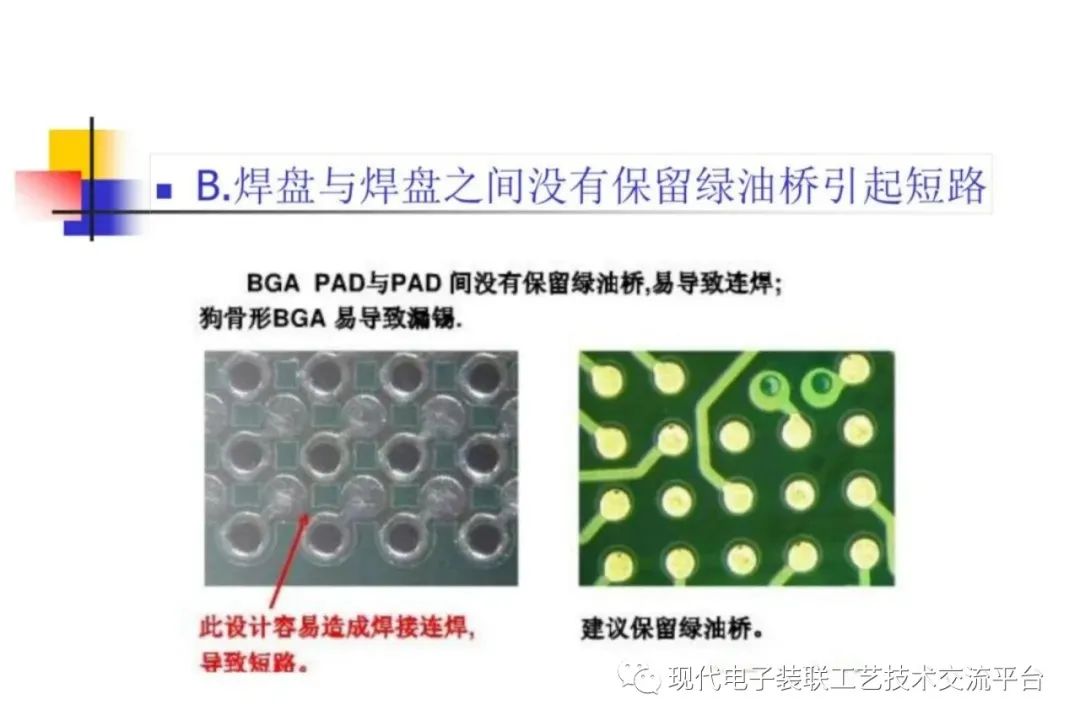



















 BGA失效分析與改善對(duì)策
BGA失效分析與改善對(duì)策

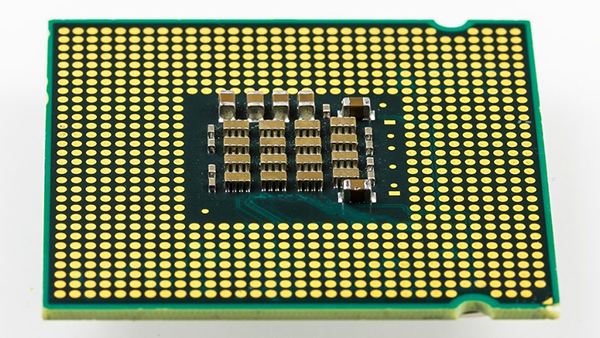










評(píng)論