等離子體中的離子可以利用等離子體的自偏壓特性和外加偏壓組合,將離子轟擊晶圓片表面的能量范圍控制在數電子伏 (eV)至數萬電子伏,從而可以部分替代傳統的離于注入。等離子體摻雜的最大優點是,可以高效地實現超低能量的搭雜,這是因為其工藝過程是在“面”上處理的,而傳統的離子注人是在“點”上處理的。對于那些對離子成分和轟擊能量純度要求不高的IC 產品的生產制造,這種工藝非常適合。 等離子體浸沒離子注入(Plasme ImmersionlonImplantation,PIII) 或等離子體摻雜 (Plasma Doping, PIAD)系統已經被廣泛地開發、應用于需要低能量或高劑量的IC 產品規模生產中(如超淺結和深溝槽應用)。
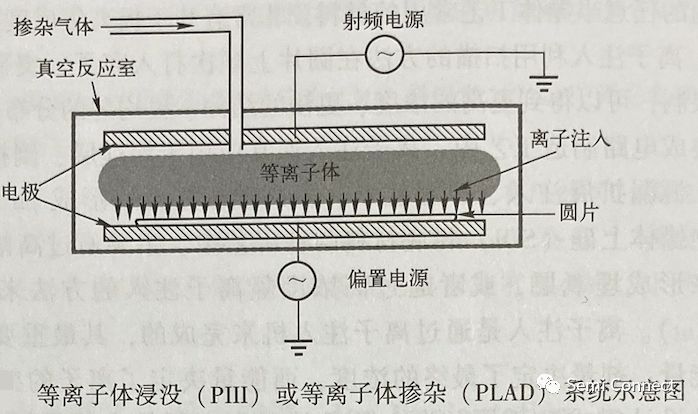
通常,用射頻電源產生高濃度等離子體電離摻雜氣體,而用偏置電源加速離子去“轟擊”圓片表面。最常用的 PLAD 摻雜氣體為 B2H6,用于硼摻雜。對于需要非常高劑量的圓片摻雜的產品,由于離子注入機需要“點”式掃描注入,即使在最高的離子束流下,工藝實施時間仍然較長,產出效率低。而等離子體摻雜則采用等離子體的“面”轟擊來替代離子束的 “點”掃描,因此可以大幅度提升產出效率。但是,PLAD 不能選擇離子種類,也不能精確控制離子的流量或劑量,因此 PLAD 的主要應用范圍是高劑量、非關鍵層離子注入。目前,PLAD廣泛應用于 DRAM 芯片的多晶硅補償摻雜,以及 DRAM 器件陣列的接觸注入。 在等離子體浸沒系統中,摻雜離子將轟擊圓片,并被注入襯底。摻雜離子流通量主要受外加RF或微波的功率控制,離子的能量主要由偏壓的射頻功率決定。通過磁鐵的電流可以調整磁場的位型,由于低氣壓下磁化的等離子體受到磁場的約束,因此可以通過磁場來控制摻雜離子流的均勻性。等離子體浸沒注入技術是一種低能量過程,離子能量一般小于1keV,所以對于亞0.1um 器件的應用,PIII可以用于形成超淺結。與傳統離子注入技術相比,等離子體浸沒系統的缺點是無法選擇特殊的離子種類,并且由于離子流量受等離子體位置和反應室壓力的影響,離子能量分布范圍不如傳統離子注入那樣單純,容易形成能量污染。所以,等離子體浸沒注入系統很難精確控制摻雜物的濃度和結深。
審核編輯 :李倩
-
射頻
+關注
關注
106文章
5757瀏覽量
170390 -
等離子體
+關注
關注
0文章
130瀏覽量
14622 -
晶圓
+關注
關注
53文章
5160瀏覽量
129763
原文標題:等離子體摻雜(Plasma Doping)
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
安泰高壓放大器在等離子體發生裝置研究中的應用

等離子體的一些基礎知識

OptiFDTD應用:納米盤型諧振腔等離子體波導濾波器
等離子的基本屬性_等離子體如何發生
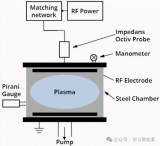
等離子體發射器的工作原理
等離子體技術在航天中的作用
等離子體電導率的影響因素
等離子體的定義和特征
等離子體在醫療領域的應用
等離子體清洗的原理與方法
Plasma等離子清洗技術介紹

為什么干法刻蝕又叫低溫等離子體刻蝕






 等離子體摻雜(Plasma Doping)
等離子體摻雜(Plasma Doping)












評論