三國演義第一回就開宗明義地說明:「話說天下大勢,分久必合,合久必分。」這句話用來形容IC芯片也是非常的貼切。
IC芯片由早期單一功能芯片,演進到多功能的多晶粒封裝(multi-chip module;MCM),到系統單晶片(system on a chip;SoC)、系統級封裝(system in a package;SiP),以至于到最近俗稱的小芯片(chiplet)。這些分分合合一路走來,與半導體制程及封裝測試技術,乃至于系統端的應用都有著密不可分的關系。
最早期的系統應用,都是將各式不同功能的IC,以印刷電路板的方式整合在一起。但隨這系統端所需操作的頻率愈來愈高,以及縮小尺寸的要求,將幾顆核心的IC整合在同一個封裝內,以縮短彼此間的傳輸距離,成為一個趨勢,多顆晶粒的封裝技術(MCM)應運而生。此外SiP、異質整合,乃至于3DIC,都是更為先進的封裝方式,技術上包括了芯片的堆棧。總之若芯片設計或晶圓制程上,無法滿足系統端的需求,就會尋求在封裝上提供解決的方案。所以芯片設計、晶圓制作以及封測是三足鼎立,而彼此間隨著時間及技術演進互有消長。
裸晶良品(known good die;KGD)在多芯片的封裝上是個很大的挑戰,通常一顆芯片都得經過封裝后,才能做完整的測試再出貨。但是在多顆裸晶共同封裝在一個模塊上,若無法確定每一個裸晶都是良品的話,勢必會造成良率上的重大損失。為了確保每顆裸晶都是良品,業者大力開發了晶圓上的測試技術(chip probe),這包括了復雜的探針卡(probe card),以及測試設備,而這些產品也形成了整體產業鏈的重要環節。
隨著晶圓制程技術愈來愈成熟與進步,晶圓廠已經可以在同一套制程中,提供不同工作電壓或崩潰電壓的晶體管。同時扮演重要角色的嵌入式存儲器,如快閃存儲器(Flash)、EEPROM、OTM(one time memory),也都能逐一實現在同一片晶圓中。至此結合了邏輯運算、類比電路、存儲器,甚至于高壓電源管理,系統單晶片的架構終于整合且可具體實現。
蘋果的M1芯片可以說是目前系統單晶片的極致,整合了Arm架構的CPU、GPU、AI神經網絡的加速引擎,以及連結這些單元的fabric總線界面。比起x86的架構,M1芯片具備了高效能、低功耗及高集成度的優勢,M1 Max一顆芯片內含了570億個晶體管,是目前個人計算機芯片的翹楚。
系統單晶片的另一個極致就是NVIDIA的GPU,NVIDIA最新一代的Hopper GPU,內涵800億個晶體管,1.5萬個核心,使用臺積4奈米的制程,而每一顆芯片的長寬邊長將近3公分。這顆巨無霸的芯片,直接挑戰的就是晶圓廠的良率,以及后續的封裝測試,而每一片12吋晶圓能有效使用的面積也會受到影響。假設系統上對于高效能運算(HPC)芯片的需求持續增加,在單一芯片的面積無法再增加的情況下,就得開始做適度的切割,這也是小芯片被提出的原因。
值得一提的是,NVIDIA GPU的命名一直使用著名科學家的姓氏,如之前的安培、伏特、巴斯卡等。此次的Hopper是美國著名的女性計算機專家,官拜海軍少將,而她的名字Grace也被命名為NVIDIA第一顆即將商品化的 CPU。
小芯片的提出,除了舒緩芯片面積持續增加的挑戰外,另外也可將單晶片內不同功能的區塊加以分割,以不同的制程條件來實現。比如說芯片的核心以5奈米來實現,而其I/O或主管控制匯流部分,就可以用較成熟的制程來實現,以進一步優化成本。因此在多個小芯片間的傳輸通訊協議就很重要,這也是小芯片聯盟所提出的界面標準UCIe(Universal chiplet interconnect express)。事實上這就是異質整合的具體實現,換言之也就是SoC的進階版system on integrated chips(SoIC)。
在這一股芯片分合的大勢下,有家新創的芯片設計公司卻反其道而行,將整個12吋晶圓制作成單一高速運算的芯片,芯片的邊長超過20公分,內含了1.2兆個晶體管。其所持的理由是,未來芯片在傳輸一個位元所損失的能量,會大于去運算一個位元所需的能量,而這種設計并可以增加操作的頻率。此種做法是否會引領風潮,且拭目以待。
十多年前喧騰一時,但卻胎死腹中的18吋晶圓計劃,最近又被有心人士提出,以應付愈來愈龐大的單一芯片。看來半導體的研發人員,一直在挑戰問題以及提出解決問題的方案,也就不斷地在分分合合的道路上邁步向前。
-
晶圓
+關注
關注
52文章
5113瀏覽量
129143 -
IC芯片
+關注
關注
8文章
254瀏覽量
26905
發布評論請先 登錄
Arm預測2025年芯片設計發展趨勢
聚焦集成電路IC:掀起電子浪潮的 “芯片風暴”

圖像傳感器芯片的發展趨勢是什么?
IC芯片檢測新紀元:X-RAY設備的五大創新優勢

ADC芯片:國產芯片發展的新趨勢
IC燒錄員-芯片價值的饋贈者






 IC芯片的趨勢
IC芯片的趨勢


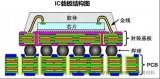












評論