在日前舉辦的2017年Q4法說會(huì)上,臺(tái)積電透露,其極紫外光光刻機(jī)(extreme ultraviolet lithography: ,簡(jiǎn)稱EUV光刻機(jī))產(chǎn)能已經(jīng)取得了較大的進(jìn)步,目前已經(jīng)將其電源功率提高到160W,助力7nm和5nm制造,而250瓦EUV也已經(jīng)安裝到位。
EUV光刻機(jī)的唯一供應(yīng)商ASML在2017年度Semicon West半導(dǎo)體設(shè)備展上也表示,250瓦的EUV光源也萬事俱備。公司2017年財(cái)報(bào)中也強(qiáng)調(diào),其EUV光刻機(jī)滿足了125WPH(每小時(shí)生產(chǎn)125片晶圓)的性能規(guī)格。那就意味著最初計(jì)劃在2004年推出的EUV光刻機(jī),在延誤了十三年之后,終于準(zhǔn)備好了。
EUV光刻機(jī)被譽(yù)為救世主,關(guān)鍵問題已解決
過去幾十年,半導(dǎo)體產(chǎn)業(yè)在摩爾定律的指導(dǎo)下獲得了高速的發(fā)展,為了滿足摩爾定律“同等面積芯片集成的晶體管數(shù)每18個(gè)月翻一番”的要求,晶圓廠一直在推動(dòng)工藝制程的更新。但隨著節(jié)點(diǎn)的演進(jìn),產(chǎn)業(yè)界普遍認(rèn)為傳統(tǒng)的光刻將會(huì)在65nm或者45nm的時(shí)候遭受到障礙,為此他們尋找新的解決辦法,EUV就是他們的主要選擇。

所謂EUV,是指波長(zhǎng)為13.5nm的光。相比于現(xiàn)在主流光刻機(jī)用的193nm光源,新的EUV光源能給硅片刻下更小的溝道,從而能實(shí)現(xiàn)在芯片上集成更多的晶體管,進(jìn)而提高芯片性能,繼續(xù)延續(xù)摩爾定律。不過在之前推進(jìn)EUV光刻機(jī)的過程中,碰到各種各種各樣的問題,EUV光刻機(jī)商用的時(shí)間也一拖再拖,業(yè)界在EUV的研發(fā)投入保守估計(jì)也超過了200億美金,發(fā)光源功率是造成EUV光刻機(jī)遲遲不能商用的最主要原因。
在EUV光刻機(jī)工作過程中,需要電源將等離子體轉(zhuǎn)換成13.5nm波長(zhǎng)的光線,之后再經(jīng)過鏡子的幾重反射,再打落到晶圓上。但是之前的電源并不能給EUV提供足夠的功率,進(jìn)而滿足經(jīng)濟(jì)可行性。這就首先要了解對(duì)EUV光刻機(jī)的要求:
簡(jiǎn)單來說,引入EUV光刻機(jī)的工作目標(biāo),就是把原來傳統(tǒng)光刻的雙層pattering簡(jiǎn)化成一層EUV完成,進(jìn)而降低光罩的層數(shù),降低生產(chǎn)復(fù)雜度。而為了達(dá)到現(xiàn)有的傳統(tǒng)光刻機(jī)250到270WPH的生產(chǎn)效率,那么來到EUV光刻機(jī),那么至少需要125WPH的效率,才能達(dá)到COO(cost of ownership)和OEE(overall equipment efficiency),這就對(duì)光源提出250瓦的要求。但知道2012年,EUV光刻機(jī)的唯一供應(yīng)商ASML只是實(shí)現(xiàn)了25瓦的光源。
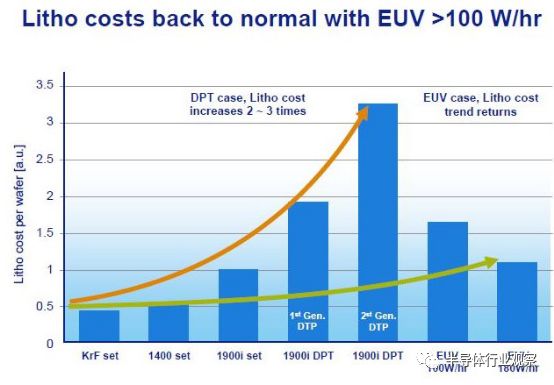
為了加速光源的發(fā)展,他們?cè)?012年斥資25億美元收購(gòu)了世界領(lǐng)先的準(zhǔn)分子激光源提供商Cymer。從全球領(lǐng)先的專利查詢平臺(tái)智慧芽上了解到, Cymer是一家專注于激光、X射線及深紫外光源的企業(yè)。收購(gòu)Cymer,讓ASML直接從源頭上獲得了其發(fā)展中至關(guān)重要的光刻機(jī)光源技術(shù)。進(jìn)而加速了EUV光刻機(jī)的發(fā)展。

據(jù)介紹,Cymer 使用了一種叫做“激光等離子體”的方法,這種方法是在一個(gè)真空腔體中,用源自金屬切割技術(shù)的放大器,產(chǎn)生強(qiáng)大的二氧化碳激光,通過腔體,照射一束每秒被發(fā)射出5萬滴的超純錫液滴。當(dāng)激光脈沖照射到錫液滴時(shí),液滴會(huì)被加熱成等離子體并產(chǎn)生EUV射線。接著,一個(gè)反射鏡收集器將該過程產(chǎn)生的光線反射到光刻機(jī)中。
在這個(gè)方法的基礎(chǔ)上,ASML和Cymer持續(xù)改進(jìn),并在2016年達(dá)到200瓦的功率,到2017年下半年,終于實(shí)現(xiàn)了250瓦的光源和125WPH的效率,那就意味著EUV光刻機(jī)的商用指日可待。
三星、臺(tái)積電、英特爾和格芯的爭(zhēng)奪戰(zhàn)打響
隨著HPC和智能手機(jī)的發(fā)展,對(duì)芯片性能的要求越來越高,設(shè)計(jì)廠商對(duì)先進(jìn)工藝的需求也隨之高漲,在臺(tái)積電Q4法說會(huì),臺(tái)積電表示已經(jīng)有了50個(gè)7nm客戶,就是最好的證明。面對(duì)這個(gè)市場(chǎng),正如文章開頭所說,晶圓代工廠們需要將目光投向EUV光刻機(jī)尋求幫助。2017年5月剛從三星集團(tuán)獨(dú)立出來的三星晶圓廠就是當(dāng)中最為激進(jìn)的一個(gè)。
三星方面表示,他們是業(yè)內(nèi)最早宣布將會(huì)使用EUV光刻機(jī)進(jìn)行7nm芯片生產(chǎn)的廠商。按照三星的說法,他們將會(huì)在2018年下半年提供相關(guān)服務(wù);至于TSMC,根據(jù)供應(yīng)鏈相關(guān)人士透露,臺(tái)積電將會(huì)在二季度末開始上馬7nm生產(chǎn),但是第一代7nm將會(huì)使用傳統(tǒng)光刻。臺(tái)積電方面表示,要到2019年的7nm plus才會(huì)引入EUV;格芯也同樣打算在2018年推出7nm工藝,但是和臺(tái)積電一樣,這時(shí)還是用傳統(tǒng)光刻,他們計(jì)劃到2019年才引入EUV。至于IDM巨頭Intel,他們對(duì)其先進(jìn)工藝和EUV的進(jìn)展秘而不談,但是據(jù)公開消息顯示,他們所購(gòu)買的EUV光刻機(jī)比任何其他公司都多。
EUV光刻機(jī)無疑是未來的大勢(shì)所趨。
格芯首席技術(shù)官Gary Patton表示,如果在5nm的時(shí)候沒有使用EUV光刻機(jī),那么光刻的步驟將會(huì)超過100步,這會(huì)讓人瘋狂。所以所EUV光刻機(jī)無疑是未來5nm和3nm芯片的最重要生產(chǎn)工具,未來圍繞EUV光刻機(jī)的爭(zhēng)奪戰(zhàn)將會(huì)變得異常激烈。因?yàn)檫@是決定這些廠商未來在先進(jìn)工藝市場(chǎng)競(jìng)爭(zhēng)的關(guān)鍵。
媒體報(bào)道,臺(tái)積電在2017年初一口氣訂購(gòu)了五臺(tái)EUV光刻機(jī);韓媒BusinessKorea在十月也表示,三星有意購(gòu)買10臺(tái)EUV光刻機(jī)。關(guān)于格芯和Intel光刻機(jī)的具體購(gòu)買數(shù)目沒有看到報(bào)道。但從S和T兩家看來,他們正在大手筆囤貨。但是ASML在EUV光刻機(jī)上面的產(chǎn)能不大,這可能會(huì)加劇了爭(zhēng)奪。
據(jù)ASML的年報(bào)得知,2016年,他們總共才出貨了四臺(tái)EUV光刻機(jī),2017年則交付了10套EUV系統(tǒng)。而從媒體報(bào)道中我們得知,2018年,ASML的EUV光刻機(jī)產(chǎn)量可以達(dá)到24臺(tái),但這些訂單都已經(jīng)被搶購(gòu)一空。但到2019年,ASML會(huì)將其產(chǎn)能提高到40臺(tái),這會(huì)大大緩解EUV光刻機(jī)的供應(yīng)壓力。
更大的挑戰(zhàn)扔在后頭
在基本克服了250W光源這個(gè)難題之后,ASML對(duì)晶圓廠客戶有了一個(gè)基本的交代,但是對(duì)于EUV光刻機(jī)系統(tǒng)來說,仍然有一些問題需要被解決的。
首先就是光罩問題;
據(jù)介紹,EUV所用的光罩和193nm浸沒式光刻的光罩完全不同,它們由使用了數(shù)十種不同材料的納米層組成。根據(jù)數(shù)據(jù)調(diào)查顯示,過去12個(gè)月來,光罩制造商已經(jīng)制作了1041個(gè)EUV光罩,光罩良率目前僅為64.3%。但同期間曝光的主流的光罩?jǐn)?shù)達(dá)到46萬2792個(gè),平均良率高達(dá)94.8%。因此如何提升光罩良率和成本問題,就成為他們考慮的首要問題。
其次EUV薄膜問題也不能忽略;
雖然現(xiàn)在EUV設(shè)備都是處于超潔凈環(huán)境中,但是在制造過程中,灰塵是無可避免地產(chǎn)生的。如果有一點(diǎn)回城掉到光罩上,則會(huì)造成很大的損失。現(xiàn)在主流光罩的薄膜是透明的,能夠經(jīng)受得起考驗(yàn),但是目前的EUV薄膜是不透明的,那就需要超薄型的薄膜去制造透明的EUV薄膜,能夠抵擋EUV光刻機(jī)的震蕩和相關(guān)干擾對(duì)光罩造成的影響。
還有一個(gè)重要的問題是目前沒有很好的方法去檢測(cè)光罩的缺陷;
理想情況下,你可以用EUV光去掃描那些需要修補(bǔ)的點(diǎn)。但這個(gè)被稱為actinic patterned-mask inspection的技術(shù)依然還在研究當(dāng)中,所以所有的芯片制造商目前在光罩檢測(cè)上也只能用權(quán)宜之計(jì):有些廠商使用193nm光刻的那些工具。但是來到7nm,用193nm的方法無異于緣木求魚。因?yàn)榉椒m然相同,但是你總會(huì)錯(cuò)過一些東西。芯片制造商也使用一個(gè)叫做“print check”的技術(shù)去檢查晶圓,但這個(gè)方法在時(shí)間和金錢成本都很高,并不能讓人接受。
對(duì)ASML來說,未來還需要解決一個(gè)光源問題。
目前的250W光源應(yīng)用在7nm甚至5nm都是沒問題的,但到了3nm,對(duì)光源的功率需求將會(huì)達(dá)到500W,到了1nm的時(shí)候,光源功率要求甚至達(dá)到了1KW,這也不會(huì)是一個(gè)容易的問題。
-
放大器
+關(guān)注
關(guān)注
145文章
14095瀏覽量
216195 -
等離子
+關(guān)注
關(guān)注
2文章
237瀏覽量
30518 -
EUV
+關(guān)注
關(guān)注
8文章
609瀏覽量
86880
發(fā)布評(píng)論請(qǐng)先 登錄
EUV光刻機(jī)何以造出5nm芯片?
光刻機(jī)工藝的原理及設(shè)備
魂遷光刻,夢(mèng)繞芯片,中芯國(guó)際終獲ASML大型光刻機(jī) 精選資料分享
EUV光刻機(jī)還能賣給中國(guó)嗎?






 關(guān)于EUV光刻機(jī)的分析介紹
關(guān)于EUV光刻機(jī)的分析介紹










評(píng)論