工程師面臨著對(duì)現(xiàn)代電動(dòng)汽車(chē) (EV) 性能和里程的權(quán)衡。更快的加速和更高的巡航速度需要更頻繁、更耗時(shí)的充電站。另外,更長(zhǎng)里程要求造成了各項(xiàng)進(jìn)展的不確定性。為了增加續(xù)航能力,同時(shí)為駕駛者提供更高的性能,工程師需要設(shè)計(jì)驅(qū)動(dòng)系統(tǒng),確保盡可能多的電池能量轉(zhuǎn)移到驅(qū)動(dòng)輪上。同樣重要的是,需要保持驅(qū)動(dòng)系統(tǒng)足夠小,以適應(yīng)車(chē)輛的限制。這些雙重需求需要高效率和高能量密度的組件。
電動(dòng)汽車(chē)驅(qū)動(dòng)系統(tǒng)的關(guān)鍵部件是三相電壓源逆變器(或稱(chēng)“牽引逆變器”) ,它將電池的直流電壓轉(zhuǎn)換為車(chē)輛電機(jī)所需的交流電。打造一個(gè)高效的牽引逆變器對(duì)于平衡性能和里程至關(guān)重要,而提高效率的關(guān)鍵途徑之一就是適當(dāng)使用寬帶隙(WBG) 、碳化硅 (SiC) 半導(dǎo)體器件。
本文將先介紹電動(dòng)汽車(chē)牽引逆變器的作用;然后解釋用SiC功率金屬氧化物半導(dǎo)體場(chǎng)效應(yīng)晶體管(MOSFET) 設(shè)計(jì)該裝置時(shí),如何才能打造出比使用絕緣柵雙極晶體管 (IGBT) 更高效的電動(dòng)車(chē)驅(qū)動(dòng)系統(tǒng);文章最后介紹了一個(gè)基于SiC MOSFET的牽引逆變器實(shí)例,并說(shuō)明了最大限度地提高該裝置效率的設(shè)計(jì)技巧。
什么是牽引逆變器?
電動(dòng)汽車(chē)牽引逆變器將車(chē)輛的高壓 (HV) 電池提供的直流電轉(zhuǎn)換為電機(jī)所需的交流電,以產(chǎn)生移動(dòng)車(chē)輛所需的扭矩。牽引逆變器的電氣性能對(duì)車(chē)輛的加速和行駛里程有很大影響。
現(xiàn)代牽引逆變器的高壓電池驅(qū)動(dòng)系統(tǒng)電壓為400伏,或者到最近的800伏。在牽引逆變器電流為300安培 (A) 或更大的情況下,由800伏電池系統(tǒng)供電的設(shè)備能夠提供超過(guò)200千瓦 (KW) 的功率。隨著功率的攀升,逆變器的尺寸也在縮小,大大增加了功率密度。
擁有400伏電池系統(tǒng)的電動(dòng)車(chē)需要牽引逆變器采用額定電壓為600至750伏的功率半導(dǎo)體器件,而800伏的車(chē)輛則需要額定電壓為900至1200伏的半導(dǎo)體器件。牽引逆變器中使用的功率元件也必須能夠處理30秒 (s) 超過(guò)500A的峰值交流電流和1毫秒 (ms) 內(nèi)1600A的最大交流電流。此外,用于該設(shè)備的開(kāi)關(guān)晶體管和柵極驅(qū)動(dòng)器也必須能夠處理這些大的負(fù)載,同時(shí)保持高的牽引逆變器效率(表1)。

表1:2021年典型牽引逆變器要求;與2009年相比,如表所示能量密度要求增加了250%。(圖片來(lái)源:StevenKeeping)
牽引逆變器通常包括三個(gè)半橋元件(高壓側(cè)加低壓側(cè)開(kāi)關(guān)),每個(gè)電機(jī)相位都有一個(gè),柵極驅(qū)動(dòng)器控制著每個(gè)晶體管的低壓側(cè)開(kāi)關(guān)。整個(gè)組件必須與為車(chē)輛其他系統(tǒng)供電的低壓 (LV) 電路進(jìn)行電隔離(圖1)。

圖1:電動(dòng)車(chē)需要一個(gè)三相電壓源逆變器(牽引逆變器)以將高壓 (HV) 直流電池電源轉(zhuǎn)換為車(chē)輛電機(jī)所需的交流電源。高壓系統(tǒng),包括牽引逆變器,與車(chē)輛的傳統(tǒng)12伏系統(tǒng)隔離。(圖片來(lái)源:onsemi)
圖1所示例子中的開(kāi)關(guān)是IGBT。這類(lèi)逆變器一直是牽引逆變器的熱門(mén)選擇,因?yàn)樗鼈兡軌蛱幚砀唠妷海_(kāi)關(guān)迅速,提供良好的效率,而且價(jià)格相對(duì)便宜。然而,隨著SiC功率MOSFET成本的下降和它們?cè)谏虡I(yè)上的普及,工程師們正在轉(zhuǎn)向這些元件,因?yàn)樗鼈儽菼GBT具有明顯的優(yōu)勢(shì)。
用于高效柵極驅(qū)動(dòng)器的SiC MOSFET的優(yōu)勢(shì)
與傳統(tǒng)硅 (Si) MOSFET和IGBT相比,SiC功率MOSFET的關(guān)鍵性能優(yōu)勢(shì)來(lái)自于器件的WBG半導(dǎo)體襯底。硅MOSFET的帶隙能量為1.12電子伏特 (eV) ,而SiC MOSFET為3.26eV。這意味著WBG晶體管可以承受比硅器件高得多的擊穿電壓,以及由此產(chǎn)生的擊穿場(chǎng)電壓比硅器件高十倍左右。高擊穿場(chǎng)電壓允許在既定電壓下減少器件的厚度,降低“導(dǎo)通”電阻 (RDS(ON)),從而減少開(kāi)關(guān)損耗并提高載流能力。
SiC的另一個(gè)關(guān)鍵優(yōu)勢(shì)是它的導(dǎo)熱性,大約比Si高三倍。較高的導(dǎo)熱性能使得在一定的功率耗散下結(jié)溫(Tj) 上升較小。SiC MOSFET還可以容忍比Si更高的最大結(jié)溫 (Tj(max) ) 。硅MOSFET的典型Tj(max)值為150?C;SiC器件可以承受高達(dá)600?C的Tj(max),盡管商業(yè)器件的額定溫度通常為175至200?C。表2提供了Si和4H-SiC(通常用于制造MOSFET的SiC結(jié)晶形式)之間的性能比較。
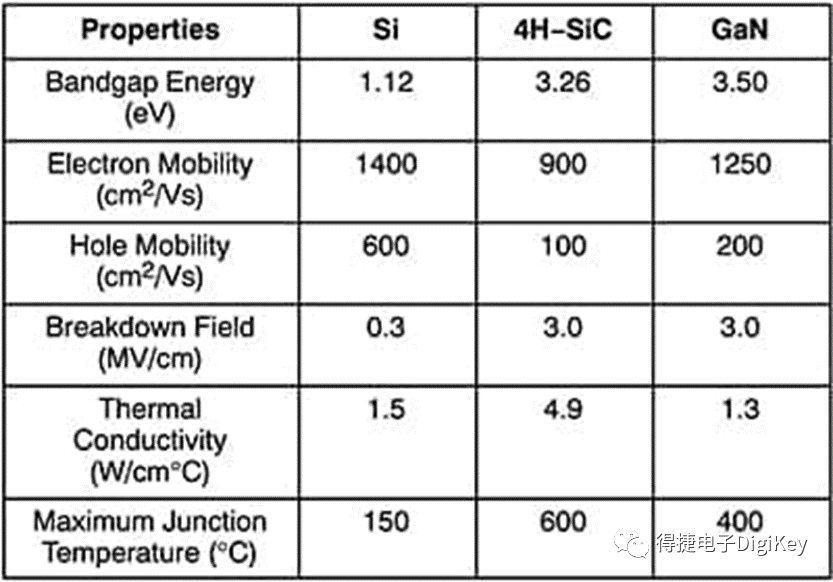
表2:SiC MOSFET的擊穿電場(chǎng)、熱導(dǎo)率和最大結(jié)溫使之成為大電流和高電壓開(kāi)關(guān)應(yīng)用中比Si更好的選擇。(圖片來(lái)源:onsemi)
高擊穿電壓、低 RDS(ON)、高導(dǎo)熱性和高Tj(max)使得SiCMOSFET能夠處理比類(lèi)似尺寸的Si MOSFET高得多的電流和電壓。
IGBT也能夠處理高電壓和高電流,并且往往比SiC MOSFET更便宜——這是它們?cè)跔恳孀兤髟O(shè)計(jì)中得到青睞的一個(gè)關(guān)鍵原因。IGBT也有缺點(diǎn),特別是當(dāng)開(kāi)發(fā)者希望最大限度地提高能量密度時(shí),由于其“尾電流”和相對(duì)較慢的關(guān)斷速度,對(duì)最大工作頻率有限制。相比之下,SiCMOSFET能夠處理與Si MOSFET相同的高頻開(kāi)關(guān),但具有IGBT的電壓和電流處理能力。
SiC MOSFET應(yīng)用越來(lái)越廣泛
直到最近,由于SiC MOSFET的價(jià)格相對(duì)較高,它們的使用僅限于豪華電動(dòng)車(chē)的牽引逆變器,但價(jià)格的下降使SiCMOSFET成為更多應(yīng)用的選擇。
Onsemi的NTBG020N090SC1和NTBG020N120SC1是這種新一代SiC功率MOSFETS的兩個(gè)實(shí)例。這兩種器件的主要區(qū)別是:前者的最大漏源極擊穿電壓(V (BR)DSS) 為900伏,柵源電壓(VGS) 為0伏,連續(xù)漏極電流 (ID)為1毫安 (mA);而后者的最大V(BR)DSS為1200伏(在相同條件下)。這兩個(gè)器件的最大Tj是175?C。這兩個(gè)器件都是單N溝道MOSFET,采用D2PAK-7L封裝(圖2)。

圖2:NTBG020N090SC1和NTBG020N120SC1N溝道SiC功率MOSFET都采用D2PAK-7L封裝,主要區(qū)別在于其V(BR)DSS值分別為900和1200伏。(圖片來(lái)源:Steven Keeping,使用了onsemi的材料)
NTBG020N090SC1的RDS(ON)為20毫歐 (mΩ),VGS為15伏(ID = 60 A, Tj= 25?C),RDS(ON)為16mΩ,VGS為18伏(ID = 60A, Tj = 25?C)。最大連續(xù)漏源二極管正向電流(ISD) 為148A(VGS=-5V,Tj = 25?C),最大脈沖漏源二極管正向電流 (ISDM) 為448A(VGS = -5V,Tj =25?C)。
NTBG020N120SC1則在VGS為20伏時(shí)具有28mΩ的RDS(ON) (ID= 60A, Tj = 25?C)。最大ISD為46A(VGS = ?5V,Tj = 25?C),最大ISDM是392A(VGS = ?5V,Tj = 25?C).
使用SiC MOSFET進(jìn)行設(shè)計(jì)
盡管SiC MOSFET具有優(yōu)勢(shì),但希望將SiC MOSFET納入其牽引逆變器設(shè)計(jì)的設(shè)計(jì)人員應(yīng)該注意一個(gè)重要的復(fù)雜問(wèn)題,即這種晶體管有棘手的柵極驅(qū)動(dòng)要求。其中一些挑戰(zhàn)來(lái)自于這樣一個(gè)事實(shí):與SiMOSFET相比,SiC MOSFET表現(xiàn)出較低的跨導(dǎo)、較高的內(nèi)部柵極電阻,并且柵極開(kāi)啟閾值可能低于2伏。因此,在關(guān)斷狀態(tài)下,柵極必須被拉到地電位以下(通常為-5V),以確保正確的開(kāi)關(guān)。
然而,關(guān)鍵的柵極驅(qū)動(dòng)挑戰(zhàn)來(lái)自于必須應(yīng)用大的VGS(高達(dá)20V)以確保低RDS(ON)。在太低的VGS下操作SiC MOSFET可能會(huì)導(dǎo)致熱應(yīng)力,甚至由于功率耗散而失效(圖3)。
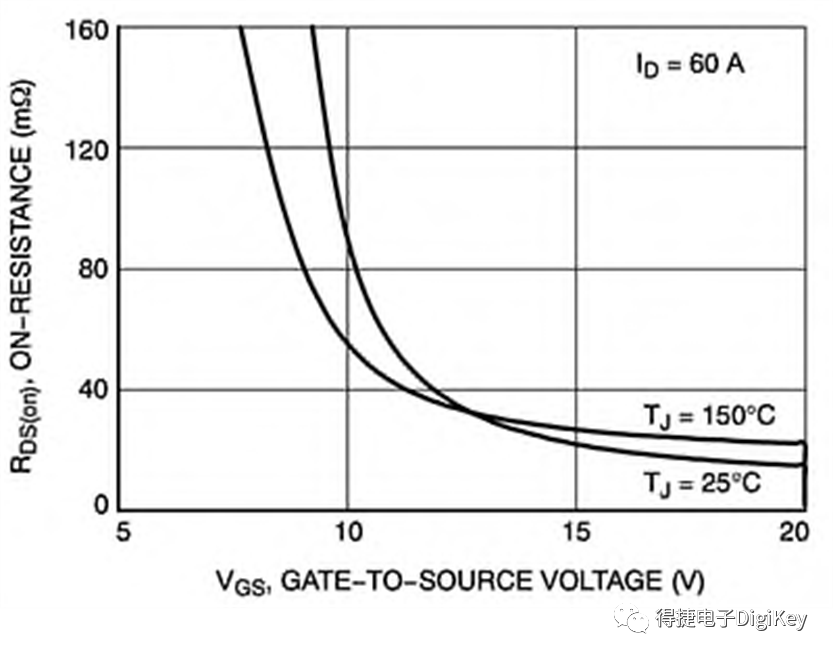
圖3:對(duì)于NTBG020N090SC1 SiC MOSFET,需要高VGS以避免高RDS(ON)帶來(lái)熱應(yīng)力。(圖片來(lái)源:onsemi)
此外,由于SiC MOSFET是一個(gè)低增益器件,設(shè)計(jì)者在設(shè)計(jì)柵極驅(qū)動(dòng)電路時(shí)必須考慮到這對(duì)其他幾個(gè)重要?jiǎng)討B(tài)特性的影響。這些特性包括柵極電荷米勒平臺(tái)和對(duì)過(guò)流保護(hù)的要求。
這些復(fù)雜的設(shè)計(jì)要求專(zhuān)用柵極驅(qū)動(dòng)器具有以下屬性:
能夠提供-5至20伏的VGS驅(qū)動(dòng),以充分利用SiC MOSFET的性能優(yōu)勢(shì)。為了提供足夠的開(kāi)銷(xiāo)以滿(mǎn)足這一要求,柵極驅(qū)動(dòng)電路應(yīng)能承受VDD = 25V和VEE = -10V。
VGS必須有快速的上升和下降邊緣,大約為幾納秒(ns)。
柵極驅(qū)動(dòng)必須能夠在整個(gè)MOSFET米勒平臺(tái)區(qū)域內(nèi)提供數(shù)安培的高峰值柵極電流。
灌電流的額定值應(yīng)超過(guò)僅對(duì)SiC MOSFET的輸入電容放電所需的電流。對(duì)于高性能的半橋電源拓?fù)浣Y(jié)構(gòu),應(yīng)考慮10A級(jí)的最小峰值灌電流額定值。
實(shí)現(xiàn)高速開(kāi)關(guān)的低寄生電感。
小型驅(qū)動(dòng)器封裝能夠盡可能地靠近SiC MOSFET,以提高能量密度。
去飽和 (DESAT) 功能能夠進(jìn)行檢測(cè)、故障報(bào)告和保護(hù),以實(shí)現(xiàn)長(zhǎng)期可靠的運(yùn)行。
一個(gè)VDD欠壓鎖定 (UVLO) 電平與開(kāi)關(guān)開(kāi)始前VGS> 16V的要求相匹配。
提供VEE UVLO監(jiān)測(cè)能力,以確保負(fù)電壓軌在可接受的范圍內(nèi)。
Onsemi已推出一款柵極驅(qū)動(dòng)器,旨在滿(mǎn)足牽引逆變器設(shè)計(jì)的上述要求。
NCP51705MNTXG SiC MOSFET柵極驅(qū)動(dòng)器具有高集成度,因此不僅與其SiC MOSFET兼容,而且與眾多制造商的產(chǎn)品兼容。該器件包括許多通用柵極驅(qū)動(dòng)器所共有的基本功能,但也具有使用最小外部元件設(shè)計(jì)可靠的SiCMOSFET柵極驅(qū)動(dòng)電路所必需的專(zhuān)門(mén)要求。
例如,NCP51705MNTXG集成了一個(gè)DESAT功能,只需使用兩個(gè)外部元件就可以實(shí)現(xiàn)。DESAT是IGBT和MOSFET的一種過(guò)流保護(hù)形式,用于監(jiān)測(cè)故障,據(jù)此VDS就可以上升到最大ID。這可能會(huì)影響效率,在最壞的情況下,可能會(huì)損壞MOSFET。圖4顯示了NCP51750MNTXG如何通過(guò)R1和D1的DESAT引腳來(lái)監(jiān)測(cè)MOSFET(Q1) 的VDS。

圖4:NCP51705MNTXG的DESAT功能能夠測(cè)量VDS在最大ID期間的異常行為,并實(shí)現(xiàn)過(guò)流保護(hù)。(圖片來(lái)源:onsemi)
NCP51705MNTXG柵極驅(qū)動(dòng)器還具有可編程的欠壓鎖定功能。在驅(qū)動(dòng)SiC MOSFET時(shí),這是一個(gè)重要的功能,因?yàn)殚_(kāi)關(guān)元件的輸出應(yīng)該被禁用,直到VDD高于一個(gè)已知的閾值。允許驅(qū)動(dòng)器在低VDD下開(kāi)關(guān)MOSFET會(huì)損壞器件。NCP51705MNTXG的可編程UVLO不僅可以保護(hù)負(fù)載,而且可以向控制器驗(yàn)證所施加的VDD是否高于開(kāi)啟閾值。UVLO的開(kāi)啟閾值是通過(guò)UVSET和SGND之間的一個(gè)電阻設(shè)置的(圖5)。

圖5:NCP51705MNTXG SiC MOSFET的UVLO開(kāi)啟閾值通過(guò)UVSET電阻RUVSET設(shè)置,具體阻值根據(jù)所需的UVLO開(kāi)啟電壓VON選擇。(圖片來(lái)源:onsemi)
牽引逆變器的數(shù)字隔離
為了完成牽引逆變器的設(shè)計(jì),工程師必須確保車(chē)輛的低壓側(cè)電子設(shè)備與通過(guò)逆變器的高電壓和電流隔離(上圖2)。然而,由于控制高壓柵極驅(qū)動(dòng)器的微處理器在低壓側(cè),任何隔離都必須允許數(shù)字信號(hào)從微處理器傳遞到柵極驅(qū)動(dòng)器。Onsemi也提供了一種實(shí)現(xiàn)這種功能的元件,即NCID9211R2,一種高速、雙通道、雙向陶瓷數(shù)字隔離器。
NCID9211R2是一個(gè)電隔離的全雙工數(shù)字隔離器,允許數(shù)字信號(hào)在系統(tǒng)之間傳遞而不產(chǎn)生接地回路或危險(xiǎn)電壓。該設(shè)備具有2000伏峰值最大工作絕緣能力,100千伏/毫秒(kV/ms) 的共模抑制,以及每秒50兆比特(Mbit/s) 的數(shù)據(jù)吞吐量。
圖6所示為片外陶瓷電容器構(gòu)成的隔離柵。
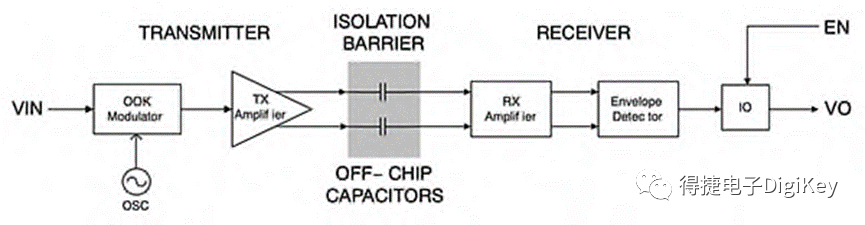
圖6:NCID9211R2數(shù)字隔離器單通道結(jié)構(gòu)的框圖。片外電容器構(gòu)成了隔離柵。(圖片來(lái)源:onsemi)
數(shù)字信號(hào)使用ON-OFF開(kāi)關(guān)鍵控 (OOK) 調(diào)制方式穿過(guò)隔離柵進(jìn)行傳輸。在發(fā)射器一側(cè),VIN輸入邏輯狀態(tài)被高頻載波信號(hào)調(diào)制。由此產(chǎn)生的信號(hào)被放大并傳輸?shù)礁綦x柵。接收端檢測(cè)隔離柵信號(hào),并使用包絡(luò)檢測(cè)技術(shù)對(duì)其進(jìn)行解調(diào)(圖7)。當(dāng)輸出允許控制EN為高電平時(shí),輸出信號(hào)決定了VO的輸出邏輯狀態(tài)。當(dāng)發(fā)射器電源關(guān)閉,或VIN輸入斷開(kāi)時(shí),VO默認(rèn)為高阻抗低電平狀態(tài)。

圖7:NCID9211數(shù)字隔離器使用OOK調(diào)制跨越隔離柵來(lái)傳輸數(shù)字信息。(圖片來(lái)源:onsemi)
結(jié)語(yǔ)
SiC功率MOSFET是高效率和高功率密度電動(dòng)汽車(chē)牽引逆變器的好選擇,但其電氣特征在柵極驅(qū)動(dòng)器和器件保護(hù)方面也帶來(lái)獨(dú)特的設(shè)計(jì)挑戰(zhàn)。除了設(shè)計(jì)上的挑戰(zhàn),工程師們還必須確保他們的牽引逆變器設(shè)計(jì)能夠與車(chē)輛敏感的低壓電子裝置進(jìn)行高級(jí)別隔離。
如上所述,為方便工程開(kāi)發(fā),onsemi推出了一系列SiCMOSFET、專(zhuān)用柵極驅(qū)動(dòng)器和數(shù)字隔離器,以滿(mǎn)足牽引逆變器的要求,并在現(xiàn)代電動(dòng)汽車(chē)的長(zhǎng)量程和高性能要求之間取得了更好的平衡。
審核編輯:湯梓紅
 電子發(fā)燒友App
電子發(fā)燒友App















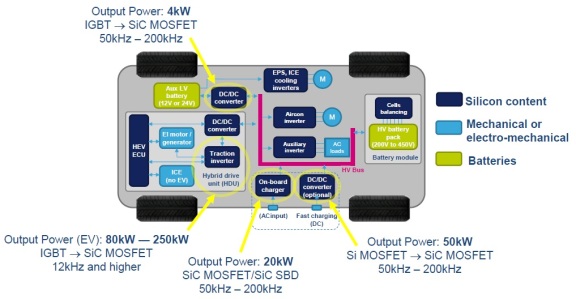
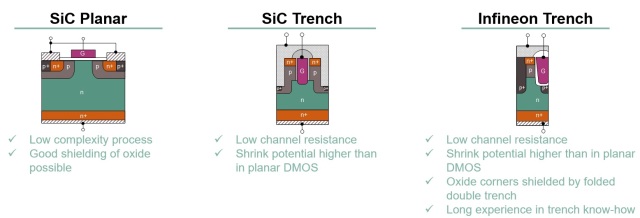
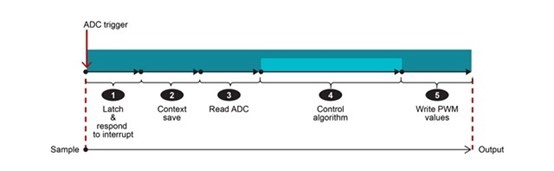
















評(píng)論