電子發燒友網綜合報道
近日,Nordson Electronics Solutions與Powertech Technology, Inc.(PTI)聯合開發的面板級封裝(PLP)解決方案,以流體點膠系統的技術革新為切入點,重塑了半導體封裝的工藝范式與產業邏輯。
這種基于高精度流體控制的創新方案,不僅突破了傳統封裝在良率、效率與可靠性層面的技術瓶頸,更通過面板級制造的規模效應,推動半導體封裝向高集成、低成本、低功耗的方向深度變革,其影響已延伸至產業鏈各環節的技術路徑與市場格局。
從工藝技術的底層邏輯來看,該方案的核心突破在于將非接觸式噴射技術與動態形變補償機制深度融合。IntelliJet噴射系統采用按需噴射閥門設計,以每秒100個流體點的高頻噴射能力,在0.5–3.5mm的間隙范圍內實現無Z軸移動的精準點膠,這種非接觸模式徹底規避了傳統針頭接觸導致的偏移污染問題。
更關鍵的是,系統通過多級壓力調節與實時形變監測,構建了完整的空洞抑制體系,當510mm×515mm的大尺寸面板因熱變形產生微觀翹曲時,集成的傳感器會動態調整點膠路徑與壓力,使環氧樹脂類填充材料在10–20μm的窄間隙內形成無氣泡的均勻填充,將空洞率控制在1%以下,由此實現99%以上的良率突破。
面板級封裝的規模化生產邏輯,徹底改變了半導體封裝的成本計算方式。相較于300mm晶圓7萬mm2的面積,標準面板26萬mm2的尺寸實現了3倍以上的芯片封裝數量提升,這種幾何級的面積利用率提升直接攤薄了單位封裝成本。
而Nordson點膠系統±1%的材料用量控制精度,將底部填充膠的浪費率降低25%,配合無針頭更換需求帶來的設備維護成本下降,使PTI的PLP產線綜合成本降低18%。這種成本優勢在先進封裝場景中尤為顯著,當2.5D/3D IC與Chiplet架構需要處理硅中介層與多芯片堆疊的復雜結構時,該方案通過無空洞填充將焊點熱機械可靠性提升3倍,功率循環壽命延長至傳統工藝的3倍,同時兼容玻璃基板與有機基板等多元材料體系。
特別是在玻璃基板應用中,系統通過流變學優化解決了玻璃脆性導致的填充開裂風險,為HBM封裝提供了新的基板選擇,這種材料兼容性拓展了先進封裝的技術邊界。
并且Nordson與PTI的合作模式開創了設備商與OSAT企業的深度綁定范式,通過聯合分銷商Jetinn Global提供本地化技術支持,并在產線部署涵蓋點膠、固化到檢測的全流程演示單元,加速了PLP工藝的標準化進程。
從市場應用來看,該技術已在AI芯片、功率模塊與汽車電子等領域實現突破。在GPU與HBM的高密度互連封裝中,其高精度填充能力保障了海量數據交互的可靠性;在銅燒結貼裝與底部填充的復合工藝中,為功率器件提供了更優的熱管理方案;而耐高溫填充膠在SiC模塊的應用,則滿足了汽車電子在-40℃至150℃寬溫環境下的可靠性需求,這種多場景適配性推動了封裝技術與終端應用的深度耦合。
小結
當面板級封裝從實驗室走向量產,其帶來的不僅是制造規模的擴大,更是封裝技術從芯片保護向性能賦能的角色躍遷,通過支持異構集成與多元材料,PLP解決方案成為AI與高性能計算芯片創新的關鍵支撐,這種技術賦能效應正在重構芯片設計與封裝制造的協同模式。
近日,Nordson Electronics Solutions與Powertech Technology, Inc.(PTI)聯合開發的面板級封裝(PLP)解決方案,以流體點膠系統的技術革新為切入點,重塑了半導體封裝的工藝范式與產業邏輯。
這種基于高精度流體控制的創新方案,不僅突破了傳統封裝在良率、效率與可靠性層面的技術瓶頸,更通過面板級制造的規模效應,推動半導體封裝向高集成、低成本、低功耗的方向深度變革,其影響已延伸至產業鏈各環節的技術路徑與市場格局。
從工藝技術的底層邏輯來看,該方案的核心突破在于將非接觸式噴射技術與動態形變補償機制深度融合。IntelliJet噴射系統采用按需噴射閥門設計,以每秒100個流體點的高頻噴射能力,在0.5–3.5mm的間隙范圍內實現無Z軸移動的精準點膠,這種非接觸模式徹底規避了傳統針頭接觸導致的偏移污染問題。
更關鍵的是,系統通過多級壓力調節與實時形變監測,構建了完整的空洞抑制體系,當510mm×515mm的大尺寸面板因熱變形產生微觀翹曲時,集成的傳感器會動態調整點膠路徑與壓力,使環氧樹脂類填充材料在10–20μm的窄間隙內形成無氣泡的均勻填充,將空洞率控制在1%以下,由此實現99%以上的良率突破。
面板級封裝的規模化生產邏輯,徹底改變了半導體封裝的成本計算方式。相較于300mm晶圓7萬mm2的面積,標準面板26萬mm2的尺寸實現了3倍以上的芯片封裝數量提升,這種幾何級的面積利用率提升直接攤薄了單位封裝成本。
而Nordson點膠系統±1%的材料用量控制精度,將底部填充膠的浪費率降低25%,配合無針頭更換需求帶來的設備維護成本下降,使PTI的PLP產線綜合成本降低18%。這種成本優勢在先進封裝場景中尤為顯著,當2.5D/3D IC與Chiplet架構需要處理硅中介層與多芯片堆疊的復雜結構時,該方案通過無空洞填充將焊點熱機械可靠性提升3倍,功率循環壽命延長至傳統工藝的3倍,同時兼容玻璃基板與有機基板等多元材料體系。
特別是在玻璃基板應用中,系統通過流變學優化解決了玻璃脆性導致的填充開裂風險,為HBM封裝提供了新的基板選擇,這種材料兼容性拓展了先進封裝的技術邊界。
并且Nordson與PTI的合作模式開創了設備商與OSAT企業的深度綁定范式,通過聯合分銷商Jetinn Global提供本地化技術支持,并在產線部署涵蓋點膠、固化到檢測的全流程演示單元,加速了PLP工藝的標準化進程。
從市場應用來看,該技術已在AI芯片、功率模塊與汽車電子等領域實現突破。在GPU與HBM的高密度互連封裝中,其高精度填充能力保障了海量數據交互的可靠性;在銅燒結貼裝與底部填充的復合工藝中,為功率器件提供了更優的熱管理方案;而耐高溫填充膠在SiC模塊的應用,則滿足了汽車電子在-40℃至150℃寬溫環境下的可靠性需求,這種多場景適配性推動了封裝技術與終端應用的深度耦合。
小結
當面板級封裝從實驗室走向量產,其帶來的不僅是制造規模的擴大,更是封裝技術從芯片保護向性能賦能的角色躍遷,通過支持異構集成與多元材料,PLP解決方案成為AI與高性能計算芯片創新的關鍵支撐,這種技術賦能效應正在重構芯片設計與封裝制造的協同模式。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
半導體封裝
+關注
關注
4文章
294瀏覽量
14476 -
良率
+關注
關注
0文章
5瀏覽量
5514
發布評論請先 登錄
相關推薦
熱點推薦
仁懋TOLT封裝:突破極限,重塑大功率半導體未來
在科技飛速發展的今天,每一次電子設備性能的躍升,都離不開半導體技術的突破。仁懋電子推出的TOLT封裝產品,以顛覆傳統的設計和卓越性能,成為大功率半導體領域的“破局者”,為工業、新能源、

Low-κ介電材料,突破半導體封裝瓶頸的“隱形核心”
電子發燒友網綜合報道 Low-κ 介電材料作為半導體封裝領域的核心材料,其技術演進與產業應用正深刻影響著集成電路的性能突破與成本優化。這類介
發表于 05-25 01:56
?956次閱讀
最全最詳盡的半導體制造技術資料,涵蓋晶圓工藝到后端封測
資料介紹
此文檔是最詳盡最完整介紹半導體前端工藝和后端制程的書籍,作者是美國人Michael Quirk。看完相信你對整個芯片制造流程會非常清晰地了解。從硅片制造,到晶圓廠芯片工藝的四大基本類
發表于 04-15 13:52
先楫半導體MCU具有哪些優勢?
先楫半導體(HPMicro)成立于2020年6月,是一家專注于高性能嵌入式解決方案的半導體企業,總部位于上海浦東軟件園。公司聚焦于研發高性能微控制器(MCU)、微處理器及配套外設芯片,并構建了完整
發表于 04-14 10:04
PLP面板級封裝,靜待爆發
電子發燒友綜合報道? 面板級封裝(Panel-Level Packaging,PLP)已經存在一段時間,但未被大規模應用。Yole Group近期預測,2024年,PLP市場總收入達到約1.6億美元
發表于 04-09 00:09
?1577次閱讀
SS6208率能半導體電機驅動芯片代理供應
芯片簡介
SS6208 將半橋 MOSFET 驅動器(高邊+ 低邊)集成到 3mm*3mm 8-pins DFN 的封裝中。
與分立元件解決方案相比,SS6208 集成解決 方案大大減
發表于 03-07 09:27
意法半導體新能源功率器件解決方案
在《意法半導體新能源功率解決方案:從產品到應用,一文讀懂(上篇)》文章中,我們著重介紹了ST新能源功率器件中的傳統IGBT和高壓MOSFET器件,讓大家對其在相關領域的應用有了一定了解。接下來,本文將聚焦于ST的SiC、GaN等
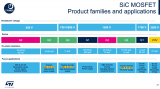
半導體封裝的主要類型和制造方法
半導體封裝是半導體器件制造過程中的一個重要環節,旨在保護芯片免受外界環境的影響,同時實現芯片與外部電路的連接。隨著半導體技術的不斷發展,封裝
半導體制造行業MES系統解決方案
半導體制造行業MES系統解決方案在提高生產效率、降低成本、提升產品質量和增強生產靈活性等方面具有顯著優勢。然而,在實施過程中也需要克服一系列挑戰。隨著科技的不斷進步和市場需求的不斷變化,MES系統將在

半導體行業諧波監測與治理系統解決方案
安科瑞徐赟杰18706165067 半導體是許多工業整機設備的核心,普遍應用于計算機、通信、消費電子、汽車、工業/醫療、軍事/政府等核心領域。為鼓勵半導體材料產業發展,突破產業瓶頸,我國出臺等多項

意法半導體物聯網eSIM解決方案簡介
本白皮書探討了使用eSIM的優勢及其工作原理。其中還全面概述了新GSMA IoT eSIM規范,以及該規范如何確保為各種類型的互聯設備和應用提供靈活安全的全球電信覆蓋解決方案。最后我們將介紹意法半導體便捷易用的物聯網eSIM產品組合及解






 從良率突破到成本優化:PLP解決方案如何改寫半導體封裝規則
從良率突破到成本優化:PLP解決方案如何改寫半導體封裝規則















評論